從NEPCON JAPAN 2012看電子構裝材料技術發展
■ 先進印刷電路板技術發展近況
印刷電路板大廠CMK分別在專門技術研討會及展場展示其印刷電路板技術發展近況。CMK公司技術開發部的齊藤紀之部長以車用印刷電路板的技術趨勢為題,說明CMK在車用電子印刷電路板的技術發展。CMK之Printed Wiring Board (PWB)技術主要有 High density technology (HDI)、High heat dissipation technology、Replacement of the ceramic substrate和Mounting technology of PWB。在HDI技術上CMK持續推出結合Interstitial via hole (IVH)和Laser Via以及Buried hole技術開發出2-4-2和3-2-3等8層高密度PWB將其應用在ECU產品上。
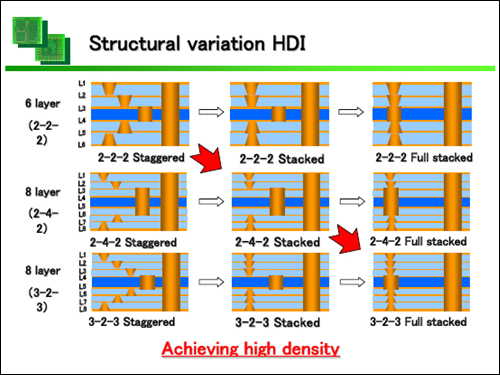 資料來源:CMK;41st INTERNEPCON JAPAN Technical Conference
資料來源:CMK;41st INTERNEPCON JAPAN Technical Conference
CMK公司展示不同結構方式的高密度連結技術(HDI)
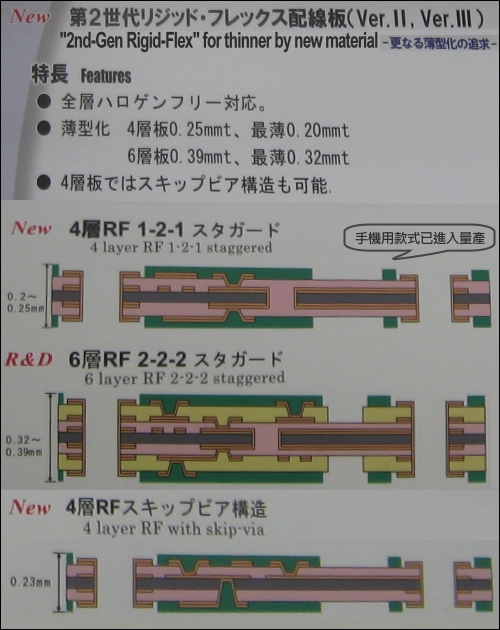 CMK的第2代印刷電路板,其特色除了更輕薄之外,每層皆無鹵素。構造上可分成:4層RF 1-2-1交錯、6層RF2-2-2交錯以及4層RF Skip-Via三種,目前4層RF 1-2-1交錯的產品已實際應用在手機的量產上。
CMK的第2代印刷電路板,其特色除了更輕薄之外,每層皆無鹵素。構造上可分成:4層RF 1-2-1交錯、6層RF2-2-2交錯以及4層RF Skip-Via三種,目前4層RF 1-2-1交錯的產品已實際應用在手機的量產上。
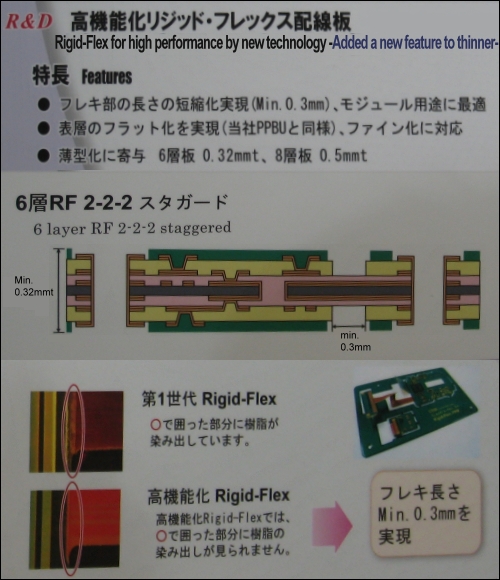 CMK展示高機能化印刷電路板,6層板為0.32mmt,8層板0.5mmt。除了更輕更薄之外,還成功縮短可撓部的長度,相當適合模組化且表層平坦更精密化。
CMK展示高機能化印刷電路板,6層板為0.32mmt,8層板0.5mmt。除了更輕更薄之外,還成功縮短可撓部的長度,相當適合模組化且表層平坦更精密化。
一般載板薄型後會有剛性不足,產生晶片承載力不足的狀況,加上高溫效應的雙重影響,會讓載板發生翹曲不平整的現象,是載板薄型化最大的問題。CMK提出一款"ZEROWARP"載板,不僅在常溫具有高剛性,在高溫200℃區域依然具有等同常溫的剛性,這是傳統載板很難做到的。從圖中顯示ZEROWARP與舊有產品在各項特性上的比較。如高剛性減少了翹曲上的問題且易於搬運,彎曲彈性率提升4倍,並顯示出與既有產品在核心0.04mm中翹曲性上的比較。在低翹曲性方面,則成功減少整體的翹起及彎曲情況。耐熱性方面,由於使用了高Tg/高剛性材料,即使加熱SR的剛性也依然不減。
 ZEROWARP具備三大優勢:高剛性、高耐熱性及低翹曲性,係極薄卻易於裝設的載板。這款產品於SR層使用了高剛性/高耐熱材料,Tg值為210℃,並將翹曲問題減少到最低。相當適用於SiP及PoP薄型PKG
ZEROWARP具備三大優勢:高剛性、高耐熱性及低翹曲性,係極薄卻易於裝設的載板。這款產品於SR層使用了高剛性/高耐熱材料,Tg值為210℃,並將翹曲問題減少到最低。相當適用於SiP及PoP薄型PKG
 ZEROWARP與舊有產品在各項特性上的比較
ZEROWARP與舊有產品在各項特性上的比較
針對電子產品應用在不同車輛場合對電子產品冷熱循環可靠度大不相同的特性要求CMK開發了高Tg PWB、Low CTE PWB以及High Tg & Low CTE PWB材料技術。經由實際可靠度測試驗證實驗顯示High Tg & Low CTE PWB 材料具有最好的表現。
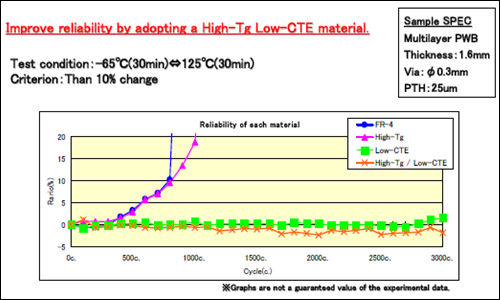 資料來源:CMK;41st INTERNEPCON JAPAN Technical Conference
資料來源:CMK;41st INTERNEPCON JAPAN Technical Conference
CMK公司藉由調整高Tg低CTE材料改善產品可靠度
此外,包括味之素及三菱瓦斯化學等IC載板材料大廠亦在展場展示其公司最新材料技術,味之素展出具優異絕緣可靠度的ABF絕緣薄膜材料,可應用在半加成式增層法製程中,從一般液狀改成薄膜材料可使平滑度上升,實現更細微的配線製程。
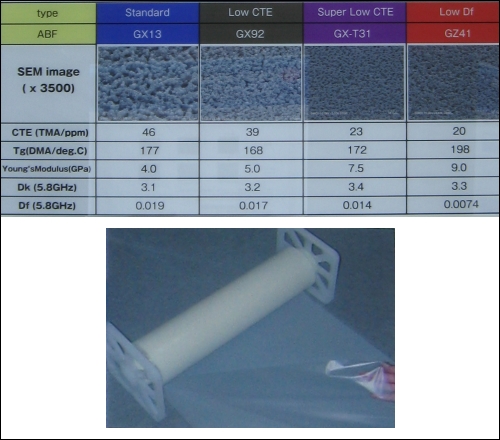 味之素增層基板薄膜材料技術
味之素增層基板薄膜材料技術
 味之素展示增層基板薄膜材料
味之素展示增層基板薄膜材料
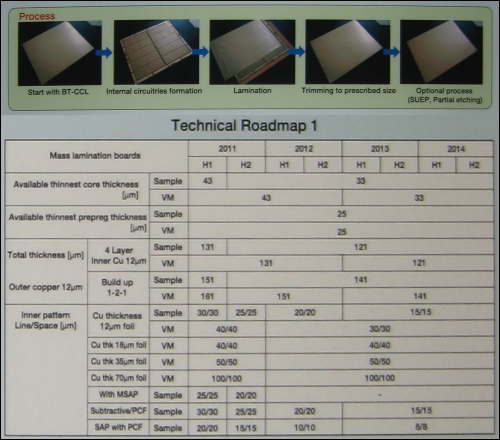 三菱瓦斯化學 BT壓合板製造程序及Roadmap
三菱瓦斯化學 BT壓合板製造程序及Roadmap
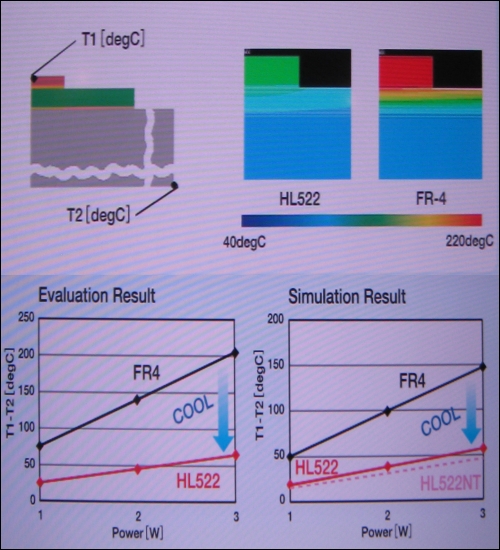 三菱瓦斯化學BT材料之散熱效果
三菱瓦斯化學BT材料之散熱效果
■ 車用電子發展
日本Denso Corp.電子基磐技術開發部的新見幸秀部長蒞會剖析電子技術如何從環境、安全、便利、舒適的觀點改變未來汽車的發展。新見部長以Denso公司車用電子技術的開發現況,針對因應環境相關的車用技術成果,利用開發有別於傳統轉速控制之點燃和噴射系統的高壓與噴射控制電子系統,從而大幅提高diesel engines效能以及降低其廢氣排放比,以滿足日本政府日趨嚴格的環保法規。另外,Denso公司也針對未來如何提高車輛能源利用效率、減排、安全以及舒適性所需之高性能車用電子裝置提出了發展構想圖,值得大家參考。
 資料來源:DENSO;41st INTERNEPCON JAPAN Technical Conference
資料來源:DENSO;41st INTERNEPCON JAPAN Technical Conference
圖、DENSO公司針對四大關鍵因素,預測未來車用電子的發展
■ 液態封裝材料的封裝製程
在NEPCON展場上,液態封裝材料的封裝製程包括真空印刷設備及點膠機設備均有多家設備及材料廠商投入,針對目前晶片堆疊、覆晶構裝及3D構裝型態,為了避免膠材封裝氣泡的包覆以及封裝位置及膠量的精密度,點膠機廠商如傳統點膠機大廠Asymtek不但提出非接觸式之dispensing jet來避免點膠針頭碰觸到晶線及晶片,並且利用快速噴塗方式來達到精準點膠控制;還有日本MUSASHI也同樣提出Aero Jet的空氣噴塗點膠方式,來達到非接觸式精準點膠控制。
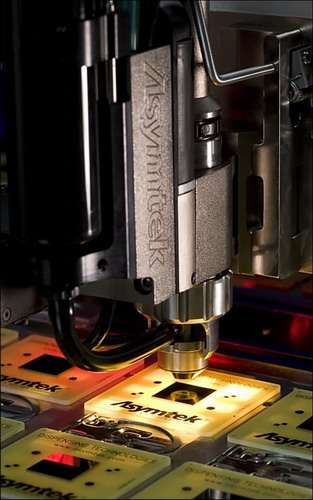 點膠機大廠Asymtek展示非接觸式dispensing jet之DJ-9000系列
點膠機大廠Asymtek展示非接觸式dispensing jet之DJ-9000系列
此外,在展場上亦可看到如岩下、ASTI等廠商提出類似的空氣噴塗點膠機。而在晶片堆疊、覆晶構裝等大面積封裝或是細線路封裝製程方面,真空鋼板印刷製程則是越來越受到重視,出展廠商包括Toray Engineering、SANYU REC、Newlong等,Toray Engineering已在真空鋼板印刷設備開發上投入10年以上時間,其主要特色為兩段式真空壓差印刷製程;而與Newlong公司技術人員討論中得知,其真空印刷機可以依據鋼板厚度達到70~100m之薄型封裝。在本次NEPCON展場不難發現為了因應晶片堆疊、覆晶構裝及未來3D構裝型態,液態封裝材料的封裝製程已逐漸受到採用,這些資訊對於封裝製程技術驗證具有極高的參考意義。
 MUSASHI展示以空氣噴塗點膠方式的Aero Jet
MUSASHI展示以空氣噴塗點膠方式的Aero Jet
 NEWLONG展示真空鋼板印刷製程
NEWLONG展示真空鋼板印刷製程
■ IC構裝高性能半導體封裝材料技術發展
近年來,由於IC構裝的高密度、大尺寸、多功能整合以及薄型複雜構裝半導體構裝發展趨勢,半導體封裝材料的技術發展需符合低應力、低翹曲、高可靠度及綠色環保的需求。在本次展會中,除了有世界知名的半導體大廠,Sumsung、Amkor等參與外,主辦公司Reed Exhibition Japan有鑑於日本半導體產業近些年逐漸向國外,設計與招攬了80多家技術精良的中小企業參與此一盛會並介紹自己的技術與產品。而多家半導體封裝材料大廠也紛紛在此展會針對未來高密度、大尺寸以及薄型複雜構裝半導體構裝用封裝材料的技術發展挑戰和解決之道提出了各家看法。
Sumitomo Bakelite主要的技術著眼點是未來打線式半導體構裝不僅導線會愈來愈細長、構型愈薄型化,導線的種類也會由金線向銅線變化。而銅在本質上就比金不安定易變化,傳統構裝技術和模封材料已無法滿足這樣的構裝產品信賴性需求。然而,與以往非常不同的是,Sumitomo Bakelite一開始並不是從如何提昇模封材料特性著手,而是先詳細介紹分析了打線製程/參數對構裝信賴性影響的重要性以及彼此之間相互關聯性。此外,提出了pH值和氯離子Cl-濃度是影響構裝HAST信賴性的主要因素這一論點。開發新型硬化劑和高純度環氧樹脂是目前高信賴性半導體封裝材料重要發展課題。
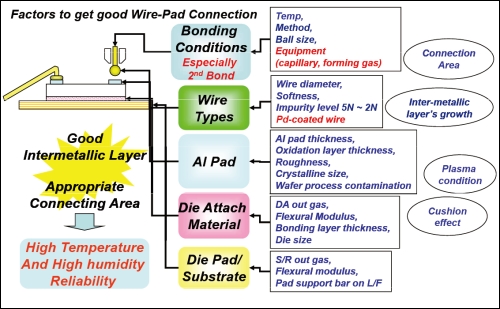 資料來源:Sumitomo Bakelite;41st INTERNEPCON JAPAN Technical Conference
資料來源:Sumitomo Bakelite;41st INTERNEPCON JAPAN Technical Conference
Sumitomo Bakelite提出打線製程與半導體構裝之關聯性
日立化成則針對新型LCP環氧樹脂技術進行技術發表及展品介紹,藉由環氧樹脂主鏈結構設計與加工製程參數調控混成材料的morphology,開發出熱傳導係數高於5.5W/mK之高導熱薄膜材料。目前日立化成已將此系列材料應用在LED、IGBT和CPU等半導體構裝產品上。
在先進封裝技術發展下,產業積極朝向堆疊構裝及3D IC封裝技術發展;另外,IC載板封裝能夠提供高密度/高腳數、高頻封裝應用,已逐漸成為主流,近年來覆晶(Flip Chip)封裝呈現快速成長,因此也帶動了底部填充膠(underfill)的市場的成長。日本覆晶用底部充填膠Underfill封裝材料製造商NAMICS亦是全球最大Underfill封裝材料製造商,針對高密度覆晶構裝或是3DIC覆晶構裝用封裝材料課題介紹了該公司的技術發展概念。在堆疊式覆晶封裝用underfill材料開發上,NAMICS是結合真空輔助底部填充製程/設備(Vacuum assist capillary underfill,簡稱VCUF)開發了具高產速、void-free封裝技術。為避免覆晶封裝氣泡所導致的不良率提高,NAMICS也非常強調未來應開發高純度環氧樹脂和低吸濕硬化劑材料技術。
除了傳統的底部充填膠材料外,長瀨Nagase及Namics兩家半導體液態封裝材料大廠也分別展出強調低翹曲、低應力、低熱膨脹係數及快速硬化等特性之液態封裝材料,利用liquid compression molding製程進行12吋晶圓級封裝(Wafer level package),在12吋晶圓進行封裝後,看不出有明顯翹曲情形,其材料特性及封裝成品分別如下圖所示。
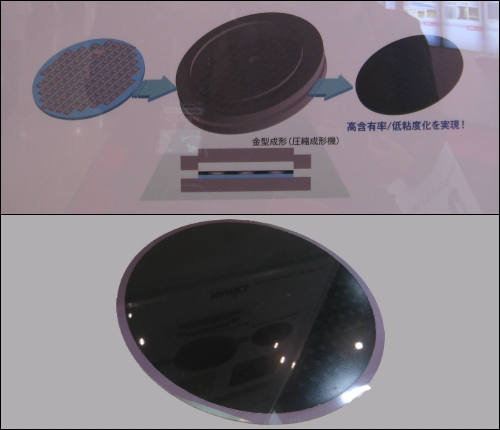 NAMICS 12吋晶圓級封裝材料特性(上)及liquid compression molding製程封裝成品(下)
NAMICS 12吋晶圓級封裝材料特性(上)及liquid compression molding製程封裝成品(下)
 長瀨12吋晶圓級封裝材料特性(上)及liquid compression molding製程封裝成品(下)
長瀨12吋晶圓級封裝材料特性(上)及liquid compression molding製程封裝成品(下)
更多Nepon 2012展覽現場請參閱材料世界網技術專文:
從2012 Lighting Japan、Nepcon Japan看新一代LED/OLED照明與電子構裝材料技術發展(上)
從2012 Lighting Japan、Nepcon Japan看新一代LED/OLED 照明與電子構裝材料技術發展(下)
日本東京LIGHTING JAPAN&NEPCON JAPAN 2012 特別報導系列(一)
日本東京LIGHTING JAPAN&NEPCON JAPAN 2012 特別報導系列(二)
日本東京LIGHTING JAPAN & NEPCON JAPAN & AUTOMOTIVE WORLD 2012 特別報導系列(三)
作者:材料世界網 編輯室