電路基板材料技術發展
目前在電子產業中,常用的有機高分子電路基板包括印刷電路基板(Printed Circuit Board; PCB)、IC 載板(IC Substrate)及可撓性電路基板(Flexible-Printed Circuit Board)。印刷電路基板較常使用之材料為玻璃布基材環氧樹脂銅箔積層板及紙基材苯酚樹脂銅箔基層板,是價格低廉、用途最廣的基板。IC 載板則是做為晶片直接承載之用,如COB 、FCOB 及DCA 等,特性是I/O 數目高,連接密度高,目前IC 載板所使用的樹脂材料以BT 樹脂(Bismaleimide Triazine Resin)為主,國內開發之類BT 載板材料則因為日本311 地震而出現替代BT 樹脂材料的契機。可撓性電路基板比PCB 更薄,所使用的耐熱性樹脂材主要為聚醯亞胺(Polyimide)或液晶高分子(Liquid Crystal Polymer; LCP)。
1. 印刷電路基板
以環氧樹脂為主的PCB 基板,其耐溫性商品如表一所示。目前TMA 所測得基板材料的Tg 大部分約在180°C 左右,雖然已經可稱作是耐溫性基板,但是要做為高耐溫基板,Tg 值仍稍低。Tg 值約210°C 以上方可稱作高耐溫基板材料。目前藉以提升環氧樹脂耐溫性的方法有:1.使用多官能基環氧樹脂或多官能基的硬化劑,藉由交聯程度的提高來增加環氧樹脂的耐溫性質; 3.使用-----全文請詳見原文
3. 可撓性電路基板
其中以 LCP 材料發展最久, LCP 的特色是強調低介電及低吸濕的特性,其吸濕膨脹約為 PI 的1/10 ,介電常數3.0 比PI 之介電常數3.5 低,應用於高頻速度上占有優勢。目前應用於軟性基材的LCP 屬於熱向列、全芳香族聚酯結構,依照其分子結構可分為三種型態,分別為Type I 、Type II 及Type III 。雖然LCP在高頻及吸濕等特性較PI 為佳,但其與銅箔接著性卻較差,且目前LCP 的成本比PI高。若要因應實際需求則價格必須有下降的空間。
工研院材化所因應全球綠色環保風潮趨勢與市場商機策略考量,自行開發無鹵無磷高耐溫用基板材料技術。利用反應型AI 寡聚合物改質馬來亞醯胺樹脂,此樹脂展現特有的韌性及高熱穩定性,在不添加任何含鹵素或含磷的難燃劑及無機添加劑的情形下,即可通過UL-94 V0 的測試標準。此材料具有相當高之Tg , TMA 量測值高於250°C 以上,具有相當優異的耐溫性。
散熱基板的技術發展與應用
1. Panasonic
ECOOL R-1787問世之後, Panasonic 並未停止對這種高導熱性複合基型CCL 的性能進行改進開發,2011 年6 月在日本東京JPCA SHOW 發表了新改進的高導熱性複合基板CCL ,其熱傳導率達到 1.5 W/m•K 。將此有機散熱基板材料用在LED 上,利用熱模擬(Thermal Simulation)可發現,使用ECOOL R-1787 基板材料,其溫度約比傳統FR-4 板材下降約35°C ,如圖一所示 。若用於構裝上,利用ALIVH 方法配合散熱基板材料所製作的多層板材料,由其測量結果可以發現,使用散熱基板材料的產品相對於傳統 FR-4 板材,其溫度約可降低9.3% 左右,如圖二所示。
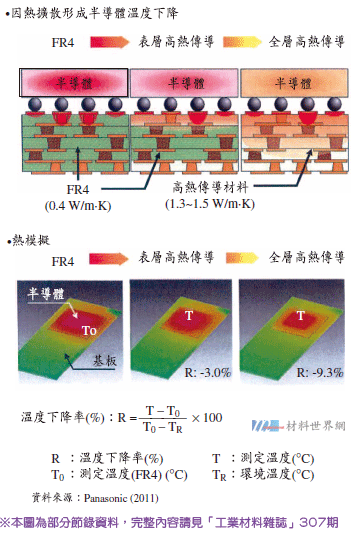
圖二、散熱基板材料製作的多層板材料溫度量測圖
工研院材化所開發的散熱絕緣有機高耐溫基板材料,利用有機/ 無機混成方式將高導熱無機粉體導入有機材料中,膠水經由研磨分散技術加工後,所製作的環保型無鹵無磷散熱基板材料性質如表三所示,此材料Tg 約為……以上內容為重點摘錄,如欲詳全文請見原文。
作者:曾峰柏 / 工研院材化所
★ 本文節錄自「工業材料雜誌307期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=10443