封裝技術簡介
電子構裝的目的在賦予晶片一個完整性的組織架構,使其能發揮穩定的功能。何謂封裝?其範圍包含晶片的黏結固定、電路聯線、結構封膠與電路版之結合、系統組合,以至於產品完成之間的所有製程,其功能包含:1.電源分布:晶片要能作用,需要外界供給一定的電源來驅動,外來的電源經過構裝內部的重新分配來驅動晶片,使晶片得以正常運作;2.信號分布:晶片中所產生的訊號或由外界輸入的訊號,須透過構裝內部的連接線路傳遞,使晶片的功能得以發揮;3散熱功能:晶片的發熱量非常大,一般LED 為2~3W ,而高功率的LED 則高達10~15W ,因此須藉由構裝建立散熱的機制,使整體的Package 溫度在85°C 以下,讓LED 能正常運作;4.保護功能:構裝可將晶片密封在Package 內部,隔絕外界的污染及外力的破壞。
而封裝是以建立各層級間介面結合(Interconnection)為基礎的技術,其製程技術以五個不同層級區分:第一層級為將晶片直接封裝起來,其中晶片藉由Wire Bonding、Flip Chip或Tape Automatic Bonding,簡稱TAB 的技術,將IC 的I/O 連接出來;第二層級為將構裝後的IC 黏著至印刷電路板上,其附著方式有兩種,一為通孔插裝(Pin Through Hole; PTH ),另一方式為表面黏著技術(Surface Mount Technology; SMT);第三層級為將黏著各種元件的板子組裝到主機板;第四層級為將整個系統組裝成產品;銲線接合(Wire Bonding)、捲帶式自動接合(Tape Automated Bonding; TAB)和覆晶接合(Flip Chip)將晶片直接組裝於電路版(COB)技術的發展趨勢,第一層級和第二層級封裝間的區分變得相當模糊,通常COB 稱之為1.5 層級封裝。
封裝熱阻的定義
1. 封裝熱傳標準
初期的電子熱傳工業標準主要是SEMI標準,該標準定義了IC 封裝在不同的測試環境下,如自然對流、風洞及無限平板的測試標準。1990 年之後, JEDEC JC51 委員會便邀集各廠商及專家學者開始發展新的熱傳工業標準,針對熱管理提出多項的標準規範與法則,其中包含了已出版、已提出及建議提出等部分,熱管理相關標準整理如表一所示。
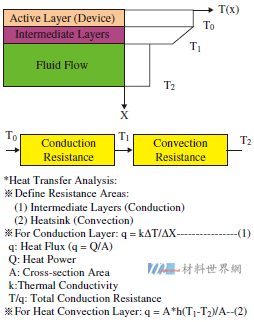
圖五、One Dimensioned Thermal Model
高散熱基板技術
1. Metal Housing Package
如圖六所示, 其結構由Fe-Ni-Co Material with Ni/Au Plating 或CuW 與陶瓷基板或玻璃護封方式將Pin 腳與金屬外殼絕緣,而使晶片訊號可傳遞出來,主要利用金屬外殼的高散熱性將晶片產生的熱導出及高度的氣密封裝與惰性氣體充填等特性。其熱傳導性(Thermal Conductivity)為150~220W/m-K ,主要的應用為Photodiode 、Laser Diode Package 、光通訊元件及LDMOS 、GaN 、SiC 、GaAs 等晶片元件的封裝。
3. 低溫共燒陶瓷(LTCC) Package
低溫多層陶瓷共燒製程技術起源於高溫多層陶瓷共燒技術及厚膜印刷技術。一般的厚膜印刷技術是在氧化鋁基板上印刷一層導電金屬後,經過乾燥燒附,再進行介電層之印刷,如此反覆金屬及介電層或電阻層之印刷及燒附步驟,所以有層數之限制。使用之金屬為Ag 、Cu 、Ag-Pd 、Au 高導電性金屬,且可在900°C 燒附,製作成本較低,但經多次印刷,良率較難控制。而低溫多層陶瓷共燒技術則結合此兩項優點,其應用範圍廣泛,包括軍事、航太、通訊、汽車、電腦、民生用品及醫療等電子零組件及電路板皆可使用此技術製作。
在散熱上, LTCC 基板的熱傳導性為3 W/m-K ,並不高,但可透過Thermal Via或散熱結構的設計來提高基板的散熱性能,以下將介紹幾種Thermal Via 的結構及散熱性: Thermal Via 結構:圖七為C-MAC MICROTECHNOLOGY 所提出的結構及散熱性比較; DuPont Thermal Via 結構:圖八為DuPont Thermal Via 結構、散熱性、不同結構的散熱性提升方式,其較特殊的結構為在生胚與生胚中間夾一層銀片,形成三明治結構,再透過Thermal Via 將熱導出,可將熱傳導性為3 W/m-K 的LTCC 基板提高至100 W/m-K ,大幅增進其散熱特性,表二為不同結構下熱傳導性的提升。另外,結構上Thermal Pipe 如圖九的設計,可變成強制主動性的散熱機制,其散熱率為100 ml/min 的流量可帶走10W………以上內容為重點摘錄,如欲詳全文請見原文

圖八、DuPont Thermal Via 結構
作者:邱國創 / 工研院材化所
★本文節錄自「工業材料雜誌306期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=10376