王祥任、許義龍、藍文正、李裕安 / 抱樸科技
原子層氣相沉積(ALD)與原子層氣相蝕刻(ALE)是目前半導體先進製程中的關鍵技術。ALD自1970年代開始發展,因其具備高精準薄膜厚度與高階梯覆蓋率特性,廣泛應用於High-k金屬閘極、3DNAND、TSV/TGV封裝、太陽能電池及2D材料等。而ALE則在2000年後逐漸成熟,透過自限性反應實現原子級精準度蝕刻,應用於GAA/FinFET結構蝕刻、高深寬比蝕刻以及二維材料的層數控制。未來,ALD將面臨沉積速率與前驅體限制,ALE的挑戰則為材料選擇比與量產效率。將兩者結合成ALD-ALE超循環(ALD-ALE Supercycle),有望成為次世代2 nm的關鍵技術與二維材料元件製程的核心。
【內文精選】
原子層氣相蝕刻技術
ALE基本上是從ALD技術衍生出來的逆向反應,與ALD不同的地方在於ALE是原子級的單層蝕刻,利用重複的循環反應精準地一層層進行原子層等級的蝕刻。從圖三中可以看到,ALE與ALD同樣都是需要四個程序來完成一個循環,核心原理都是Self-limiting,確保厚度控制在原子層等級。其差別在於ALE的第一步驟是表面改質(Surface Modification),在材料表面吸附蝕刻性物質,使其轉化為更易揮發或更易去除的狀態。常見方式有氟化改質:例如在Si表面引入F,形成Si–F鍵;或是氯化改質:例如在金屬或氧化物表面引入Cl。在表面改質完後,第二步驟同樣為將多餘的氣體移除,接下來第三步驟則是活化與移除(Activation + Desorption),藉由物理能量(離子轟擊、熱能)將修飾後的原子層逐層去除,以確保每次只移除單層或次單層厚度。第四步驟同樣是將多餘的氣體以及蝕刻後的副產物移除。
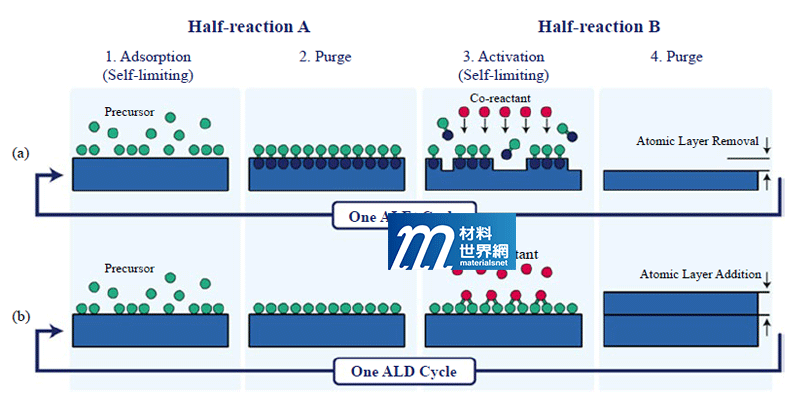
圖三、ALE和ALD反應程序示意圖
另一種常見的原子層蝕刻則是採用電漿式ALE (Plasma-enhanced ALE; PE-ALE)。首先把蝕刻氣體用電漿解離(如Cl2、SF6)來對材料表面做改質,然後再用低能量的離子轟擊(如Ar+),進而將表面改質層移除。PE-ALE的優點為速率較快,並且較容易控制離子能量達到蝕刻選擇性,且可蝕刻的材料種類較為廣泛,但其缺點是相較T-ALE的表面損傷稍微大。除此之外,PE-ALE由於利用基板偏壓來加速離子的撞擊,因此蝕刻方向偏向非等向性蝕刻;而T-ALE是利用表面的自限性反應,因此屬於等向性蝕刻。
相較於傳統的反應式離子蝕刻RIE(Reactive Ion Etching),ALE蝕刻速率雖然慢,但是蝕刻厚度的精準度較高並且表面損傷較小,使表面能夠在蝕刻後維持低粗糙度(圖四)---以上為部分節錄資料,完整內容請見下方附檔。
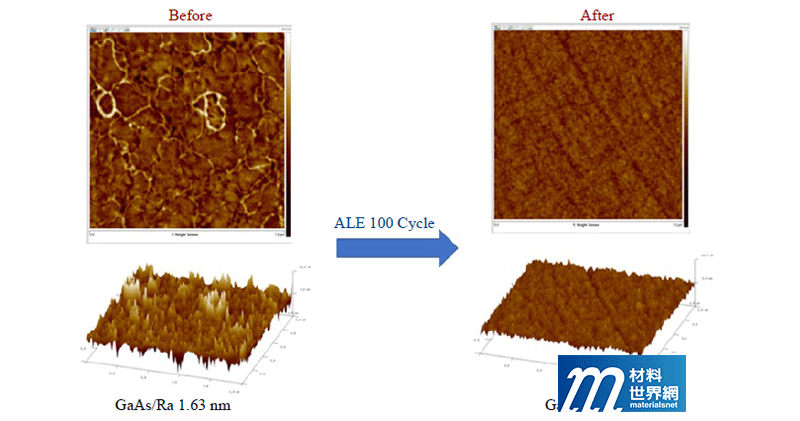
圖四、GaAs磊晶層表面經過PE-ALE蝕刻後表面粗糙度改變,由蝕刻前的Ra = 1.63 nm,經過100 Cycles的PE-ALE蝕刻製程後,Ra減少至0.3 nm
★本文節錄自《工業材料雜誌》467期,更多資料請見下方附檔。