無線通訊平台的射頻封裝解決方案
在IMS2010 Workshop中,Intel的Vijay Nair 博士以『Multi-Protocol Multi-Radio Wireless Platform Integration Challenges』為題,開宗明義的帶出多頻多模在未來行動裝置中的應用趨勢,介紹RF 封裝在其中所扮演的角色。由Intel 的觀點來看,未來在行動裝置上必定會將“代表Data-com 的Netbook”與“代表Telecom的Mobile Phone”做整合,在這個框架下,其中會遇到將單一功能的系統電路做小(Decreasing the Form Factor), 並同時增加應用功能(Increasing Functionality);也因此將會有一個所謂的無線通訊平台來做整合,並使這些不同規格的RF 與Digital Logic 電路共存。其中要使這個平台得到最佳化的運作,則必須解決平台內的問題,如多晶片、封裝及測試層級等問題。
由圖二可以了解,從近身無線通訊到衛星無線通訊,不斷地有許多通訊協定被定義與開發出來;亦可以了解到,一個手持行動裝置為了要能同時滿足近距與遠距通訊,則必須整合多個通訊協定。因此帶出未來行動通訊裝置,將朝向多頻多模並存的趨勢發展。
再由另一個面向來看,過去3C 電子產品的兩個版圖:以高資料量運算為主Data Communication 的電腦、筆記型電腦;以及無線通訊裝置的Tele-communication ,如圖三所示。現在已逐漸明顯整合(Integration),如智慧型手機,而搭配雲端運算技術,未來在行動通訊、行動運算上,『整合』將是主導新產品的發展趨勢。唯有如此,才能實現行動通訊裝置“高運算能力化”,遠端高運算伺服主機“高通訊量化”,也才能帶出高傳輸量無線通訊的需求。因此,無線通訊技術也從過去的單一通道系統,轉變至今日的多通道系統,如圖四所示。

圖四、無線通訊技術之通道系統
在多通道系統上,由於有多個射頻前端模組,故其間的干擾問題,為此一技術衍生的困難點,也是前所未有的技術挑戰。此多通道系統可以僅是單純的一種多通道通訊協定,也可以是多個通訊協定的整合型通訊系統。從此趨勢來看,無線通訊的未來就是要建構一個系統整合平台,再基於這樣的平台,來解決各通訊系統中的問題。此時便帶出了實現此多頻多模的無線通訊平台。其中一個技術就是採用系統單晶片(SoC);另一個就是系統構裝技術(SiP)。而對Intel 來說, SoC 與SiP 技術應同時並行,才是最佳化的解決方案,如表一所示。
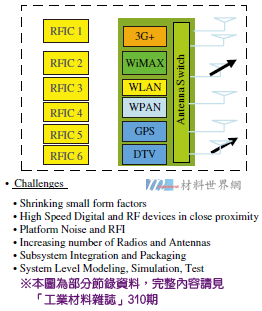
圖五、RF SiP 開發的技術點
接著針對Intel的Dr. Telesphor Kamgaing所提出的RF SiP 基板設計Embedded Passives技術。Intel 將RF 事業移到以色列後,其在亞歷桑那州(Arizona)的封裝事業部,有關RF 封裝技術仍然予以保持。2003 年工研院電光所在IPC 研討會發表Embedded Passives相關的論文時,就遇見Intel 的Dr. Telesphor Kamgaing 及Dr. Rockwell Hsu 。當時兩位都在Intel ,負責協助RF SiP 基板與Embedded Passives 技術,並且在Intel 公司內部啟動相關的前瞻計畫。此計畫仍繼續在執行與前進中,並且有一些成果……以上內容為重點摘錄,如欲詳全文請見原文
作者:蔡承樺 / 工研院電光所
★ 本文節錄自「工業材料雜誌310期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=10638