李文欽、丁文彬 / 工研院材化所
近年來國內載板大廠競相擴增ABF載板產能,月營收屢創佳績,市場普遍預期國內載板產線至少滿載到2023年底。然而,面對半導體封裝製程日益劇烈變化,資本投入是否能在載板需求衰弱前來得及回收,已經是許多投資人心中的疑問。ABF載板市場未來可能因扇出型晶圓級封裝(FOWLP)與扇出型面板級封裝(FOPLP)技術的持續發展而面臨壓力;而5G應用帶動的W波段到毫米波天線封裝需求,將會對ABF等封裝材料特性要求越來越嚴苛。本篇文章幫讀者整理幾項ABF載板最新的技術研究,盼能一起思考國內載板產業未來發展的機會與挑戰。
【內文精選】
前 言
是鮮味精原料拿來做IC載板絕緣材料,這麼跳Tone的構想,當初連發明國日本的半導體產業也都無法接受。但是味之素很自豪地將自己發明的載板絕緣材料命名為ABF (Ajinomoto Buildup Film),並且在高階IC載板絕緣材料市場獲得巨大成功;ABF載板之所以稱為ABF載板,是因為當初只能用ABF材料才能做得出來。味之素在1996年開發這個ABF絕緣材料時,雖然只花4個月,但後來卻持續推廣了3年才找到外國客戶簽約力推ABF載板。開發ABF材料的基礎其實在1970年代就開始建立,當時生產味精的副產品需要找尋新產品應用,所以展開長達幾十年的基礎化學研究;換句話說ABF材料不是一蹴可幾的,ABF產品是應用了味之素累積20幾年的基礎研究成果。相關ABF材料之品項、組成與使用方式請參圖一。
圖一、味之素開發之ABF材料的品項、組成與使用方式說明
載板Core層玻璃材料的超高頻應用
喬治亞理工學院的3D系統封裝研究中心(3D Systems Packaging Research Center; PRC)這幾年持續在玻璃絕緣材料高頻應用領域發表多元的研發成果,包括上述康寧柔性鋁陶瓷片基板材料也是透過跟喬治亞理工學院PRC合作進行。PRC的超高頻封裝研究中,玻璃材料主要是當作Core層,上下製作線路重佈層(Redistribution Layer; RDL)所使用的有機絕緣材料主要是用ABFGL102。PRC因應未來6G無線通訊的RF(Radio Frequency)天線頻率將會達到100 GHz以上,嘗試整合140 GHz RF天線元件到載板封裝中,並在2021年ECTC發表相關成果。
PRC之所以集火於玻璃材料研究,是因為他們認為玻璃基板比目前半導體級EMC (Epoxy Molding Compound)材料高頻電性更優異;透過內埋晶片或打孔將晶片封裝於底層,上層封裝面積可以盡量留給天線元件使用,在需要時更容易擴大天線陣列數量。2021年PRC另外發表一篇關於晶片內埋於Core層玻璃基板中,如何透過RDL層連接天線元件和下層錫球的基礎研究。
JSR在2022年和PRC共同發表了一篇研究,探討透過玻璃Core層進行垂直方向無通孔超高頻電訊號互連的可行性。這篇研究頗有趣味,筆者預想JSR想在這篇研究拿自家材料挑戰ABF材料,但是努力讀完整篇內容卻發現JSR沒有特別強力的數據可以打壓ABF;看來可黃光液態絕緣材料和乾膜絕緣材料在超高頻電性表現仍是在伯仲之間。
ABF材料在FOWLP和FOPLP的應用
味之素子公司Ajinomoto Fine-Techno Co. (AFT)已經參加由Fraunhofer IZM主導的Panel Level Packaging Consortium 2.0,並且提供新開發ABF材料和KT7系列感光型介電材料,促成面板級封裝量產新製程迅速確立。該聯盟主要成員來自日本、美國和歐洲,英特爾也有參與,但國內僅看到電鍍化學品廠商參與其中。LE和MI系列之所以能打進半導體封裝製程,靠的是低應力樹脂設計和奈米級粉體的高含量添加技術;圖七(c)是Shu Ikehira對低應力樹脂設計的圖示說明。LE/MI可以達到線寬/間距2 μm/2 μm和直徑5 μm精密通孔的製程要求,LE同時可以在原有PCB載板RDL層使用。
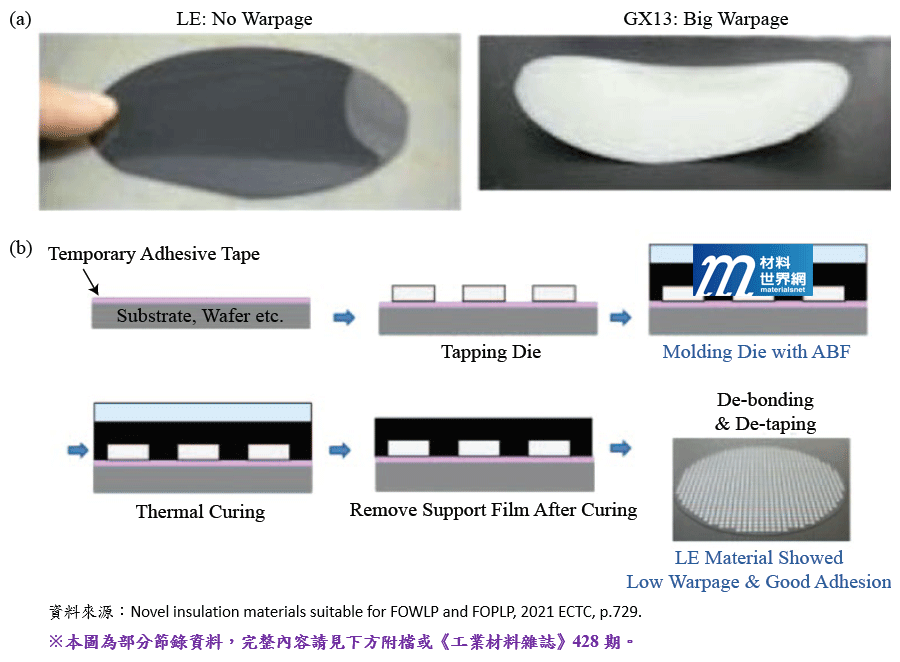
圖七、(a)ABF LE系列低翹曲的特性比較;(b) LE系列進行WLP/PLP Molding Process說明與結果;(c) LE系列採用新型低應力高分子結構設計
台積電在2021年發表一項具革新性的SoIS (System on Integrated Substrate)晶片封裝技術,這命名非常中規中矩,畢竟集成基板是非常籠統廣泛的技術稱謂;深入閱讀後筆者突然醒悟,如果SoIS封裝產能大量開出,ABF載板廠的技術發展Roadmap可能要跟著修正了。過去電路板的高層數技術發展,已經成為ABF載板產品技術升級的教材,但是適合高層數用的ABF材料仍然在研發中,導致高層數ABF載板量產遇到良率瓶頸。採用台積電先進製程生產晶片的客戶們,對於高階ABF載板的缺貨變成自家產品出貨量瓶頸的問題必定難以接受,因為ABF載板價格比起先進製程晶片價格實在是差太多---以上為部分節錄資料,完整內容請見下方附檔。
★本文節錄自《工業材料雜誌》428期,更多資料請見下方附檔。