3D IC 於手機的應用
1. 第一波應用:CIS 、MEMS
3D IC 鎖定的驅動力與應用市場,第一波將以滿足小型化需求為主要驅動力,影像感測器(CMOS Image Sensor; CIS)及MEMS應用市場已於2007~2008 年間逐漸開啟,以Toshiba 在2008 年所量產TSV 技術架構的照相模組來說,較傳統照相模組的體積大幅縮減64% ,有助於符合照相手機與數位相機輕薄化的需求,而Apple於今年5 月所發表的iPhone 4 更可發現最新OmniVision 背照式感光元件(Backside Illumination Sensor; BSI)技術,可在1.75 µm-pixel 的面積上運作500萬畫素感測功能。另外,智慧型手機的MEMS 麥克風、MEMS 陀螺儀和MEMS 加速度計皆有TSV 技術的身影, Nokia 於2006 年就已採用TSV 技術於手機MEMS中,該模組使用一個Silicon Interposer 搭配一個MEMS 麥克風和一個ASIC 。
在iPhone 4 的帶動之下, BSI 技術在智慧型手機的應用將越來越廣。BSI 技術將感測器的上下層顛倒,因此感測器可以透過原本是感測器底層的矽基來收集光線,與傳統的前面照度(Front Side Illumination; FSI)影像感測器相反,如此可增加每單位面積的敏感度、改進亮度的效率與降低光學反應不一致的問題。BSI 具備較大的畫素尺寸,也能夠支援高畫質視訊錄影功能。根據iSuppli 的預估,今年應用在中高階智慧型手機產品的BSI 感光元件出貨量將達到3,340 萬組,至2015 年BSI 的市場規模將擴張近10 倍,出貨量上看3 億組。到2014年,約有75% 的中高階智慧型手機採用BSI感光元件。不僅Apple 大幅採用BSI 感光元件, SONY 、Toshiba 、Aptina 、Samsung已於2010 年量產相關產品。
2. 主要應用:Logic + Memory
3D IC 第二波用於手機的主打為邏輯和記憶體的堆疊,主要的驅動力來自於4G 通訊時代來臨,手機影音多媒體功能及傳輸的需求會導致應用處理器或基頻處理器和記憶體之間的頻寬不足,記憶體大廠Elpida 也認為,下一代Mobile DRAM 需要高達12.8GB/s 的頻寬才可支援4G 時代手機傳輸功能的需求,而使用Mobile Wide IO DRAM 加上TSV 技術,才可做到如此高的頻寬,因此手機的邏輯和記憶體堆疊被公認是3D IC最大的應用市場。
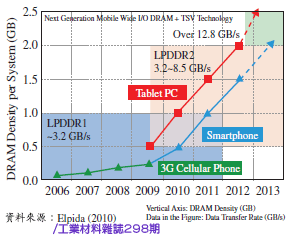
圖七、Elpida 次世代行動記憶體之技術藍圖
聯電、Elpida 和力成三大廠於2010 年6 月宣布跨界合作,共同開發Logic IC 和DRAM 的3D IC 異質整合完整解決方案,運用Elpida 的DRAM 技術和聯電28nm先進邏輯技術,搭配力成的封裝技術,聯手搶食手機應用大餅。三方在合作模式上,聯電之28nm 製程後閘極(Gate-last)高介電係數和金屬閘極(HK/MG)研發在2010 年底即進行客戶矽智財驗證;力成與Elpida 就TSV 技術探討了兩年之久,隨著Elpida 已量產,力成也將會配合提供後段的服務,以Via Last技術為主,力成預估3D IC 技術將在2011年進入送樣階段,最快2012 年量產。
3D IC 應用於手機之市場值
2010 年台灣為全球3D IC 最大的量產國,占全球總晶圓產量的45% ,目前以生產影像感測器、MEMS&Sensor 為主。預估在2012 年,隨著4G 通訊技術的應用,手機的TSV 技術應用於邏輯和記憶體的整合將會起飛,至2015 年邏輯和記憶體的應用將占3D IC 總產值的……以上內容為重點摘錄,如欲詳全文請見原文
作者:陳玲君 / 工研院產經中心