當材料尺寸小到奈米尺度範圍時,其許多物理與化學性質就與塊材性質大不相同。以生活中最常見之奈米光觸媒(二氧化鈦,TiO2)為例,當二氧化鈦奈米光觸媒尺寸在30nm以下且結構為銳鈦礦時,其達成光觸媒反應效果最佳。因此如何控制材料尺寸與結構,並進一步利用檢驗設備來驗證其製程參數就變成相當重要的課題。
隨著電鏡試片製備技術的發展與高性能商業電鏡之推陳出新,原子級之影像解像度早已不再是遙不可及的夢想。國際上電鏡發展趨勢目前朝向次原子尺度與次能量尺度(Sub-Å and Sub-eV)邁進,而目前工研院奈米中心之200keV穿透式電鏡(JEOL JEM-2100F)之影像解析率約在1.9 Å、電子損失能譜能量解析度約在1eV。雖然工研院新購置的電子顯微鏡設備尚未達到國際最高水平,但對於所內許多應用型研究而言,只要提升功能型之分析技術,仍可與世界一流研究分庭抗衡。綜觀工研院的各項大型研究計畫,從奈米科技、生醫科技、化工材料到光電產業,所面臨的是「五花八門,軟硬兼備」的樣品種類。以有機薄膜電晶體(OTFT)為例,由於有機材料的許多特殊性質、如低成本、可撓性與輕便性等等,使得現在許多無機元件中都融入有機材料。因此對檢測而言,所面臨的不單是日益縮小的超薄膜,而且是有機無機的超薄膜混合體(hybrid)。不論材料型態如何改變,研發者想要應用表面分析技術與電鏡技術來窺探與瞭解的是這些材料結構在不同製程下其成分、化態、微結構等性質變化情形。
為了因應上述各項計畫對元件特性之檢測需求,將簡略介紹超薄樣品製備技術與次奈米級電子能量損失光譜分析技術之發展概況。此次利用工研院奈米中心之前瞻電鏡試片準備室與場發射穿透式電子顯微鏡(型號:JEOL JEM 2100F),發展超薄TEM (<50nm) 樣品製備技術(for sub-nano EELS analysis)與次奈米級電子能量損失光譜分析技術。
超薄TEM樣品製備技術
1.技術簡介
此次所發展之超薄 TEM (<50nm)樣品製備技術,是以楔型研磨技術為基礎所衍生之樣品薄度控制技術。此技術比其他的技術有較強的可塑性,不但可以做平面研磨,也可以做橫截面研磨,也可做精確平面-橫截面研磨。目前楔型研磨技術已被公認為機械研磨最精緻的技術,利用此工具可以直接機械研磨得到精確定點SEM的試片。本研究即是利用俯視平面研磨技術,再搭配研磨載具所設計之角度控制器藉以達到精密角度控制之目的。分析樣品最後都放置於離子減薄機做最後的減薄及清潔動作,從厚的地方向薄的地方修減,即完成最後完整試片。
2.實驗結果
此次利用半導體metal-insulator-metal(簡稱,MIM)電容結構之多層膜樣品作為研究載具,這裡選用之材料為AlCu/Ru/MIM/TiN/Si,樣品薄膜厚度約為300nm。利用GATAN PIPS(精密離子束研磨系統)將樣品減薄至<50nm,以利於EELS分析。一般而言,PIPS可以控制之參數為:載台選轉速度、離子束能量、離子束電流強度。實驗結果發現,當樣品厚度由100nm減薄至50nm時,必須將離子束角度與離子束能量與電流束調小,這樣比較容易控制檢薄之速度與樣品深度。實驗最佳參數為:離子束能量:2kV與離子束角度:2度。圖一為經過離子束減薄之後,樣品透光程度示意圖,我們可以反覆利用光學顯微鏡下投式穿透光來判斷樣品減薄厚的厚薄程度。

圖一、利用光學顯微鏡利用光學顯微鏡下投式穿透光來判斷樣品減薄厚的厚薄程度
次奈米級電子能量損失光譜分析技術
1. 場發射穿透式電子顯微鏡簡介
場發射穿透式電子顯微鏡與一般傳統穿透式電子顯微鏡比較,其主要特色有二:(1).電子束可匯聚至次奈米尺度,可以進行次奈米尺度之微區分析;(2).電子束相干性佳,物鏡之轉移函數在高頻時遞減較慢,較易得到原子級解析度。除這兩大特色外,常配掛在場發射穿透式電子顯微鏡之分析儀器有X光能量分散光譜儀(EDS)、電子能量損失譜儀(EELS);除此之外,儀器加上掃瞄系統,即為掃瞄穿透式電子顯微鏡(Scanning Transmission Electron Microscope, STEM),此掃瞄線圈將電子束在穿透式電子顯微鏡試片上掃瞄,經過偵測器接收,再重組影像,可得二維影像訊息。掃瞄穿透式電子顯微鏡一般有兩種機型,其一為一般穿透式電子顯微鏡,加裝掃瞄線圈,稱(S)TEM,將微細電子束在試片區域上做二維的掃瞄;另一種為掃瞄穿透式電子顯微鏡STEM,其電子束經聚焦掃瞄在試片上,即由偵測器接收,無須後段之投影透鏡組,減少後段透鏡組之影響,解析度可較佳。

圖二、CTEM與STEM電子光學路徑與成像方式比較圖
一般場發射式掃瞄穿透式電子顯微鏡之影像解析度可以達到原子級程度。由於STEM同時具備原子級影像解析與空間掃瞄能力,使得二維以上之空間訊息得以解析出來。相較於EDS僅具有元素組成解析能力,EELS更可以提供豐富之材料性質訊息,如:介電性質、能隙量測與分子鍵結。因此,近年來各國積極發展之STEM EELS spectrum-Imaging分析技術。
2. 次奈米級電子能量損失光譜分析技術
在電鏡中的二維能譜成像(Spectrum-Imaging)檢測技術,主要有兩種能譜影像分析方法,均可以同時得到空間與能譜I (x, y, △E)之訊息。一為能譜影像 ( STEM Spectrum-Imaging ):利用電子束掃瞄的方式來取得一系列二維訊息之電子能量損失譜。二為影像能譜 ( EFTEM Spectrum-Imaging ):藉由一系列之能損影像之特定位置,來重整建立能量損失能譜。STEM Spectrum-Imaging可以應用之領域相當廣泛,如奈米顆粒(催化劑)、奈米超薄膜等,不但可以提供樣品之分佈情形,還可以解析出原子結構之分子鍵結型態。
目前國際上之技術水準均能達到<0.5nm左右之空間解析度,約領先我們1.5~2年左右。STEM Spectrum-Imaging在國內材料檢測應用上卻並不廣泛,原因在於(1).硬體設備不是標準配備,國內研究單位因礙於經費與人力原因,選購此項設備意願低。(2).檢測技術本身對檢測人員之背景要求過高,往往資料之擷取與判讀需要有電子能量損失能譜知識背景的研究人員才能處理。因此若能透過計畫建立完整且可靠之STEM Spectrum-Imaging檢測技術,對國內的超薄膜分析上都有很大之幫助。在發展次奈米級電子能量損失光譜分析技術上,工研院奈米中心之穿透式電子顯微鏡於去年度已建立電子能量損失譜之掃瞄擷取功能之硬體設備。而發展此項技術需要突破的困難點有:(a).樣品必須控制在50nm以內、(b).表面非晶層需控制在5nm以內、(c).樣品能量漂移問題與(d).試片漂移問題。至於樣品品質部分,將利用本研究開發之超薄樣品製備技術來達成。在能量漂移問題上,針對能量過濾系統量測單位時間之能量漂移速率,藉以瞭解能量漂移與時間的關係。
3. 線與面掃瞄之次奈米級電子能量損失光譜分析技術
本研究所建置之次奈米級電子能量損失光譜分析技術可分為兩種:(1) 線掃瞄空間訊息,如圖三(b)所示、(2)面掃瞄空間訊息,如圖三(a)所示。

圖三、次奈米級電子能量損失光譜分析技術
(a).線掃瞄空間訊息、(b).面掃瞄空間訊息
EELS面掃瞄之分析時間較為冗長,以一個60 pixels × 40 pixels之面掃瞄影像訊息來說,如果一個能譜記錄時間為1秒,每格60秒做一次影像位漂移校正,則所需時間約為40分鐘。因此對系統之穩定性要求相當高。通常影響EELS spectrum-imaging影像品質的因素有:(a).樣品必須控制在50nm以內、(b).樣品能量漂移問題、(c).試片漂移問題。薄樣品製備技術,我們可以利用GATAN PIPS離子減薄機的電流與角度參數來控制。而能量與試片漂移問題可以透過軟體在實驗過程中校正。此次發展之次奈米級電子能量損失光譜分析技術,空間解析度可達0.5nm,並可提供一維線掃瞄元素分佈分析(見圖四)與二維面掃瞄成分分佈分析(見圖五)。
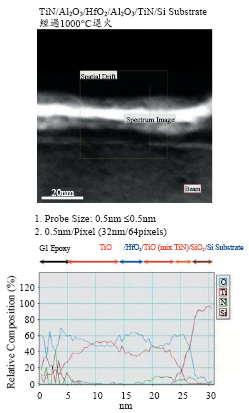
圖四、二維空間EELS定量成分分佈檢測技術建立-線掃瞄分析

圖五、二維空間EELS定量成分分佈檢測技術建立-面掃瞄分析
實驗結果顯示次奈米級電子能量損失光譜分析技術可以解析>0.5nm空間解析度之元素分佈情形,圖四顯示在多層膜層底部有元素因為擴散而產生之聚集情形。圖五顯示退火失效主要原因在於TiN氧化形成TiO2。此次所發展之次奈米級電子能量損失光譜分析技術搭配高分辨顯像技術(HRTEM)、與nano-scale EELS元素分佈分析成功地應用在MIM奈米電子薄膜材料分析上,可以提供快速且精確之研究成果。未來我們將朝更小尺度之元素分佈分析與分子鍵結分析,以滿足半導體元件日益縮小之趨勢。
作者:羅聖全、林明為、陳淑貞、李世莉、林麗娟
出處:工業材料雜誌254期
★詳全文:https://www.materialsnet.com.tw/DocView.aspx?id=6658