張香鈜/工研院電光所
由於高階手持裝置需要整合各種不同功能之晶片,且持續有高效能、低功耗以及微縮化之需求,因此利用三維晶片封裝之異質整合技術持續受到重視,尤其在現在物聯網以及人工智慧趨勢下,台積電CoWoS製程產能需求也越來越高。由於異質整合堆疊的需要,通常會將12吋晶圓減薄至50 µm以下,在這麼薄的晶片上進行製程就必須要有薄晶圓暫時接合技術以承載晶圓(Carrier Wafer)進行薄晶圓之支撐,而在製程之後須將承載晶圓移除並將殘膠清除乾淨。
整個三維晶圓的製程流程如圖一所示,而暫時接合技術即圖上紅色虛線處。首先將晶圓洗淨後進行黃光製程定義矽導通孔之位置,接著以非等向性乾蝕刻方式製作出矽導通孔,接下來是化學氣相沉積進行絕緣層沉積以及物理氣相沉積,完成阻障層/晶種層(Barrier/Seed Layer) 沉積以利後續電鍍製程執行。再來是以電鍍方式進行矽導通孔的填孔,並以化學機械研磨設備將表面銅移除,完成後可以進行正面的線路製作。接下來則是用暫時接合技術將晶圓接合在承載晶圓上,將晶圓減薄後露出背面銅即可開始製作背面的線路以及凸塊,完成後將承載晶圓分離並洗淨後即完成整個三維晶圓製程。
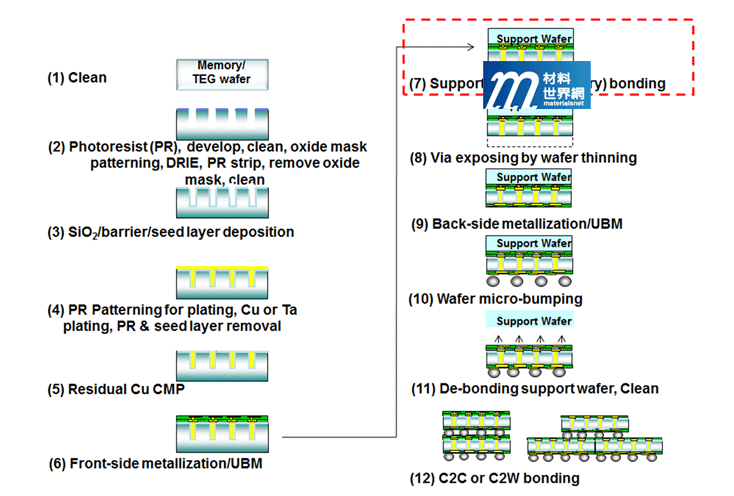
圖一、三維晶圓製程流程及暫時接合步驟(紅色虛線)
在整個三維晶圓製程流程中,除了製作矽導通孔之外,傳統封裝技術比較沒有接觸到的就是暫時接合製程。暫時接合技術最重要的就是材料的選擇,如果後續製程需要有很好的平整性可以選擇熱塑性材料以獲取較好的平整性,而若後續製程需要通過高溫處理則建議選擇熱固性材料,避免高溫時膠材軟化變形。圖二是Brewer Science材料之製作流程,其材料為熱塑性材料,在12吋晶圓上能達到< ± 1 µm之平整性。首先在晶圓上塗佈材料並烤乾,接下來將此晶圓與Carrier Wafer以加熱加壓方式接合起來,經過後續製程之後有三種晶圓分離方式能將其分開,分別是加熱滑動(Thermal Slide)、機械分離 (Mechanical de-bond,需搭配機械分離之分離層)、雷射分離(Laser de-bond,需搭配雷射分離之分離層)以及能夠讓雷射透過之基板(此基板一般為玻璃材質)。
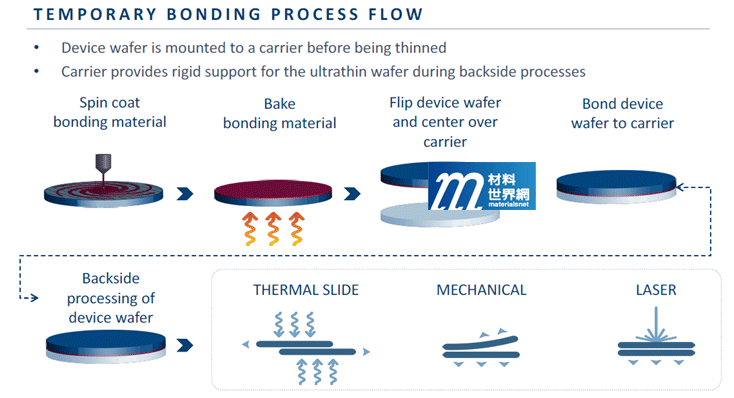
圖二、Brewer Science暫時接合技術
圖三為TMAT材料暫時接合之製程步驟,TMAT材料為熱固型材料,能夠耐溫250℃兩小時以上。其製程步驟第一步為-----以上為部分節錄資料,完整內容請見下方附檔。