環保型印刷電路板的耐燃方式從溴化環氧樹脂逐漸以添加有機阻燃劑與無機耐燃粉體而成為主流,而另一類改善方式則是新型樹脂材料的大量使用。未來毒性低、加工性佳、添加量少、發煙量低且與樹脂相容性好之材料,將成為技術的主軸。以提升基板耐熱性的結構為基礎,使板材具有較佳之耐燃性,同時可提高交聯密度,以提升尺寸安定等特性及價格適當,將成為未來可廣泛應用於高階電子用品以及複合材料的競爭優勢。交聯劑為PCB基板材料主要成分中不可或缺的一種,為提升基材的耐燃效果,可行的方向將是進行複合式的基板製備,即從環氧樹脂、交聯劑與無機粉體三者的搭配來進行,若以成本較低且商業化的無鹵素環氧樹脂與添加無機粉體,配合現行為技術開發重點的高耐熱/ 耐燃性的交聯劑,基材將會因為具有較高耐熱性,可因應較高溫度的無鉛製程,同時在裂解後高含量的苯環可產生較多的焦炭層以達到阻燃效果,從高限氧指數的結果則可得知基材的優異阻燃效果。
市場/ 技術現況與發展
近年來IC 封裝型態從DIP 、SOP 、PLCC 、QFP 轉向BGA 、CSP 、Flip-chip等新封裝型態, IC 載板因具備1.多接腳化;2.縮小封裝產品的面積;3.改善電性及散熱性;4.高密度化,使IC 載板於封裝領域中的應用愈來愈廣泛。根據Prismark 的預估(圖一), 2006~2011 年PCB 產業中,成長幅度最大的產品為高密度多層板(Multilayer Boards)以及封裝載板(Packaging Substrates),年複合成長率明顯高於其他種類,顯示出電子材料的精細化與高效能逐漸成為市場上與民生關切的主流,而我國在這方面的產業概況亦然如此。2007 年我國PCB 產業產值為340,171 百萬元,年成長6.64% ,境內佔58% ,境外佔42% 。帶動我國PCB 成長最主要產品為載板市場的成長。2008 年我國PCB 產業產值為357,680百萬元,年成長5.15% ,整體市場邁入成熟期,再佐以全球市場成長減緩影響,邁入低潮期,如圖二。我國PCB 主要產品別分佈,目前仍以硬式基板為最大宗,載板則是成長最快速的產品項,顯示該二類產品仍是市場經濟主流,因此配合環保的訴求,此類產品的技術研發一直成為首要的對象。

圖一、2006~2007 年台灣PCB產品產值預測
(本圖為節錄資料,詳細資料請參考原文)
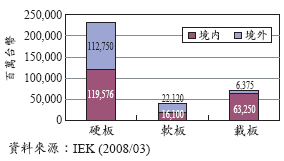
圖二、2007 年我國PCB 產品結構
若是無鹵素無鉛製程基板的功能逐漸可替代舊有材料,同時更能提升既有效能,或是利用價格較為低廉的材料,取代高單價且專利與技術為國外大廠所控制之功能性樹脂材料,未來可取代的市場產值將是令人期待的。
工研院著力於環保型高尺寸安定性基板材料的研發已有數年時間,硬質基板的開發技術初步以耐高溫無機粉體的開發,來改善市售商品料普遍在耐溫性不足的缺點。第二階段進行具有高耐燃效果之交聯劑製作,在著重於低成本的考量下,將現有之商品料逕行具有高耐熱性之結構如Imide 、Ester 、Melamine 及有機耐燃元素如B 與N等官能基的有機結構改質,所完成的交聯劑具有可與環氧樹脂交聯以提升交聯密度,結構上具有不燃性元素可產生阻燃作用,同時高苯環的含量可增加基板耐熱性、低膨脹性及低吸水性等效果。初步成果如圖四所示,改質後之新型態交聯劑具有較高的熱穩定性,從DMA結果得知,新型態交聯劑FR-hardener 1(圖四之B)因其結構上具有較高的苯環數量,使其Tg 從原先之150°C增加到245°C ,顯示所鍵結的苯環除提供較高的熱穩定之外,又可使交聯的結構藉由苯環的均勻堆疊產生的交互作用力來提升其應力模數,同時結構上與原始的商品料相同,僅有一可反應之官能基,但因為在側鏈結構的延伸使其Storage Modulus 起始值從260000MPa 上升到550000MPa ,而在Tg 點時,其值亦從32700MPa 上升到43300MPa ,顯示熱硬化後的結構具有較高的延展性,可提升其應力模數。而另一種新型態的交聯劑FR-hardener 2(圖四之C)則因為結構上除了增加的苯環數量外,亦增加了可自行交聯之官能基,因此其熱硬化的樹脂首先除了無需額外添加催化劑之外,其優異的交聯密度將Tg 值提升到330°C 以上,同樣的在側鏈結構的延伸使其Storage Modulus 起始值從260000MPa 上升到350000MPa ,而在Tg 點時,其值從32700MPa 小幅度上升到35200MPa ,顯示熱硬化後的延展性因為交聯密度的增加而稍微降低。

圖四、熱硬化後交聯劑之DMA圖(B) Modified FR-hardener 1;(C) Modified FR-hardener 2(本圖為節錄資料,詳細資料請參考原文)
一般來說,阻燃效用最有效的機制為可產生自由基捕捉,在這方面以鹵素材料最具明顯功效,但在鹵素禁用後,另一個可產生相同作用的為五價的磷化物,磷化物除具與鹵素相同程度之阻燃效用,在物性的表現上又較鹵素為佳,同時應用在PCB 板材的玻璃轉移溫度(Tg)上較含溴之FR-4 基板更優,但是磷化物的缺點也是周知的,即為吸水性過高,在未來更高功能的通訊用基板材料需求方面,將面臨無法突破的窘境,目前解決方案皆為添加適當的無機粉體以進行改善,在效果上已具有突破。
交聯劑為PCB 基板材料主要成分中不可或缺的一種,為提升基材的耐燃效果,可行的方向將是進行複合式的基板製備,即從環氧樹脂、交聯劑與無機粉體三者的搭配來進行,若以具備高耐熱性的環氧樹脂與交聯劑,配合添加無機粉體,基材將會因為具有較高耐熱性,可延後基材的裂解溫度而能因應較高溫度的無鉛製程,同時在裂解後高含量的苯環可產生較多的焦炭層以達到阻燃效果,從高限氧指數的結果則可得知基材的優異阻燃效果。國內目前許多大廠面臨的壓力在於新技術的創新成果,普遍來看,目前技術仍處於添加磷化物與使用大量無機粉體來達到無鹵PCB的方式,因此在製程上當然也必須負擔前述的成本增加。若要因應更高階產品或是無鉛製程的訴求,可能必須以更高價位的樹脂來替代環氧樹脂,因此從2009 年起將會同時面臨須全面提供無鹵產品,及尋找更新更低成本技術,以抒解對高效能及環保耐燃材料需求的壓力。
對環保型構裝基板材料之發展與應用有興趣者,歡迎mail至materialsnet@itri.org.tw
作者:吳信和、楊偉達、謝青城、劉淑芬 / 工研院材化所
★本文節錄自「工業材料雜誌264期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=7396