對消費性電子產品來說,系統化構裝(SiP, System in a Package)技術所應該展現的主要特色為節省成本與縮小化。而以基板做為整合元件的平台來說,則有兩個方向。其一為運用一般常見的有機材料基板,或是多層印刷電路基板(PWB, Printed Wiring Board);另一者為無機材質的基板,例如矽基板…等等。後者通常具有與晶片電路或製程相結合的縮小化優勢,但成本則是一個考量指標。而對前者來說,除了具有低成本的特性之外,現今已可藉由精良的製程技術:例如高密度互連(HDI, High-Density Interconnection)技術等,再結合特殊材料複合於其中,則仍然可以達到SiP化的要求。
內藏被動元件基板技術的優勢
內藏被動元件基板技術,其主要是利用多層印刷電路板製程,將電容與電阻或其他射頻元件於基板製程中同時實現,並且可以將此種基板應用到5GHz的射頻前端模組(RF front-end module)。在此有機材料基板中,內藏電容主要是利用高介電常數(Hi-DK65, DK>60 @ 1MHz)之基板材料來做應用設計,如此則可以節省許多電極板的面積。另外,也同時以(1 k歐姆/per square)的新式的電阻材料來實現不同的電阻元件值,達成整合各種元件功能的基板。而內藏電感元件一般也可以用一些繞線的方式來設計,如此一來,即可以利用一個基板的製程,整合電容,電阻與電感三種元件,再與主動元件結合成為一個SiP模組。在應用上,此種整合被動元件基板對於射頻電路來說,具有縮小模組尺寸的優點,而在高速數位電路的應用上,亦提供了低成本的去耦合電容(De-Coupling Capacitors)的解決方案。由於IEEE 802.11a以及ETSI HIPERLAN-II [2]標準在5-6GHz頻段的發展,已經對許多對無線收發機在高速數據傳輸的要求做了定義,因此,我們將提出一個應用在C-band且具有高線性度的前端功率放大器SiP模組設計。此電路是設計在一個6層的有機材料HDI壓合製程基板上。透過一個新開發具有高介電常數與低損耗因子特性的材料,可以縮小電路與功能性元件的尺寸,並且這些小型化元件的電氣特性,寄生效應等,也在設計時要一併考慮。
工研院電光與材化所共同發展基板內藏被動元件的RF模組
基於消費性無線通訊電子產品對於低成本的考量,工研院電光所與材化所多年來致力於研發一種運用基板內藏被動元件的RF模組。歷年來已完成2.4GHz壓控振盪器(VCO),帶通濾波器(BPF),平衡轉非平衡器,無線網路功率放大器,藍芽模組與無線網路卡。而現在所要展示的是以一個6層基板的架構應用到更高頻段的5GHz WLAN功率放大器上做驗證。一般來說,高介電常數材料是應用在基板內藏電容元件上;因此表面黏著型(SMD)的電容元件則可以用內藏 電容來取代,也可以省下許多電路表面積來。這樣的6層有機材料壓合基板如圖一所示。此多層印刷電路板 (PWB) 架構為一個具有三對上下相互對稱的6層金屬基板。其中是以一個雙面玻璃纖維板(CCL)做為內層Metal 3與Metal 4的基板材料(Dielectric Material 3),形成做材料載體,藉以提供良好的機械強度;再以壓合製程上下增層(Built-up)壓合具有高介電常數(Hi-DK65)的背膠銅箔(RCC)材料(Dielectric Material 2 & 4),以做為縮小化的內藏電容材料。最後再壓合上具有低介電與低損耗的基板材料(Dielectric Material 1 & 5),此種材料可以提供良好的阻抗匹配,減少訊號的傳播延遲(Delay)以提升元件的品質因素(Quality factor)等。此高介電常數(Hi-DK65)的背膠銅箔為工研院材化所技術團隊所開發,圖二顯示此高介電常數材料之連續放大(Continuously Scale Up)塗佈情形,其意謂著此種新材料已可導入量產階段。表一列出此基板各種材料的電氣特性。通常高介電值材料適於高密度電容的設計。而為了解Hi-DK材料其相對介電常數(Relative Dielectric Constant)與損耗正切(Loss Tangent)對頻率的關係,則採用諧振法來做基板材料測試。由實驗結果顯示,高介電常數值在高頻下會隨頻率而有衰退的現象,如圖三所示。並且由於電容元件的特性與其介電常數值有很大的關聯性,因此需預先對材料特性有所掌握,如此才能建構準確的內藏電容電氣模型。
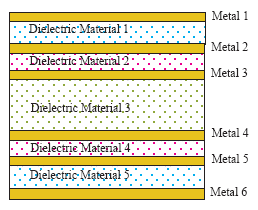
圖一、六層PCB基板結構
資料來源:工研院/工業材料雜誌第251期

圖二、Hi-DK65 RCC型基板材料之連續塗製程
資料來源:工研院/工業材料雜誌第251期
表一、基板材料特性表
|
Layer
|
Material
|
Thickness
|
|
Metal 1~6
|
Copper foil
|
0.7~1.4mil
|
|
Dielectric material 1
|
DK=3.2; DF=0.03
|
4 mil
|
|
Dielectric material 2
|
DK=65; DF=0.04
|
2 mil
|
|
Dielectric material 3
|
FR4; DK=3.2; DF=0.02
|
20mil
|
|
Dielectric material 4
|
DK=65; DF=0.04
|
2 mil
|
|
Dielectric material 5
|
DK=3.2; DF=0.03
|
4 mil
|
資料來源:工研院/工業材料雜誌第251期
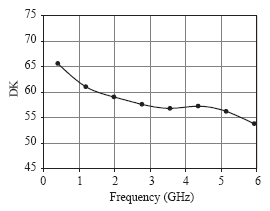
圖三、Hi-DK65之相對介電常數對頻率之特性
資料來源:工研院/工業材料雜誌第251期
5GHz的無線網路功率放大器
透過一個5GHz的WLAN功率放大器來驗證內藏被動元件高頻模型的載具。5GHz的WLAN 是要符合IEEE 802.11a標準的正交頻分多工調變(OFDM)方式,因此它對傳輸路徑上的功率放大器(Power Amplifier, PA)之線性度有很高的要求。此處PA的架構為雙級單端的型式,並且此兩級皆使用GaAs IC,其設計完成後詳細的電路架構如圖四所示。如圖所示,此模組電路其上須有10個電容元件,一個電感元件及2個電阻元件。表二列出此PA模組在以SiP內藏被動元件基板設計後之可實現內藏被動元件情形。由表二可知,僅剩下一個電容元件並未取代到內藏被動元件基板中。這代表著在6層有機材料增層製程的基板中,製作內藏被動元件,可以為一個PA模組提供92.3%所需的被動元件。
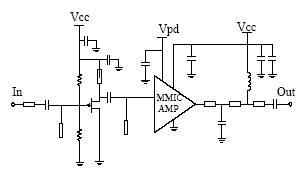
圖四、WLAN PA模組電路圖
資料來源:工研院/工業材料雜誌第251期
表二、以內藏被動元件基板實現PA模組之元件取代情形
|
Item
|
Embedded Passives PA
|
|
SMD
|
Embedded Passives
|
|
Capacitor
|
1
|
9
|
|
Inductor
|
0
|
1
|
|
Resistor
|
0
|
2
|
|
Total passive components
|
1
|
12
|
資料來源:工研院/工業材料雜誌第251期
此外,此PA模組中的各部內藏被動元件亦已為模組特性做最佳化匹配設計,使得此PA模組可以得到最佳的特性。其中此電路中所使用的電感是使用電磁模擬所得的散射參數(S-parameter)做為等效電路模型,而非量測的結果。圖五顯示以6層有機增層法製程基板所實現的WLAN PA模組,其所佔的基板面積約為13mmx10mm。

圖五、運用SiP內藏被動元件基板之WLAN PA模組成品照片
資料來源:工研院/工業材料雜誌第251期
此一運用SiP內藏被動元件基板之WLAN PA模組電氣特性實測結果,如功率增益,三階截斷點(IP3)及1dB輸出功率壓縮點(P1dB),其散射參數特性等特性則顯示如圖六與圖七所示。由量測結果可知,功率放大器所測得的特性為:增益:26.4dB,P1dB:26dBm,IP3:37.2dBm。有這樣的結果即顯示以PCB製程與新式材料做內藏被動元件基板設計,不但是可行的,還可驗證到5~6GHz頻段上。
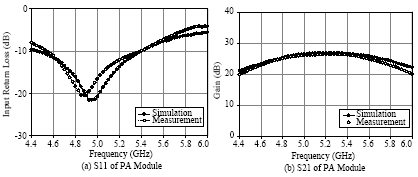
圖六、以內藏被動元件基板實現PA模組之S參數模擬與量測結果比較
(a) S11 of PA module、(b) S21 of PA module
資料來源:工研院/工業材料雜誌第251期
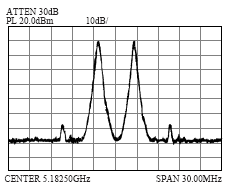
圖七、Two tones test result
資料來源:工研院/工業材料雜誌第251期
聯絡人:陳昌昇03-5913312、劉淑芬03-5916853
★詳全文:https://www.materialsnet.com.tw/DocView.aspx?id=6445