因手機通訊產品與消費性電子朝向輕薄短小的發展趨勢,使得晶片設計越趨複雜與微小化,隨著半導體製程技術能力不斷向上提升,半導體晶片的功能日益強大,以致半導體晶片訊號的傳輸量逐漸增加,過去以導線架(Lead-Frame)的封裝形式已逐漸無法滿足市場的需求,因此半導體封裝方式與技術也同步跟著世代交替發展。
由低階的DIP(Dual In-Line Package)、SOP(Small Out-Line Package)、TSOP等逐漸走向以IC載板的閘球陣列(BGA)、覆晶(Flip Chip; FBGA)、晶圓尺寸封裝(WLCSP)、系統晶片封裝(System in Package; SIP),乃至於3D封裝等高階型態封裝,這些都是為了滿足終端應用市場的需求。隨著半導體封裝技術不斷創新發展,其中關鍵零組件材料機能性感光高分子材料的發展趨勢亦是如此。在高性能及環保的訴求下,鹼性水溶液顯影與低溫的製程條件,低介電、低吸濕、低應力等材料特性都是機能性感光高分子材料的發展方向。
機能性感光高分子材料介紹
1. 感光性聚亞醯胺
聚亞醯胺(Polyimide; PI)是一種含有亞醯胺基的有機高分子材料。由於具有優異的熱安定性及良好的機械、電氣及化學性質,聚亞醯胺一直是高性能高分子材料的首選。在對材料要求嚴格的 IC工業上,聚亞醯胺被用於鈍化膜(Passivation Coating)、應力緩衝膜(Stress Buffer Coating)、α粒子遮蔽膜(α-particle Barrier)、乾式蝕刻防護罩(Dry-etch Mask)、微機電(Micromachines)和層間絕緣膜(Interlayer Dielectrics)等方面,其他新的用途正陸續開發中。目前在這些應用上,以保護IC元件的塗膜(Coating)佔最大部分,主要原因是 PI 材料可通過 IC元件可靠性(Reliability)的測試。
PSPI 則在半導體封裝的演進中(圖二),扮演關鍵材料的角色,從 TSOP 中的應力緩衝層(Stress Buffer Coating)到 WLP 中的重分佈層(Redistribution Layer; RDL),因為 Molding Compound 中都含有大量無機填充物(Filler),為避免 Molding Compound 在加熱收縮時所產生的內應力過大,傷害到元件本身,因而利用感光型Polyimide來形成應力緩衝層保護晶片,一般應力緩衝層材料特性需求為 Elastic Modulus在 2~4 GPa、Yield Strain 5~10%、Tensile Failure Strain > 25%,此外需具有良好的熱安定性以及與基材和 Molding Compound 之間良好的接著性。
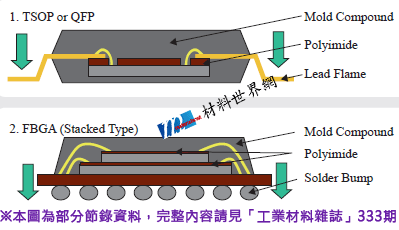
圖二、半導體封裝結構演進圖
圖三為晶圓封裝(Wafer Level Package;WLP)的截面圖,由於原始設計上考量或為了打線的容易性,一般晶圓上晶片的 I/O 焊墊呈環狀分佈在晶片邊緣四周。為了解決此現象,架構在基本凸塊製程的線路重佈技術(RDL)即被應用在晶圓上,其最大目的就是為了重建 I/O 的分佈,使其達到縮小封裝尺寸的要求,RDL 技術主要包含薄膜化金屬導線與有機鈍化層的重佈兩個製程步驟。
Polyimide 優異的介電性質十分適合應用於單層或雙層接腳墊板的重新分佈,它是藉由感光型 Polyimide 將傳統位於晶粒四周的銲墊重新調整安排到整個晶粒的區域(Area Array Bond Pads),再於銲墊上長凸塊(Bumps)做為與外界訊號連接之用,其製程(圖四),在晶圓上塗佈感光型高分子介電材料,目的在增加鈍化層(Passivation)的強度,因為若無鈍化層有針孔存在的話,將使後續的繞線金屬與底層產生短路現象。
表一為日本東麗公司最新發表 LT 系列 PSPI 的物性表,該公司宣稱200˚C以下低溫硬化且低殘存應力,只有 13 MPa,硬化溫度可以降低至 170˚C,其物性與 250˚C硬化的差異不大,圖五為其低殘存應力 Polyimide 結構設計概念,採雙管齊下的方式,其一導入柔軟鍊段於 PI 主結構中,使整體的 PI 分子具有較低的 Modulus,進而在硬化製程中有較低的殘存應力……以上內容為重點摘錄,如欲詳全文請見原文。
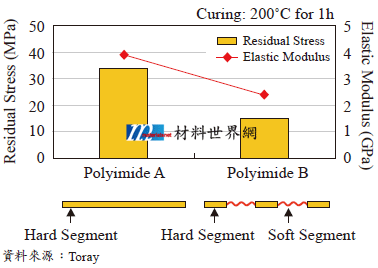
圖五、低殘存應力 Polyimide結構設計概念
作者:鄭志龍/工研院材化所
本文節錄自「工業材料雜誌333期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=17091