前言
隨著時代演進,市場需求端的變化快速,2015年在光電半導體產業的產品將持續聚焦,邁向高效能、多元化整合與輕薄微小化等方向發展,無線與行動穿戴功能設計導向的電子產品,將會成為市場主流。如圖一所示,因應產業變化,IC設計、製造到封測的流程將帶入新的概念。至2015年半導體整體方向,將朝往鰭式場效電晶體( FinFET )結構、泛三維堆疊技術( 3D ICs )與物聯網( IoT )三方向發展,歸納重點如下。
①半體製程為了持續降低成本,未來可能朝 450 mm(18吋晶圓)發展,如圖二所示,成本降低與成長率能持續提升是半導體持續發展的關鍵。但如今建造一座18吋晶圓廠所需經費約 110億美元並提升成長 4~6%,是12吋晶圓廠(約30億美元)建置成本的 3~4倍,且由8吋提升至 12吋晶圓廠時可創造成長率高達 17%,可見投資金額需大幅提升且成長率已下降,相關發展將朝向策略聯盟共同開發(如 G450C 聯盟,預計於2018年試量產 18吋晶圓製程)。台灣佔有晶圓代工高達 60%以上的市佔率,絕對是有發展世界第二座18吋晶圓廠的可能,值不值得與可不可行,正確的規劃與佈局是我國能在半導體製造業持續領先的關鍵之一。

圖二、半導體營收趨勢,18吋晶圓廠成長率較12吋開發時趨緩
④再次工業革命:後 Moore’s Law與工廠生產製造智慧化與無人化時代即將來臨。3D ICs是延續Moore’s Law的方式,而半導體製造的未來、物聯網將帶來新機會。新技術會衍生出新設備的需求,設備國產化也是台灣本土終端廠商降低成本、提升競爭力與技術保護的關鍵。而產品開發將著重在精緻客製化、多功能化與配合產業快速循環,加上就業人力的下降,設備的開發配合生產力4.0(設備智慧化、Big Data、IoT),會是不可或缺的規劃趨勢。
3D ICs技術與市場趨勢簡介
積體電路(IC)在1958年由德州儀器(TI)發表,1980年聯電與1987年台積電以高良率的半導體製程技術將晶圓順利代工量產,從此電子元件改變了我們的生活。1990年起,半導體邁入系統單晶片(SoC)技術領域,可以在單一晶片上整合邏輯、記憶體、運算與其他功能的電路,配合新材料與結構的發展,提供產品微小化的技術並奠定了行動穿戴式的可能性。
技術發展至2015年,台積電(TSMC)在以 SoC+FinFET 結構為核心的 20奈米節點技術,及 TSMC FinFET Plus(FF+)、FFC結構為核心的 16 nm製程技術上(功耗能比 20 nm晶片低 50%、性能可提升 10%),有絕對的市占優勢(邏輯IC供應產能仍然比三星(Samsung)多一倍),而TSMC製程今年底預計邁入10 nm以下,量產時程規劃預計是在 2017年。Samsung雖在 14 nm技術領先(以2015上半年量產為主),但其效能評估仍比 TSMC的 16nm低 10%。
此外,針對主流28 nm產品進行討論,由於Samsung及格羅方德(GF)暫緩 28nm擴充並直接挑戰下個製程節點 14nm技術開發,而TSMC 28 nm產能持續滿載,今年只剩下UMC有能力開出新產能(UMC 28nm良率已達9成以上的穩定階段),另外大陸的晶圓廠中芯(SMIC) 28nm良率過低延遲上市,目前預估至少要到 2016年中芯才有機會將良率提升並小量供貨,所以28 nm市場台灣可望成為最大供應國 ……以上為部分節錄資料,完整內容請見下方附檔。
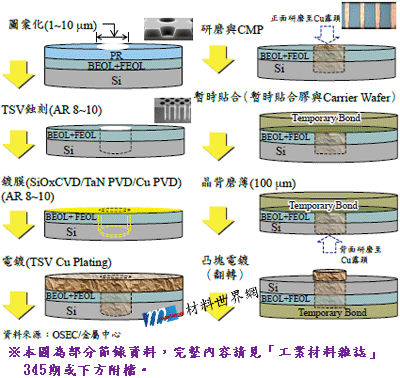
圖八、TSV製程流程
作者:王舜民/金屬工業研究發展中心
★本文節錄自「工業材料雜誌」345期,更多資料請見下方附檔。
★相關閱讀:3D ICs設備零組件與生產力4.0發展趨勢(下)