SiP構裝高度異質整合趨勢
電子產品的系統演進與對元件的規格需求,持續促使元件技術朝小型化、高效能、高整合、低成本等方向前進。在元件的技術發展方面,隨著電子產品的發展朝可攜、省電、高效能、小型化等構面演進,「系統」的概念已由過去「Board Level」的System on Board快速前進至「Chip Level」的系統晶片(System on a Chip; SoC)階段。但面臨異質製程整合困難的嚴重挑戰後,在電子產品強調更嚴苛的上市時程壓力驅動下,元件技術迅速由SoC 技術轉進以構裝技術達成整合目標為主流趨勢,尤其在行動通訊產品的應用方面,由於功能日趨複雜,但同時又受限於尺寸不被期望增加的元件規格需求引導下,諸如系統構裝(System in Package; SiP)、構裝堆疊(Package on Package; PoP)、2.5D IC、3D IC等各種新型態構裝技術在近年來被廣泛採用,如圖一所示。
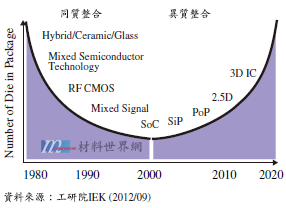
圖一、晶片整合趨勢
SiP 終端系統與元件應用分析
手機裡平均含有12~15 顆IC 構裝和高達300 個分離式及被動元件,因此構裝型態移動至SiP 的原因涉及到分離式及被動元件的數量,如在手機裡的電容器、電感器、電阻器。未來SiP 的特性和趨勢將包括因小型化驅動更小的被動元件、利用覆晶(Flip Chip)及TSV 連接以提供小型化及效能的增加和更薄的SiP 模組。
SiP 一般包含多顆晶片和被動元件,而一些SiP 只有一個主動元件加上許多被動元件。手機增加功能且同時縮小物理尺寸的關鍵是整合力。預估2015 年,每個SiP 裡平均會有3.1 顆晶片和5 顆被動元件。展望未來, SiP 裡的晶片數量將有不斷增加的趨勢,如表一所示。
由表二可知, SiP 模組的市場預估及主要的供應商。堆疊晶片構裝(Stacked Die in Package)的型態是SiP 主力,主要是記憶體產品的堆疊,例如MCP 堆疊構裝,預估2015 年市場可達85 億顆,占總體171 億顆的50% ,相關的廠商多為記憶體大廠如Samsung 、Micron 、Hynix 、SamDisk 等。其次是射頻模組(RF Modules),預估2015 年市場可達38 億顆,占總體的22.2% ,全球主要的RF 大廠如Skyworks 、RFMD 、Renesas 都是主要的供應商。RF 相關應用則包含收發器(Transceiver)、功率放大器(PA)和過濾器(Filter),這些應用變得越來越重要且不斷推動SiP 的增長,許多手機製造商也已經表示未來將會放置更多的SiP 數量在其產品上。

圖四、SiP之終端產品應用情況
全球主要IC 廠商發展SiP 情況
全球前三大封測廠日月光、Amkor 和矽品主要是針對類比IC 、RF 模組、無線通訊晶片包括Bluetooth 、WLAN 、GPS 、Mobile TV 、FM 等進行SiP 的應用布局。而在策略上,日月光於2010 年藉由併購環隆電子來取得RF SiP 模組的設計、組裝和測試能力。此三大廠也佈建整合被動元件(IPD)、2.5D IC 和3D IC 技術的解決方案。此外,以記憶體封測為主的廠商,包括……以上內容為重點摘錄,如欲詳全文請見原文
作者:陳玲君 / 工研院產經中心