超薄型RFIC 3D 模型建立與模擬
本文模擬分析RFIC 3D 模型熱翹曲變形,以壓模樹脂供應商提供之特性建立有限元素模型之材料參數設立,並參考2D 結構模擬結果,進行壓模厚度0.4mm 模擬分析,最後與實際量測比對,確立簡化之模型模擬分析可行性正確無誤後,再進行壓模厚度0.2mm 熱翹曲分析。
1. 3D 模型簡化
基本上,封裝可包含晶片的黏著固定、晶片打線、結構密封與基板的結合,理想情況下,會儘可能建立詳細的分析模型,由於基板上有數百顆晶片及黏膠,在有限的計算機運算資源或演算法限制下,必須簡化模型。圖十為RFIC 封裝結構,忽略晶片打線時熱傳效應之四分之一模型示意圖,實際上打線時,熱傳效應對晶片或基板所產生的熱應力及翹曲變形是非常小的,故圖十是最接近實際的理想狀況模型。
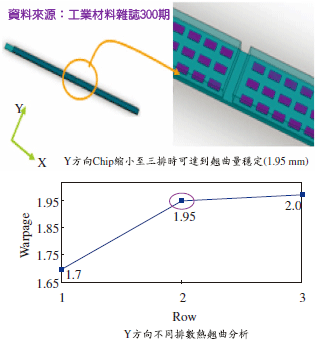
圖十一、Y 方向不同晶片排數熱翹曲穩定性分析
2. 3D 模型邊界條件
相關的邊界條件設定如下:忽略打線的溫度熱傳效應;取1/4 對稱模型;初始狀態應力為零;簡化了銲墊; Y 方向晶片數列為三排;在長度92.6 mm 處設定拘束。
3. 3D 結構壓模樹脂厚度0.4mm 分析
晶片黏著製程分析,升溫至150°C ,模擬翹曲結果為1.9 mm ,基板上緣受到壓應力13 MPa 、下緣受到張應力7.9 MPa 、晶片熱應力為-15 MPa 。主要原因是膠材在150°C 時,熱膨脹係數為170 ppm ,但是楊氏係數僅有0.4 GPa ,相較於基板之楊氏係數200 GPa 太軟,故在晶片黏著製程中主要由基板與晶片作用,基板之熱膨脹係數(11 ppm)大於晶片(2.6 ppm),且膨脹較快,故基板會往上翹曲,如圖十二所示。晶片黏著降溫固化分析,預期膠材會釋放應力且基板之熱膨脹係數(11 ppm)大於晶片(2.6 ppm),基板收縮較快,故基板會往下翹曲。模擬結果為往下翹曲0.2 µm ,基板上緣受到張應力0.05 MPa 、下緣受到壓應力0.019 MPa 、膠材及晶片受到的應力極小,如圖十三所示。
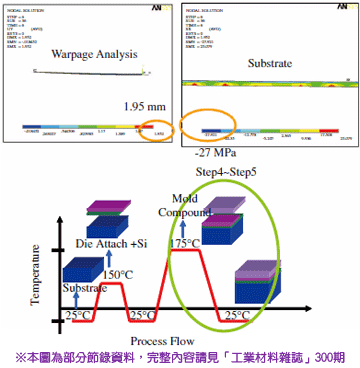
圖十五、3D模型壓模成形降溫固化分析
4. 壓模厚度0.4 mm 模擬結果與量測比對
模擬結果與量測結果趨勢一致,皆為往上翹曲,模擬翹曲量為1.95 mm ,實際測試結果為往上翹曲1.5 mm ,如圖十六所示。因此本文以此簡化模型來分析,當壓模樹脂厚度為0.2 µm 時,基板翹曲變化。
5. RFIC 封裝壓模樹脂厚度0.2 mm 模擬結果分析
由於所有的製程參數均無變化,僅壓模樹脂厚度由0.4 mm 改為0.2 mm ,所以在晶片黏著升溫、降溫固化及壓模成形升溫等製程應力及翹曲變化同厚度0.4 mm 模擬結果,有所變化的是壓模成形降溫固化製程。
6. RFIC封裝壓模厚度0.2 mm模擬結果與量測比對
壓模樹脂0.2 mm 厚度的模擬與量測結果往上翹曲趨勢一致,且翹曲量相當接近,模擬翹曲量為0.6 mm ,實際測試結果平均值為往上翹曲0.551 mm ,如圖十八所示。壓模樹脂厚度0.2 mm 的最大應力為11 MPa;晶片受到最大應力為145 MPa的壓應力,遠小於矽(Si)的破壞強度 (Si Yielding Strength~1 GPa) ……以上內容為重點摘錄,如欲詳全文請見原文
作者:毛俊凱、李新立、王欽宏、潘力齊 /工研院南分院;李糖、劉秋維 / 麥瑟半導體股份有限公司