在2007 Symposium on VLSI Technology有關高介電常數絕緣膜/金屬閘極(high-k/metal gate)議程的會場上,Intel和IBM公司以「電晶體(transistor)歷史中最大的技術革新」為口號,各自發表45nm時代的實用化技術,即所謂的high-k/metal gate材料技術。high-k/metal gate技術預計可在2009-2010年達到32nm世代的量產化,如圖一所示,藉此技術的增進得以降低元件的驅動電流並抑制漏電流,使32nm以下大型積體電路(LSI)的性能持續提升,讓多數的LSI製造商都能共同受惠。而其中已導入的high-k/metal gate材料製程,可以控制金屬氧化物半導體場效電晶體(MOS FET)之閘極(gate)電壓,克服了阻礙high-k /metal gate實用化的最大問題,也就是臨界電壓偏移的問題,使其效用能同時滿足高速性能(high performance;HP)及低操作電功率(low operational power;LOP)等用途廣泛之LSI元件需求,此技術更相繼被以CMOS元件加以驗證,因而受到高度的關注。
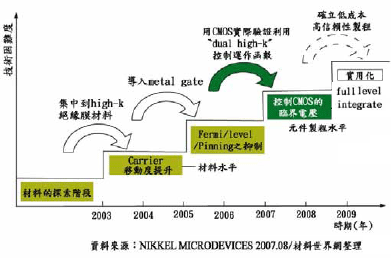
圖一、High-k/metal gate材料技術的演進發展
資料來源:Nikkel Microdevices 2007.08/材料世界網整理
Dual high-k的材料設計優於Dual metal
在多數技術人員中具有高度評價的是被稱為「雙重(dual) high-k」的MOS FET臨界電壓的控制手法,其具體作法是在nMOS和pMOS的metal gate和high-k膜界面附近,添加不同的金屬元素,利用高溫退火以活化源極與汲極(source drain)時,使其擴散至high-k膜中,使high-k膜的成份產生變化。此次所謂dual high-k的技術,並未停留在2006年提出的「材料/製程水準(level)」,被評價為「CMOS設計水準」的案例已經不斷推陳出新。因此,相繼出現所謂「以高優先度手法進行實用化檢討」的迴響,LSI製造商各公司也都有一致的高度評價。
各家公司對dual high-k具高度評價的主要理由有二,(1)能符合高速性能或低操作功率下MOS FET所需的低臨界電壓或高開通(ON)電流;(2)易於導入現行的CMOS製程。Dual high-k非常容易導入現行標準CMOS製程的「gate初始製程」中,如圖二所示。因此,隨著high-k/metal gate的導入,得以抑制製造成本的增加及產率的降低。此一製程中是在gate成形後導入不純物以形成source drain。Dual high-k在此一製程中之所以容易導入,是因為可利用source drain活性化的高溫退火,以控制臨界電壓。在metal gate和high-k膜的界面附近,事先添加金屬元素,退火時藉由加熱使其擴散至high-k膜中。利用此一製程改變High-k膜的組成,促使gate的work function產生變化。
相對於此,以往提出的「dual metal」就難以導入gate初級製程中。因為在dual metal中,分別使用nMOS和pMOS兩種work function相異的metal gate材料來控制臨界電壓。「dual metal」在高溫退火時,因為加熱而使metal gate的work function容易產生變化,所以難以導入gate的初始製程中,而且在source drain形成後,gate也已形成,一般認為必須增加降低金屬熱負荷之「Gate last Process」,對現行製程而言必須做大幅的改變,因而導致成本的增加和成品率的降低。
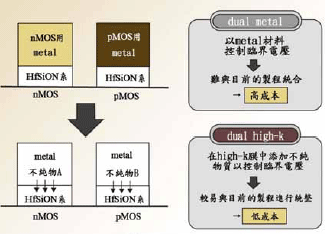
圖二、Dual metal與Dual high-k的比較
資料來源:Nikkel Microdevices 2007.08/材料世界網整理
各家製造商的high-k /metal gate 實用化成果
(一)Intel和IBM先後將在45nm製程中導入high-k /metal gate材料製程
Intel和IBM兩家公司在2007年1月相繼發表了high-k /metal gate的實用化時程,兩家公司自2007下半年到2008上半年,在量產化的45nm世代製程中將導入high-k /metal gate。其他製造商也大多認為「在32nm世代的製程中導入high-k /metal gate是必須的」,因為早日達到實用化的目標,才能建立在同業中有利的地位。韓國Samsung電子公司、德國Infineon Technologies AG、日本東芝、松下電器等大廠,皆表示有意將技術導入32nm世代製程。IBM這次與美國Advanced Micro Device公司、東芝和SONY,共同發表了導入dual high-k的高速性能45nm世代CMOS。(在初始製程中使用SOI(silicon on insulator)基板,藉由SiN薄膜呈現出gate長33nm的nMOS之特性,得以獲致200μA/μm(OFF時的漏電流為100nA/μm)的高開通電流。
(二)比利時IMEC公司的提案
比利時IMEC公司將DyO cap應用在Ni FUSI gate中。nMOS是NiSi/DyO(0.5nm)/HfSiON構造,而pMOS的構造則是NiSi/DyO(0.5nm)/SiON。估量長約80nm左右gate中的微細成份,可以得到0.2~0.3V的臨界電壓。在FUSI中,目前利用silicide的互相控制來調節臨界電壓的方法是一般最常見的,因此這次採取了和gate初始製程相同的手法。
(三)SEMATECH以理論作為效用的證據,Samsung將雙重high-k導入MIPS
除IBM外,像Samsung之外的其他LSI製造商,從美國SEMATECH公司,及具有半導體先端技術(Selete)的國際財團(consortium)開始,也相繼利用理論來證明,藉著dual high-k改變gate的work function,使其得以在Si能帶端進行設定。在nMOS的HfSiON gate絕緣薄膜中可以使LaOx、Sc、Er及SrO等稀土類金屬擴散,而該集團也研究出其中元素的種類與臨界電壓變化量的關係(圖三)。以此結果為基礎,改變gate實際有效之work function的主要因素,正是金屬元素藉由退火的熱,穿透HfSiON膜擴散至下層的SiO2膜,與氧(O)原子一起形成電雙極子(Electric dipole)。其中閘極電壓的偏移(shift)量,和金屬電氣的陰電性,及離子半徑等皆有所相關。SEMATECH公司提出的此一模式,正是以電雙極子的電偶極矩(dipole moment)來改變gate實際有效之work function。
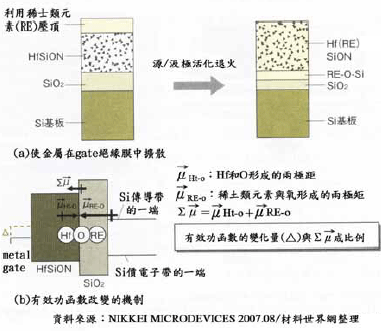
圖三、藉由電極矩改變Gate的功函數
資料來源:Nikkel Microdevices 2007.08/材料世界網整理
此外,從Samsung、Selete和SEMATECH開始,相繼發表將重點放在成本低、可靠性高的初始製程。Samsung將dula high-k導入MIPS(metal inserted poly-Si stacks),MIPS即是在多結晶Si gate 和 high-k膜之間夾入metal。MIPS與現行的多結晶Si gate/SiON薄膜構造十分相近,製程的變動較少,具有節省經費的優點。將AlOx薄膜層導入pMOS的TaN gate上,退火時Al擴散至HfON薄膜,而使gate之work function產生變化。Selete和SEMATECH則是在pMOS的metal gate中添加Al,使其在退火時擴散入high-k薄膜來控制work function,如圖四所示。
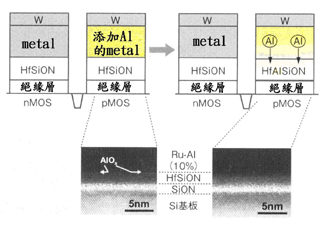
圖四、在金屬閘極中添加不純物
資料來源:Nikkel Microdevices 2007.08/材料世界網整理
日本MIRAI及產業、學界和獨立行政法人合作的high-k計畫成果
獨立行政法人產業技術綜合研究所次世代半導體研究中心和技術研究團體超先端電子技術開發機構,在獨立行政法人新能源及產業技術綜合開發機構的委託事業日本半導體MIRAI計畫中,主要關注於新構造極限CMOS電晶體相關技術,和效氧化膜厚(Equivalent Oxide Thickness, EOT) gate stack基盤技術的開發,也致力於開發CMOS電晶體中必須的高介電常數gate絕緣膜及金屬gate電極等gate stack新材料及其製程,和材料內部或界面的原子構造缺陷的新測量法。目前也正在進行新gate stack材料製作電晶體特性評估,與其造型及可靠性相關的研究。由於規劃2013年開始量產32nm技術世代,半導體積體電路將持續微細化,迴路中控制電流的電晶體gate絕緣薄膜,也有必要再往1nm以下進行薄化。目前用來作為電晶體中gate絕緣薄膜的氧化矽膜(SiO2),膜的厚度若再變薄的話,以量子力學的穿隧效應來看,電流將直接通過絕緣層,絕緣薄膜也將失去其功能。為了解決此問題,透過提高介電常數或將絕緣膜加厚等,以實現電性上的等價電容量,都必須採用高介電常數的新材料。
除MIRAI開發機構外,由產業界的Selete、大學和獨立行政法人等所組成的虛擬研究組織的High-k Net,聚集各種領域的專門知識,並以明確解釋關於high-k/metal gate之物理、化學結構為目標。以虛擬的體制進行研究的「High-k Net」,是由幾位彼此不同專門領域的研究者所組成,這些研究者大多是在世界上各領域中的著名人士,針對Selete提出的技術課題,以自己的研究方法充分發揮,從不同的角度進行科學化的解析。身為民間半導體研究開發國際財團的Selete,認為將high-k/metal gate實用化的技術成果移轉給關係企業時,科學化的理論資訊也不可省略,必須一併提供。當時,僅由Selete報導科學資訊顯得較為困難,因此就透過High-k Net活用大學或獨立行政法人的力量,以此作為解決的對策。
這個組合對合作的大學和獨立行政法人方面來說,也有所獲益。第一,必須的實驗樣本(試料)可由Selete提供。一般而言,大學要取得先端製程的實驗樣本是相當困難的,而利用Selete的300mm設備則得以提供實驗樣本。第二,可以吸收產業界的新知,對大學的學生教育也有很大的助益。High-K Net設立於2003年,至今雖已創造出許多成果,但卻幾乎從未在公開場合中被介紹過,在2007年6 月1 日舉辦的「Selete Symposium 2007」中,半導體先端科技公司Selete,以產業、學界和獨立行政法人合作成功的案例之姿,介紹了「High-k Net」。2007年度之後的活動中,更增加了與high-k/metal gate可靠性相關的物理性解析,也舉行了關於界面特性和新材料的討論。32nm世代以後,關於立體電晶體或metal source drain的討論日後也將陸續展開。
★詳全文請見下方附檔