黃曉鳳、簡佩琪/工研院材化所
隨著可穿戴電子、物聯網(IoT)、AI和5G等需求的加速,使得全球半導體需求急速增溫,同時也帶動半導體用膠帶之需求,半導體用膠帶最主要用於晶背研磨和晶圓切割。隨著對電子儀器薄小化之要求日益提高,所搭載之半導體晶片亦同樣被要求薄片化。薄化後之晶圓如紙片,於後續製程更容易產生破損,因此,研磨膠帶和切割膠帶之特性和品質備受關注。本文將藉由數篇近十年日本主要半導體膠帶生產公司申請之專利進行解析,探究近期半導體用黏著膠帶之技術進展。
【內文精選】
前言
黏著膠帶(Adhesive Tapes)應用於半導體(Semiconductor)方面主要有晶背研磨(Wafer Back Grinding)及晶圓切割(Dicing)等兩大製程。晶背研磨係將晶片背面研磨到需要的晶片厚度之過程,目的是使晶圓厚度減小,以允許堆疊和高密度IC封裝。晶背研磨膠帶主要功能是在晶背研磨期間能完全保護晶片表面,並防止研磨液的滲入而造成污染。晶圓切割顧名思義係將晶粒(Die)從晶圓上分割出來的切割製程。切割膠帶在此製程的功能即固定晶圓,使晶片能精準地被切割分離,同時避免於切割過程中產生晶片位移或飛晶的情況。
全球半導體用膠帶主要生產廠商包括:三井化學株式會社(Mitsui Chemicals)、琳得科(LINTEC)、日東電工(Nitto Denko)、古河電氣(Furukawa Electric)、電氣化學(DENKA)、住友電木(Sumitomo Bakelite)、Maxwell、AI Technology等公司。台灣生產之半導體於全球市占超過50%,而半導體用膠帶約有九成以上都由日商供應,截至目前為止,國內尚無相關膠帶生產商正式供應國內半導體業者做晶背研磨或晶圓切割使用。
專利技術解析
不論是研磨膠帶或是切割膠帶,皆包含非UV型膠帶(Non-UV Tape)和UV型膠帶(UV Tape)。非UV型即一般傳統感壓膠帶,考量容易剝離性,其黏著力一般較UV型(未UV曝光前)低,約落在100~400 gf/25mm;UV型膠帶是一種曝光前具有高黏合強度的感壓膠帶,曝露於UV光後其剝離力會大幅降低,對被接著物不但具有強固定性,於製程目的達成後又能兼具容易剝除的優點。Non-UV Type和UV Type的膠帶結構如圖一所示。
隨著晶片尺寸愈來愈小,對於膠帶的性能要求愈來愈多,大多已非單純之兩層材料架構可以滿足。由於市面上相關膠帶技術細節資訊不易取得,後續內容將從近10年來日本主要半導體膠帶生產公司申請之專利中挑選幾篇進行解析,探究近期半導體用之研磨膠帶和切割膠帶,於性能上做了哪些精進以及所對應解決的問題。
2. 切割膠帶
日東電工JP06021263B2專利中提到,切割完之晶片間間隔至多僅數百μm,如圖七,若欲直接拾取,將容易碰到其他晶片而造成晶片毀損,因此,通常切割完後會在切割膠帶載有晶片的情況下,將切割膠帶擴展(延伸),藉以拓寬晶片間之距離,然後再拾取晶片。但儘管拓寬了晶片間距,拾取時仍然會產生不便。該司發現,即便減弱切割膠帶與晶片之間的黏著力,仍未消除上述問題。該司研究人員針對吸嘴之吸附面與晶片之位置偏移反覆研究,發現擴展或銷頂起之切割膠帶之應力於該帶面內均勻性較為重要,而切割膠帶之厚度於帶面內也必須有良好的均勻性,故將切割膠帶之厚度不均的標準偏差之級別嚴格調整成2 μm以下而完成本發明。
近年來,為了降低切割刀於切割晶圓時之高速旋轉振動造成晶片的缺損,也有利用電漿作為切割工具(如圖八右),其不僅可以避免對晶片的振動,且蝕刻速率非常快,被認為是最適合晶圓切割的工藝之一。惟此電漿切割製程會處於高溫環境下,因此,所使用之切割膠帶除了要有良好的延展性以滿足晶片拾取前之膠帶擴展處理,還要能耐受電漿切割之高溫製程。一般切割膠帶難兼顧上述兩種性能,即擴展性良好的膠帶於高熱時就容易熔融;耐熱性良好的膠帶通常難進行擴展。
圖八、傳統刀片切割與電漿切割之比較
工研院自有黏著膠材技術
工研院材料與化工研究所具備半導體用膠帶之黏著膠材合成與膠帶製備相關技術與開發經驗。表一為目前工研院材化所黏著膠材規格。主膠部分,藉由壓克力系單體之選配加上製程控制手法,合成出具極高分子量之壓克力樹脂,該樹脂具備足夠高之內聚力(Cohesion)…以上為部分節錄資料,完整內容請見下方附檔。
表一、工研院材化所開發之黏著膠材規格
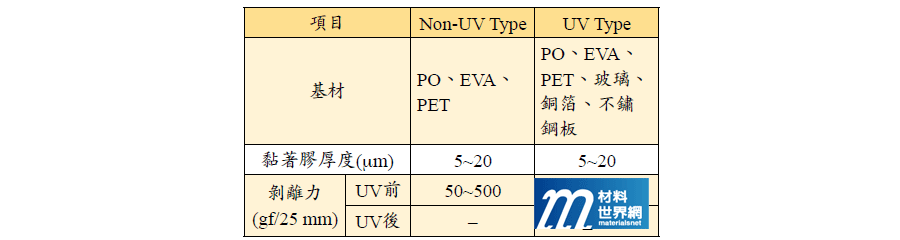
★本文節錄自《工業材料雜誌》404期,更多資料請見下方附檔。