隨著摩爾定律的發展,電晶體尺寸得以不斷微縮,但如今晶片的繼續微縮已經因為物理極限而出現瓶頸。同時,透過新型垂直整合方式的三維積體電路(3D IC)等先進封裝技術應運而生。金屬接合技術是實現垂直整合的關鍵之一,而銅憑藉其優異的物理特性成為接合技術的首選。然而傳統銅接合技術所需之高溫、高壓等條件限制其進一步的發展。
本文將從以下大綱,介紹低溫銅接合技術在3D IC與先進封裝中扮演的關鍵角色以及目前的研究趨勢。
‧低溫銅對銅接合技術
1. 接合表面濕式處理
2. 表面活化接合(Sur face Activate Bonding; SAB)
3. 鈍化層保護接合表面
(1) 自組裝分子鈍化層(Self - assembly Monolayer Passivation)
(2) 金屬鈍化層
4. 特定晶向接合
5. 異質結構接合
‧低溫銅接合技術的發展與應用
【內文精選】
在傳統的積體電路中,元件處於同一平面,通過內層互連引線(Interconnect)相連接,然而如今晶片內部包含數十億顆電晶體,佈置互連引線的難度越趨困難。運用三維積體電路(3D IC)中垂直整合的概念,可以大幅度降低互連引線長度,進而縮小互連延遲與電容效應,晶片性能可大幅提高。
三維積體電路的諸多優勢是透過晶片堆疊來實現,因此晶片的接合技術是3D IC關鍵技術之一。在眾多的接合技術中,金屬接合憑藉其在不損失機械強度的同時可以提供出色的電性表現而備受重視。金屬銅作為標準CMOS製程中內層互連引線的材料之一,具有出色的抗電遷移特性,成為金屬接合的首選。如何在低溫(Low Temperature)低壓下實現高品質的銅接合(Copper Bonding)製程,是目前業界迫切需求的技術。金屬銅在空氣中易於氧化,其氧化物不僅會阻礙接合的順利進行,在接合完成後亦會使接觸阻抗大量上升。除此之外,銅的接合表面之平整度,亦決定接合過程是否會在接合界面產生空隙而導致接合品質不佳。上述兩點原因限制了銅接合技術的發展。
低溫銅對銅接合技術
1. 接合表面濕式處理
在接合之前將接合表面的氧化物去除,可以增加接合效率與提高接合品質,因此有研究人員提出在接合之前對表面進行清潔。日本東大的Suga教授和他的研究團隊提出使用電漿對表面進行處理,但這種技術必須在特殊的客製化腔體內完成。如圖一所示,通過使用四氟化碳與氧氣的混合電漿對表面進行活化操作。然而,由於使用氧氣電漿,在活化後仍面臨產生新的氧化物之風險。
3. 鈍化層保護接合表面
既然氧化物會影響銅接合製程,那麼使用鈍化層(Passivation)將接合表面金屬銅保護起來,使之在接合前不與空氣接觸,是另外一種低溫銅接合解決方案。
(2) 金屬鈍化層
國立交通大學陳冠能教授和他的研究團隊開發出使用金屬鈦作為鈍化層,並實現180˚C低溫接合製程。圖三為使用金屬鈍化層的銅接合結構示意圖,在銅表面覆蓋一層金屬鈍化層,熱壓接合的過程中,銅原子可以穿過金屬鈍化層到達接合界面進行銅對銅擴散接合,而並非鈍化層之間的接合。
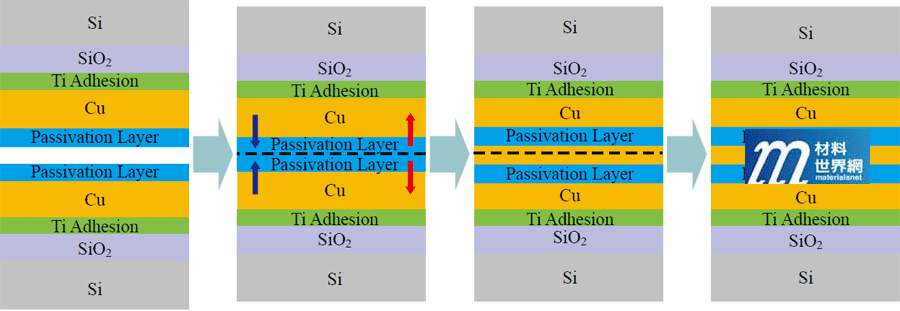
圖三、具有金屬鈍化層的銅對銅接合示意圖
陳冠能教授團隊在使用金屬鈦作為鈍化層的基礎之上,又開發出使用鈀(Pd)作為新的金屬鈍化層材料,成功在150˚C的低溫條件下實現銅接合製程,並且具有良好的電性表現。該結構經過多種可靠度測試之後,電性表面仍然穩定,是一種可靠、可兼容業界標準CMOS製程的技術。
5. 異質結構接合
除了上述針對接合表面進行處理,進而實現低溫接合的製程之外,陳冠能教授的團隊與他的合作伙伴們共同開發出一款新型低溫銅對銅接合結構—異質結構接合。如圖六所示,透過結構設計的方式,使用高分子材料,建構出銅凹洞結構,並與銅柱進行接合。在熱壓接合的過程之中,銅柱僅有邊緣小範圍與凹洞相接觸,在巨大的壓力下,銅柱邊緣產生不可逆的形變。之後經過再結晶與晶粒生長的過程,實現良好且穩定的接合結果。該結構可以在大氣環境下實現200˚C以下的低溫接合。

圖六、不同部位SEM影像(a)銅柱;(b)銅凹洞;(c)接合結構示意圖;(d)接合後結構影像
低溫銅接合技術的發展與應用
銅接合技術應用於先進封裝垂直整合技術之中,目的是大幅縮短互連引線長度,增加元件密度,因此對細間距(Fine Pitch)也有一定的要求,目前針對細間距的目標是實現間距在10 μm以下的接合。
目前索尼公司(Sony)已經成功將銅對銅技術應用在最新一代CMOS圖像傳感器的製作之中,其銅接合通孔直徑為3 μm,間距為14 μm。同時Tezzaron®公司也是用銅接合技術開發製造了下一代記憶體—DiRAM4™三維記憶體...…以上為部分節錄資料,完整內容請見下方附檔。
作者:劉德民、陳冠能/國立交通大學
★本文節錄自「工業材料雜誌」382期,更多資料請見下方附檔。