人工智慧(AI)與物聯網(IoT)之技術結合發展出智聯網(AIoT),智聯網可以感測世界並數據化,使之成為一個大型的信息系統,甚至自我學習及動態演進。智聯網的崛起,使高效能的元件需求增加,在半導體發展面臨摩爾定律(Moore's Law)瓶頸的困境時,先進封裝無異提供了一個延續摩爾定律的可能性。藉由不同的先進封裝形式,像是立體堆疊、中介層或是扇出型封裝等,改變晶片在系統中組裝和互連的方式,同時兼顧成本以及性能,將異質晶片整合進化成在單一封裝內,包含了完整晶片系統,即稱之為系統級封裝。
本文將從以下大綱,分析現今全球最新的系統級封裝技術。
‧智聯網對半導體產業之影響
‧晶片整合之封裝技術
1. System-on-Chip (SoC)
2. System in Package (SiP)
‧廠商技術發展動態
1. CoWoS (Chip on Wafer on Substrate)
2. NTI/SLIM
3. Fan-Out
4. EMIB
‧總結
【內文精選】
智聯網對半導體產業之影響
智聯網(AIoT)憑藉著高速運算、自我學習、雲端存取、無線技術、微機電系統(MEMS)和網路等技術,使世界成為一個大型的信息系統。隨著消費者希望電子產品比以往更小、更易於攜帶且更多功能,在智聯網市場的快速崛起下,影響到半導體產業發展趨勢。半導體的設備裡除了調節電流及電壓大小的電阻、存儲電能的電容、過濾電流雜訊並防止電磁波干擾的電感等被動元件,也含有數個不同功用的主動元件,如電晶體、存儲器、RF、感測器等。為了要降低元件尺寸大小,又不影響效能,此一趨勢使各家廠商開始研究如何把不同功能的元件整合於一個系統中,藉以滿足低功耗及微型化之需求。
微機電之元件在物聯網(Internet of Thing; IoT)與人工智慧(Artificial Intelligence; AI)的技術結合下逐年快速成長。為了能加快蒐集、傳輸及處理龐大的訊息,促進了5G技術的發展,且隨著頻段擴大與複雜化,RF濾波器的需求也增加,使得RF成為MEMS領域中成長最快之技術。
感測器因具有抵抗有毒廢氣和惡劣環境的特性,且精度高,特別使用於智能輪胎的開發,對於未來的自動駕駛汽車,能提供更多有關輪胎狀態的信息,在車用電子應用最廣。感測器與MEMS中驅動力來源的致動器(Actuator),在未來消費電子設備中,如AR/VR之預估市值約為5,000萬美元,平板電腦和智慧型手機的預估市值則高達530億美元;其他如智慧汽車、工業4.0等領域也占有極高之市值,如圖五所示。

圖五、電子元件之趨勢:2023年感測器與致動器之市場產值影響
廠商技術發展動態
不管是SoC或是SiP,皆是使用了許多不同技術的集成製程,以下為目前不同廠商的技術介紹。
1. CoWoS (Chip on Wafer on Substrate)
由台積電在2012年提出。利用CoW(Chip-on-Wafer)製程,將不同的晶片藉由晶圓級矽中介層(Si Interposer)連接在一起,使元件之間能橫向傳輸。再把CoW晶片藉由封裝技術連接至基板上,完成2.5D IC封裝技術,提高頻寬增加效能的同時降低功耗。由於成本較高,多用在高階高效能品。圖九為CoWoS技術之例子,由Xilinx與台積電共同開發,裡面使用了4層RDL來連接TSV Interposer,RDL層的線寬和間距為0.4 μm,中介層上的μ-Bump數量高達200,000以上。
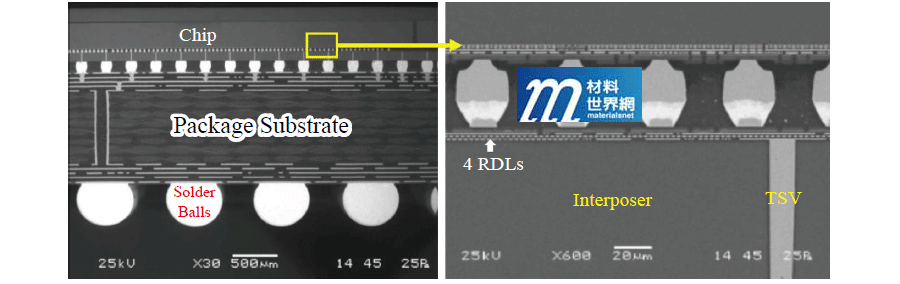
圖九、利用CoWoS技術之元件截面圖
總結
工研院材化所精微成型與表面技術研究室,長期致力於半導體封裝製程中的金屬化技術開發。近年來建構了全濕式製程,已成功於含有高深寬比TSV (AR≒10 and 12)的晶圓基材內沉積金屬,可用於2.5D/3D IC之製程(圖十五)。而在TGV (Through Glass Via)金屬化製程中,依客戶需求玻璃基板厚度可微縮至250 μm以下(圖十六,開孔約350 μm),最薄可製備35 μm(開孔約15 μm)之TGV樣品。近年更成功開發玻璃上高附著力金屬技術,經過標準百格測試(ASTM)…...以上為部分節錄資料,完整內容請見下方附檔。
作者:顏銘翬、林子婷/工研院材化所
★本文節錄自「工業材料雜誌」382期,更多資料請見下方附檔。