楊啟鑫/工研院產科國際所研究員
前言
國際首屈一指的半導體先進構裝會議—第68屆電子元件及技術會議(The 68th Electronic Components and Technology Conderence;68th ECTC)由IEEE-CPMT所主導,與ESTC、EPTC及ICEPT等並稱為國際四大電子封測會議的ECTC討論範圍包括電子構裝、創新材料/設備、製程技術、模擬分析和技術應用等,每一年都吸引來自全球各地與先進構裝及半導體創新發展有關的學術和產業專家齊聚一堂。今年堂堂邁入第68屆的ECTC會議,選在美國聖地牙哥盛大舉行。
今年的研討會主要議題涵蓋全球半導體封測產業在先進構裝技術的發展,尤以後段新穎封裝型態為重的製程技術、設備及材料廠商動態與技術發表最受矚目。封裝類型包含3D IC、2.5D IC、扇出型封裝、高階異質整合封裝、Flip Chip及SiP等。研討會舉辦方式除了論文發表與廠商展會以外,另外特別開設先進構裝技術的相關專業課程,藉由邀請專業講師來介紹完整的技術,主題性的呈現全球關注的未來先進封裝技術發展情況,專業講師係由國際知名廠商、研究機構所組成,包含Qualcomm、Georgia Institute of Technology、Texas Instruments及ASM Pacific Technology Ltd.等等,透過此會議可以掌握全球最新構裝技術趨勢與市場。筆者有幸參與盛會,將依1.先進封裝產業發展趨勢分析;2.扇出型封裝產品狀況與技術發展趨勢;3. 2018年台灣暨全球IC封測業現況與展望等不同篇章,系列介紹前瞻整合晶片系統暨構裝趨勢發展,期提供最新構裝資訊,以饗讀者。
先進封裝市場及趨勢
2016年全球半導體覆晶封裝(含Cu Pillar及Solder Bump)產業分佈如圖一所示。8吋以下覆晶封裝供給端以中國為主。值得注意的是,中國大陸為覆晶封裝潛在成長區域,且因應晶圓廠之製程微縮趨勢下,晶片對銅柱凸塊需求日增,未來覆晶封裝擴廠將以銅柱凸塊相關為主。
覆晶封裝應用包含CPU、FPGA、ASIC、DSP和DRAM,而小顆的Amplifiers and Switches 佔2016年Flip Chip總量26%。另外,值得注意的是,覆晶封裝為先進封裝中數量最多的封裝型態,但卻不是成長率最高的封裝方式。全球覆晶封裝量變化如圖二所示。

圖二、全球覆晶封裝量逐年變化圖
因應晶圓廠製程微縮趨勢下,銅柱凸塊需求日增,而其Bump Pitch主要在130μm以下,40μm以上。另外,台灣及韓國佔全球 Cu Pillar產能的64%,12吋覆晶封裝則佔67%。預測未來在中國大陸政策持續提倡中國製造聲浪中,中國大陸當地將持續擴大Cu Pillar產能,以提供晶圓作後續封裝使用。

圖四、全球銅柱凸塊12吋晶圓量逐年狀況
覆晶及扇入型並非先進封裝中成長最快速的項目,Fan-out及2.5D Interposer未來成長性驚人。Fan-out主要成長動能來自手機、穿戴裝置及車用雷達等相關晶片,2.5D Interposer成長動能則來自AI高速運算晶片(FPGA、GPU、TPU...等)。
異質整合封裝技術除了過去十五年在載板上開發密度較低的SiP技術外,近年來在高整合度晶圓級封裝技逐漸發展下,晶圓級異質整合技術可分類為三類,即Low Density Fan-out、High Density Fan-out及2.5D中介層技術......以上為部分節錄資料,完整內容請見下方附檔。

圖五、全球先進封裝成長率狀況
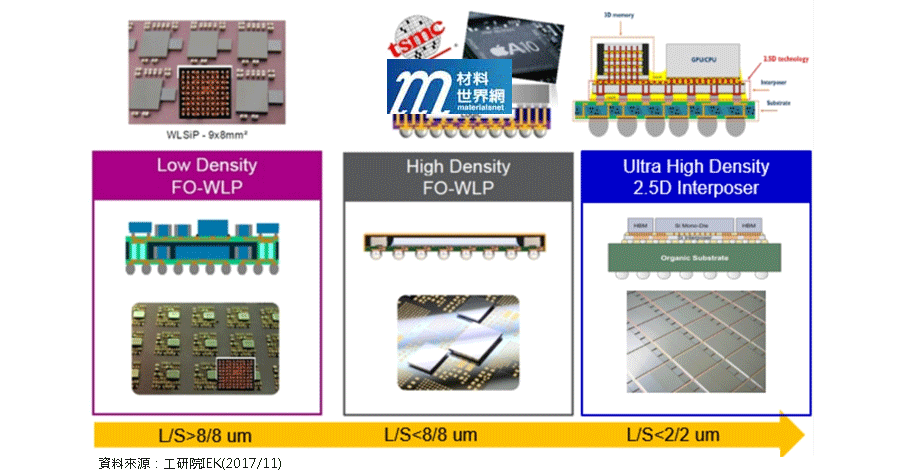
圖六、三種主要晶圓級異質整合技術