2.5D/3D IC架構都會使用矽導孔互連技術,藉由TSV形成3D互連橋接結構,縮短晶片間的導通路徑、改善訊號速度、降低功耗及減少延遲效應等特點達到整合架構,滿足電子產品朝向輕薄短小的發展趨勢,也是目前半導體產業發展的一個重點方向。關於銅金屬於電化學沉積過程中容易形成空隙的機制說明如下(排除晶種層缺陷的影響)。①原始存在於盲孔內的空氣未完全排除;②矽晶圓表面張力大,鍍液無法完全濕潤盲孔;③盲孔周圍(Via Mouth)存在局部高電流密度區,金屬沉積速度快於孔底,致使導孔過早被銅金屬封閉;④盲孔內因電化學反應產生的氫氣,未能及時排出,而被包覆其中。
對於影響金屬析出反應的關鍵因素尚有伴隨電化學反應的極化作用(即反應進行的阻力),其極化作用分為活性極化、濃度極化及電阻極化,藉由電化學反應槽各組件的功能設計及電鍍液各組成特性,可適當調控矽晶圓表面及盲孔內的極化效應,使其達到無空隙金屬填孔並改善晶圓表面銅金屬的厚薄差異。
銅金屬填孔電鍍液組成
電鍍液各組成對金屬沉積的影響原因說明如下。
③ 添加劑:
在鍍液中的作用有兩種主要形式,一種為透過形成膠體吸附金屬離子以阻礙金屬離子放電,增大陰極極化作用;另一種吸附在陰極表面上,阻礙金屬離子在陰極表面的放電,或阻礙放電後吸附原子的擴散,影響電結晶過程,增大陰極極化作用。不同功能添加劑在填孔過程的示意如圖三。
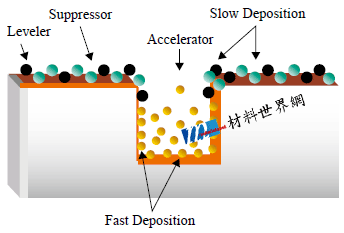
圖三、不同功能添加劑的填孔過程
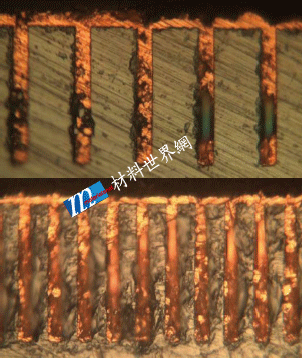
圖五、銅金屬填孔失效之光學影像
電化學動態流場分布控制模組
除了考量鍍液組成對銅金屬電沉積的效應,對於如何在佈滿十幾萬微小盲孔的矽晶圓依然可達到完美無瑕金屬導線,則需靠電化學動態流場分布控制模組的設計,以達到穩態的對流、擴散質傳及可分區控制的電場。
電化學動態流場分布控制模組包含陰極(Cathode矽晶圓)、陽極(Anode可溶性陽極銅粒或不溶性陽極氧化銥)、擴散模板、陽離子隔膜、可脈衝供電及電場遮蔽裝置等,其相關設計功能隨性能需求而有差異。就槽體外觀可分為槳擺動與湧泉方式,前者矽晶圓直立懸掛於槽體;後者則矽晶圓的被鍍面朝下與鍍液呈水平接觸,並可調整順反向旋轉速度,如圖六電化學沉積模組示意圖,此兩者機構於鍍液對流方式及電場分布控制有著極大差異的設計,本文主要介紹湧泉式鍍槽模組之設計,功能如下述。
③ 擴散板:
消除槽體鍍浴與電極之間濃度梯度,提升極限電流密度,使可利用之電流密度範圍更廣。流體通過的開孔設計,隨主槽體噴流流道或配合TSV圖案,而有不同設計式樣,如圖九,是改善晶圓表面鍍層厚度均勻性的關鍵。
⑤ 電流遮蔽裝置:
目的為遮蔽高電流區,尤其應用於當電化學反應透過上述動態流場調控,而仍無法達到鍍層厚度均勻性時;遮蔽材質應為不導電且與鍍浴不起任何反應,避免衍生干擾……以上為部分節錄資料,完整內容請見下方附檔。
作者:周雅靜、陳安邦、陳興華/工研院材化所
★本文節錄自「工業材料雜誌」345期,更多資料請見下方附檔。