電子構裝技術專題
我國半導體產業於80年代快速崛起,創造出我國第一個兆元產業,目前包括半導體製造、封測及IC設計的三大領域,在2012年創造1.6兆元的產業規模,平均每季4,000億元的產值,穩定地扮演我國經濟發展的火車頭角色。與晶圓代工產業相同,我國也擁有全球最大的封裝測試廠,長期在全球封測產業中居於領導地位。近年來行動智慧電子裝置風行,電子構裝產業已找到著力點,如何在現有產業體系下進行產業升級及技術提升,繼續維持產業領先地位,將是電子構裝產業發展的關鍵。九月工業材料雜誌特別企劃「電子構裝」技術專題,邀請工研院的構裝技術專家,以行動智慧電子產品的功能需求做為前提,探討新型構裝設計及概念來面對以上的構裝議題。其中,“內埋式SiP功率模組設計”是針對高頻構裝縮裝做構裝結構與電性模擬,將功率模組內埋,降低原始電路的寄生電阻與電感,增進整體構裝系統的功率轉換效率。3D晶片封裝是將多顆晶片以矽穿孔(TSV)技術,進行三度空間的整合構裝,可以提高頻寬,同時具有高密度連接、低耗電及構裝縮裝的特色,適用於高階行動式手持電子產品,本專題特別以3D IC“細間距微凸塊晶片堆疊封裝製程”一文來闡述這項先進的構裝技術。另安排一篇關於散熱構裝的文章—“功率元件構裝技術發展及應用”,將從低電流的TO構裝形式、整合功能的IPM構裝,到高電壓電流的膠囊式構裝做詳細介紹,也介紹外殼型式構裝的功率模組提升可靠度的最新技術發展。最後一篇是以今年JPCA Show展出的內容,來對應與檢視現今電子構裝技術與材料的發展趨勢,提供給同業及相關業者做一參考。
現今封裝結構的趨勢為輕薄短小,不僅是在體積上大幅的縮小,相對地在電性上也有改善的空間,而在功率模組上也走向Power SiP(System in Package)的封裝結構。「內埋式SiP功率模組設計簡介」一文針對內埋式的功率模組進行結構設計(圖一)與電性模擬,以600V/20A的IGBT與Diode為規格,內埋入兩顆IGBT與兩顆Diode功率元件,形成一個半橋式的功率模組,將可運用於PV Inverter最後輸出的功率轉換部分,以降低原始電路設計的寄生電阻與電感,更增進系統的效率。
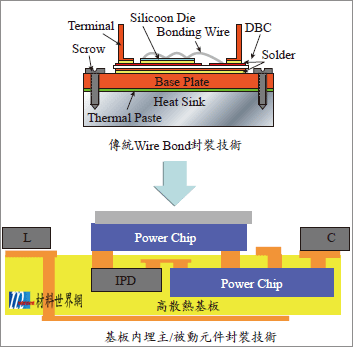
圖一、基板封裝技術
考量3D IC高密度電性導通與模組性能需求,細間距的微連結接點是必要的。異方性導電膠為高分子基質中添加隨機散布的導電粒子,藉由導電粒子的變形,以及與晶粒/基板凸塊的碰觸,而建立晶粒與基板間的電性連結,此接合特性相較於其他覆晶封裝製程,具有較低的製程溫度、簡化的製程步驟、較低的製程成本、環保及可實現細間距封裝等特性。「採異方性導電膠之細間距微凸塊晶片堆疊封裝製程」一文探討具30微米間距微凸塊晶片載具,採高密度且陣列式排列導電粒子之異方性導電膠材進行封裝製程,藉由製程最佳化調整並分析檢測膠材狀態、導電粒子分布等,評估採此接合架構之微凸塊接點可靠度及其失效原因探究。
功率模組構裝需提供①良好的散熱特性以帶走高發熱密度晶片所產生的熱;②在長期的負載環境下有高的可靠度;③需具有高的導電性以達到小的寄生電性參數;④對模組而言,必須提供切換間及電路和散熱器間的電絕緣性。功率模組構裝趨勢朝向可靠度提升及功能整合,「功率元件構裝技術發展及應用」一文將從低電流的TO構裝形式、整合功能的IPM構裝到高電壓電流的膠囊式構裝做詳細介紹,同時也介紹外殼型式構裝的功率模組提升可靠度的最新技術發展。
一年一度的JPCA Show是全球最大也是最受矚目的電子電路與構裝技術展覽,最先進的技術及概念都會在這個展會中試水溫,是電路板及電子構裝業者尋找技術與產品開發方向的最佳場合。「由2013 JPCA Show看構裝基板技術與材料」一文從可攜式電子產品所需的構裝技術面向切入,包括高頻高速化、薄型化及功能化等三個主要議題,搭配與尋找展會中的相關展出作論證及說明,由電子構裝設計、製程、材料來闡述整體技術的方向與趨勢。
電子連接器技術專題
2012年全球連接器產值已達478億美元(約1.43兆新台幣),根據工研院IEK預估,2013年連接器產業的產值會比2012年成長4.4%。而國內連接器產業的產值為1,478億新台幣,IEK預估今年的產值僅比去年增加1.3%。由於消費者對智慧行動裝置與平板電腦等新產品的青睞,已讓全球個人電腦產值成長趨緩。這些行動裝置產品由於考量輕薄化的需求,故造成產品所配備之連接器數量的精簡。加上Ultrabook等NB新產品的成長不如以往,因此也讓占國內連接器產值大宗的NB用連接器市場成長受到阻礙。廠商在無法擴增市場規模的狀況下,國內連接器的產值增加自然會低於全球產值擴增的平均值,這也反應出國內產品過度集中於3C產業,明顯地受到單一終端產品消長的影響。工業材料雜誌九月特別企劃「電子連接器」技術專題,從市場演變談台灣連接產業的發展,以及探討連接器的各項技術,希望能提供讀者目前連接器產業最新的研發現況與思考方向。
台灣連接產業一直與資訊產業景氣連動,資訊產業的改變牽動著連接產業的發展。在全球網路化的發展下,連接產業面對異於以往的嚴苛挑戰。這些挑戰來自於內部及外部,必須以更寬廣的思維來面對。「從市場演變談台灣連接產業的發展」一文提出一些重要議題,提供對於這些挑戰的可能思考途徑。
有別於一般零組件僅需要單一領域的專精,一個小小的連接器就結合了許多層面的技術,除了金屬、電鍍及塑膠等傳統產業的製造技術之外,也須對材料力學和機構設計有相當的敏銳度。近年來更須結合一些高頻電學和光學等跨領域的知識,才能設計出一個具備可靠度及高效能的連接器。此外,由於連接器需連結兩個不同的機構或系統,因此設計一個連接器的必要條件就是對這兩個系統有通盤的了解,否則無法在這兩者之間建立一個良好的橋樑(即連接器)。「連接器各項技術探討及其未來發展方向」一文將針對連接器的相關技術做初步的介紹。
「漫談微波測試的高頻連接器技術」一文主要介紹應用於高頻領域連接器的物理結構、電性特徵與介電材料對連接器的影響。在不同的頻率範圍內選用正確的高頻連接器,如K型、SMA型與WSMA型連接器相容性的問題與頻率響應特性,以及工程師使用連接器必備的基礎專業知識。
IC插座為一結合電子與機械裝置的系統,讓IC元件與PCB間做可分離之電氣互連。IC插座的設計與一般電子連接器不同,除了原有的沖壓端子設計外,因為其特殊的需求,所以在端子設計上有很多不同於一般電子連接器的外型或使用的材料。許多新的端子設計或材料都已應用在IC插座上。IC產業新的需求將會繼續驅動IC插座技術的發展。「IC插座連接器」一文針對IC插座的產品、零組件、使用的材料、端子型態等做一介紹說明,未來對於更細間距(fine pitch)之發展趨勢將是一大挑戰,不僅只在IC插座設計上,還有接合之可靠性、共面與成本等議題皆需要進一步克服。
主題專欄
除了上述兩大技術專題之外,其他精采內容尚包括:『台灣IC封測產業趨勢與展望』; IC封測產業一直是台灣半導體產業供應鏈上重要的一環,本文藉由分析台灣IC封測產值、IC封裝營運指標、IC封測業者動態與策略、新興封裝技術等,對台灣IC封測產業做一全面的剖析。積層製造技術有別於傳統的減法加工方式,其可能引發的衝擊與潛在的市場商機,包括軍事、航太、汽車、電子、生醫、珠寶、食品、消費性產品等應用,『積層製造(3D列印)技術之機會與挑戰』一文介紹全球積層製造產業的發展現況以及此技術可能帶來的機會與挑戰。全固態敏化太陽電池(Solid-state Dye-sensitized Solar Cells; SDSC)近來的研發相當快速,目前最高光電轉換效率已達14%以上,且所需的工作電極厚度更薄(<1μm),具有降低生產成本的優勢。『全固態敏化太陽電池的最新發展與突破』一文將針對固態染料敏化太陽電池的電洞傳輸材料及量子點做為無機光敏材料的最新發展及突破做一整理,並比較說明其重要性。自從太陽電池價格崩跌後,太陽光電業者普遍認為模組端的抗反射層是能夠快速達到量產高效率矽晶電池模組的技術之一,『抗反射膜玻璃應用於太陽電池模組之發展現況』一文針對近幾年發表的抗反射膜材及其製程技術做一整理與介紹。目前III-V族藍光LED市場正處於血流成河的成本競賽,各大LED磊晶廠也開始將其產品慢慢轉移至功率元件的開發,『GaN on Si磊晶技術應用於發光二極體與功率元件現況』一文將針對III-V族半導體GaN於Si基板上的磊晶技術所面臨的問題與克服方法做概括的說明。隨著LED光源技術逐漸成熟及成本降低,使得LED照明滲透率持續提升,高效率的LED照明並結合智慧型照明控制將能提高節能效果,『LED平面光源技術發展與應用』一文將介紹商用照明中常用之平面光源技術趨勢及相關的研究發展,並且介紹中置式LED光源配置架構,以及蝠翼光形與朗柏光形對室內照明之均勻度比較。
凡對以上內容有興趣的讀者,歡迎參閱102年9月號『工業材料雜誌』,並歡迎長期訂閱或加入材料世界網會員,以獲得最快、最及時的資訊!
服務專線:03-5915351張小姐、03-5918205葉小姐、03-5915439 林小姐
■ 工業材料雜誌 訂閱一年 2000元,二年 3600元 ►線上訂閱
■ 材料世界網會員年費一年 5000元,二年 9000元 ►立即會員下載
★其他繳款方式請見下列網址:
http://www.materialsnet.com.tw/magazineorder.html