時間:2016年9月7-9日
地點:台北南港展覽館一館1、4樓
主辦單位:SEMI
被視為台灣半導體產業中最重要盛事的SEMICON Taiwan 2016 已圓滿落幕。今年的展覽聚集了600家國內外領導廠商的1,600多個攤位,於南港展覽館1&4樓展出,三天展覽期間共吸引超過45,000人次參觀,創歷年最高。
今年展會共規劃17個展區;包括新增的IoT、日本沖繩、菲律賓及新加坡專區,加上原有之自動光學檢測、化學機械研磨、高科技廠房設施、材料、精密機械、二手設備、智慧製造、半導體設備零組件國產化等主題專區,以及海峽兩岸、德國、荷蘭高科技、韓國、日本九州等國家/地區專區,共9大主題專區及8大國家/地區專區,帶給參觀者更完整的產業全貌與國際視野。
隨著物聯網發展勢不可擋,行動及穿戴裝置對晶片的低功耗與小體積需求,為半導體產業帶來新的市場契機。SEMICON Taiwan 2016因應此趨勢,不僅在展場中新增更多終端應用廠商展示最新產品,更安排21場國際論壇,邀集台積電、聯電、日月光、矽品、艾克爾(Amkor)、柯林研發(Lam Research)、東京威力科創(TEL)等超過140位產業與學界等重量級講師,共同探討與剖析最新記憶體科技、半導體材料、MEMS、半導體先進製程、高科技產業永續發展、高科技廠房設施、IC設計趨勢、2.5D/3DIC技術、內埋與晶圓級封裝技術、永續供應管理及半導體市場趨勢等多元議題。三天的論壇共吸引3,600名業界人士參加,為半導體產業注入全球最新之前瞻性觀點。
■ 展場焦點
 SEMICON Taiwan展前記者會,邀請TSIA 理事長暨鈺創科技董事長兼執行長 盧超群、台積電物聯網業務開發處資深處長 王耀東、華亞科技總經理 Rod Morgan、日月光集團營運長暨董事 吳田玉、科林研發(Lam Research)亞太區總裁 廖振隆、Entegris 總裁兼執行長 Bertrand Loy,以及台灣IBM全球企業諮詢服務事業群副合夥人 林金泉等業界領袖代表出席
SEMICON Taiwan展前記者會,邀請TSIA 理事長暨鈺創科技董事長兼執行長 盧超群、台積電物聯網業務開發處資深處長 王耀東、華亞科技總經理 Rod Morgan、日月光集團營運長暨董事 吳田玉、科林研發(Lam Research)亞太區總裁 廖振隆、Entegris 總裁兼執行長 Bertrand Loy,以及台灣IBM全球企業諮詢服務事業群副合夥人 林金泉等業界領袖代表出席
 台積電共同執行長 劉德音先生蒞臨SEMICON Taiwan國際半導體展CEO高峰論壇,分享半導體產業未來的趨勢與動向
台積電共同執行長 劉德音先生蒞臨SEMICON Taiwan國際半導體展CEO高峰論壇,分享半導體產業未來的趨勢與動向
 蔡英文總統出席SEMICON Taiwan 科技菁英領袖晚宴,並頒發SEMI永續製造傑出領袖獎給聯電執行長 顏博文先生,表揚他對於半導體永續經營的貢獻與成就。(圖片由左至右: 聯電執行長 顏博文先生、中華民國總統 蔡英文女士、SEMI全球總裁 Denny McGuirk)
蔡英文總統出席SEMICON Taiwan 科技菁英領袖晚宴,並頒發SEMI永續製造傑出領袖獎給聯電執行長 顏博文先生,表揚他對於半導體永續經營的貢獻與成就。(圖片由左至右: 聯電執行長 顏博文先生、中華民國總統 蔡英文女士、SEMI全球總裁 Denny McGuirk)
 SEMICON Taiwan今年共吸引45,000人次參觀
SEMICON Taiwan今年共吸引45,000人次參觀
 經濟部長李世光出席SEMICON Taiwan開幕典禮時表示,半導體產業未來兩年將有更好的表現
經濟部長李世光出席SEMICON Taiwan開幕典禮時表示,半導體產業未來兩年將有更好的表現
 SEMICON Taiwan規劃一系列聯誼小聚,包括智慧製造、高科技廠房設施以及半導體材料,幫助相關廠商與客戶及供應商媒合
SEMICON Taiwan規劃一系列聯誼小聚,包括智慧製造、高科技廠房設施以及半導體材料,幫助相關廠商與客戶及供應商媒合
 今年的車用x設計論壇,深度探討車用半導體的發展與機會。隨後的IC設計產業聯誼午宴,更邀請到Uber台灣區總經理與現場佳賓交流
今年的車用x設計論壇,深度探討車用半導體的發展與機會。隨後的IC設計產業聯誼午宴,更邀請到Uber台灣區總經理與現場佳賓交流
 TechXPOT創新技術發表會邀請廠商分享最新研發技術與突破,提供與會者尋找解決方案與合作夥伴的絕佳機會
TechXPOT創新技術發表會邀請廠商分享最新研發技術與突破,提供與會者尋找解決方案與合作夥伴的絕佳機會
■ 參展廠商Highlights
琳得科 提供製程簡化的優勢
半導體後段封裝測試製程中,有「膠的專家」美稱的琳得科公司,提供先進製程用膠帶與設備最佳的自動化解決方案及全方位的產品。今年展出「晶片背面保護膠帶LC86系列」,除具備晶片背面保護膠帶的特性之外,並可對應WLCSP較薄晶圓的材料,貼片後仍可進行切割作業的能力,幫助簡化製程。另外,「E-9000系列」適用於錫球(Bump)材質,除了擁有良好的包覆性及貼覆後的平整度外,並可抑制研磨後晶圓翹曲,提高研磨製程後晶圓的厚度、精度等性能,提升穩定性生產品質。
「新型全自動研磨膠帶貼片機」,除了縮小占地面積優勢外,並增加機台的UPH,可大幅提升貼合作業的效率及性能,達到研磨用表面保護膠帶的低應力貼合及優良切割的要求

■ Rudolph提供下一代FOWLP及FOPLP解決方案
近年來全球各主要封裝測試廠持續提升晶圓級的先進封裝技術,尤其是扇出型晶圓封裝 (FOWLP) 技術。扇出型晶圓封裝(FOWLP)不須使用載板材料,預估可節省大約30%封裝成本,封裝厚度也變得更加輕薄,有助於提升晶片商產品競爭力。最近在多晶粒整合(multiple die integration) 需求及降低生產成本的考量下,面板級扇出封裝技術(FOPLP),也開始引發市場高度重視,從生產成本考量,比晶圓級扇出型封裝更具競爭力。
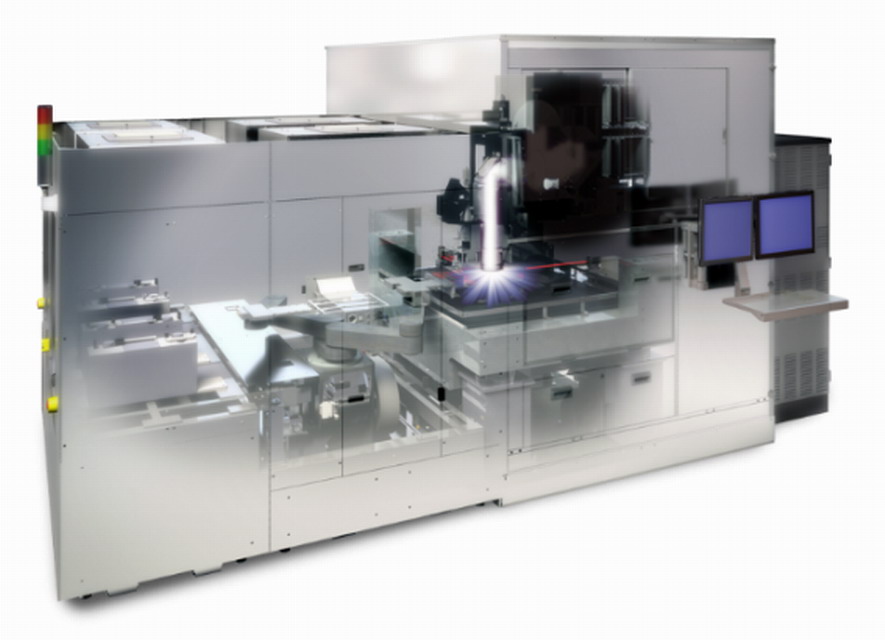 JetStep® S3500 Panel Lithography System
JetStep® S3500 Panel Lithography System
■ 豪勉科技展出智能營運平台
豪勉偕同日商SEIKO EPSON及新加坡商MIT,於SEMICON Taiwan 2016展出新款IC Handler高效率機型及新一代Die Sorter Machine Caerus C330。另外,豪勉自行開發的智能營運平台,在單一平台即時收納異質機台資訊,進行儲存、警示、視覺化分析,讓客戶從進料到出貨達成一條龍監控,同時滿足不同單位管理需求,絕對是台灣製造業面對經營環境巨變的競爭利器。
■ 千住金屬以三位一體滿足客戶需求
千住金屬工業今年將在SEMICON Taiwan展出的主題訂為”TRINITY SMIC”,其含意為將最新的材料、先進的設備及累積多年的製程技術三者整合一體化,進而提供給客戶最佳的焊接解決方案。因應車用半導體趨勢,要求具卓越耐熱疲勞性錫球的客戶也逐年增加,千住開發在Wafer實裝具有優良耐熱疲勞性的M758系列合金錫球產品。隨著技術的革新,穿戴式產品及平板的電子零件更進一步邁向小型化。千住開發出應用在Jetting Dispensing工法的M705-NXD900ZH及針對雷射焊接所開發的M705-SGC007錫膏等產品,以實現超高密度的封裝。
資料提供:SEMI(國際半導體產業協會);材料世界網 編輯室整理