微影技術主要是用於圖案化(Patterning)矽晶圓表面,以形成積體電路圖形,線寬解析度愈高,則積體電路單一元件晶胞(Unit Cell)的面積愈小,產品晶粒(Die)積集密度也就愈高。Lithography ITRS Roadmap(圖一) 提供一個具有指導性的技術開發規格之參考指標。驅使微影技術不斷向更高的線寬解析度努力之動力來自記憶體(以NAND 快閃(Flash)記憶體為主)與微處理器(包含邏輯IC)的電晶體密度及積體化提升的需求。動態隨機存取記憶體(DRAM)的需求介於前述兩者之間。半導體產業的Moore’s Law趨勢要求每兩年半提升積體電路密度一個技術節點(NAND Flash記憶體要求位元數增加成四倍),成為各積體電路製造公司瘋狂追求提升微影線寬解析度的原動力。經過不斷地技術突破及創新,目前微影技術已進入22奈米尺寸的線寬解析度時代。預期不久的將來會有一種微影機型在具備線寬解析度/ 控制度(指線寬粗糙度Line Width Roughness; LWR)、機台擁有成本(Cost-of-Ownership; CoO)、機台占地面積(Footprint)、能源消耗量、光罩(模仁)製作及劣化成本、可用製程條件範圍(Available Process Window)、製程缺陷產生率(Defect Generation)、晶片產率(Wafer Throughput,包括光阻的光敏感度)及營運成本(Running Cost,包括製程耗材及機台維護)等多項嚴格規格要求下,仍具最佳優勢的機具,成為唯一的主流奈米微影機種。
下世代微影技術種類
奈米微影技術目前進展到22奈米技術節點之製程及機台開發,所謂下世代微影技術是指具有能力或潛力達到22奈米線寬解析度的奈米微影機具。正在發展中的競爭技術有:(1)雙重圖案化(Double Patterning; DP)浸潤式氟化氬(Immersion ArF; ArFi)微影技術;(2)超紫外光微影(Extreme UV; EUVL)技術;(3)奈米壓印微影(Nano-imprint Lithography; NIL)技術;(4)多電子束直寫(Multi-electron Beam Direct Writing; MEBDW)微影技術;(5)光源−光罩同時最佳化(Source-mask Co-Optimization; SMO)計算微影技術等五類。目前尚在研發競爭中的各種類微影技術設備廠商表列參見表一。
表一、22奈米世代微影機台/工具種類及研發/製造商對應列表
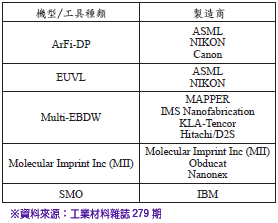
世界最大半導體製造公司Intel曾主導ArFi-DP及EUVL的發展。國內目前唯一公開與設備商間有合作研發或製造關係的是台積電(tsmc)與MAPPER合作開發低加速電壓(<5仟伏特)電子束直寫步進機。圖二說明ArFi 機台設計原理。當時的微影技術節點正處於65奈米及以下世代各種微影技術的競爭。主要競爭機種除浸潤式氟化氬掃描機外,尚有(1)100 KV加速電壓的電子束縮影微影機(Electron Beam Projection Lithography; EPL);(2)低加速電壓的低能量電子近接式微影機(Low Energy Electron Proximity Lithography; LEEPL);(3)氟分子(F2)準分子雷射(Excimer Laser)(光波長157奈米)掃描機;(4)近接式X光微影機(Proximity X-Ray Lithography; PXL);(5)離子束縮影微影機(Ion Projection Lithography; IPL)等五種機型。經過一番激烈競爭及評估後,除了浸潤式氟化氬掃描機外,其餘五種機型全部被淘汰。此一世代NGL 的激烈廝殺真可以用中國人的成語“一將功成萬骨枯”來形容(圖三中打“ X” 的部分均是被淘汰之機型)。想不到22奈米NGL世代又必須經過幾乎完全相同的一段競爭及廝殺的過程,只是淘汰賽的主角換成了另外的四種微影設備機型。前一世代NGL淘汰賽中,僅ArFi 仍然存活至22奈米世代續做競爭。圖四為由ASML計算的EUVL與各種ArFi-DP的CoO比較及圖五為由Semiconductor International 提出NIL(具壓印模仁複製前提)相對EUVL及Spacer DPL的CoO比較,均可看出EUVL及NIL相對於ArFi-DP具優勢……以上內容為重點摘錄,如欲詳細全文請見原文
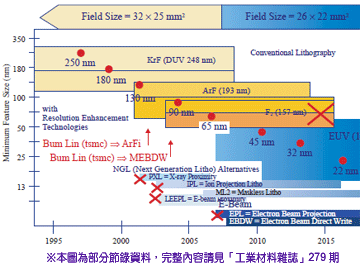
圖三、各種65奈米世代NGL發展時期對應特徵尺寸說明
作者:陳維恕/工研院電光所
★本文節錄自「工業材料雜誌279期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=8417