隨著奈米科技之進展,許多有關奈米檢測分析之儀器,已有其很好之發展;其中雙粒子束聚焦式離子束顯微切割儀(DB-FIB),也是一項不可或缺之奈米檢測儀器,因其具有高解析度之電子束(E-beam)以及具有強大之蝕刻能力之離子束(I-beam),使得這項儀器兼具檢測及製程之功能,包括高解析度之E-beam在CNT之檢測、各種奈米材料之剖面分析、SPM探針試片製作、製作含應力(stress)之試片以提供TEM之檢測分析、以及製作奈米結構提供近場光學之檢測等應用。
高解析度E-beam之檢測
因DB-FIB機台之E-beam功能具有如一般場發射掃描式電子顯微鏡之解析度,因此可解析如單壁CNT之奈米線。如圖一所示為檢測單壁之CNT奈米線至3nm,若不是利用高解析度之電子束,其奈米線可能常會被忽略,而無法探究其根本原因,進而失去製程改良之先機。利用電子束之高解析度模式,尋找適當位置,調整好像差及焦距後,直到觀察到此奈米線,此過程是需要一些經驗及技巧。由圖一所示之中間單壁奈米碳管連接著兩端較粗之碳管,可見其強度及韌度。若能適當掌握其製作過程,將可製作單壁奈米碳管試片,供深入之研究及應用。
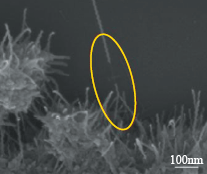
圖一、高解析度之E-beam檢測3 nm之單壁奈米碳管
資料來源:工研院材化所/工業材料雜誌第252期
在奈米材料方面,亦可藉由DB-FIB之截面分析技術,清楚分辨膜層間之界面(interface),如圖二為銅(Cu)與錫(Sn)之薄膜會隨時間做擴散,欲鑑別其界面之厚度與時間之關係,可做截面之蝕刻觀測其界面,進而分別利用E-beam及I-beam影像之對照,確定界面位置及寬度,再量其厚度,即可得出較精確之數值;由此數據可調整製程參數,以得到較佳之溫度控制及薄膜厚度。由圖二可以看出DB-FIB邊切邊看之優點,一方面由離子束作截面蝕刻,另一方面可由電子束作檢測判斷,是否已經切到所要之位置;因此,即時之截面分析技術,可減少過去試片需破片斷裂之風險,提高檢測之準確性,輔以I-beam之影像對照,更增加界面判斷之精確度。
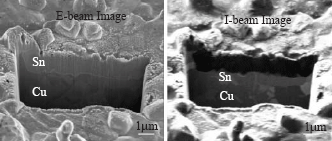
圖二、利用DB-FIB截面分析技術檢測銅與錫之界面
資料來源:工研院材化所/工業材料雜誌第252期
鋰電池之單顆顆粒3 D檢測分析
同樣的截面分析技術,把DB-FIB之技術由二維提升為三維剖面,鋰電池之單一顆粒即為其例。鋰電池之負極材料為Si-Ni之合金,若用傳統之方法找出顆粒,再作切割之截面分析,不是一件簡單的事,且容易因外力破壞其界面影響觀測結果;若利用DB-FIB之截面分析技術,則可減少破壞樣品之機率,且在E-beam下易於尋找此單一之合金顆粒,因而可執行3D之截面檢測分析,圖三為截面分析之SEM影像。
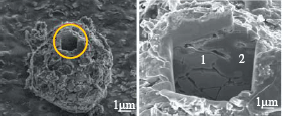
圖三、利用DB-FIB截面分析技術檢測Si-Ni單顆合金顆粒
資料來源:工研院材化所/工業材料雜誌第252期
在上圖中選擇適當之單顆合金顆粒,進行剖面切割後,即可觀察出如同3D之影像,並在右圖中可明顯看出在界面間顆粒大小以及顏色之深淺不一。經研判後可能是Si-Ni兩者含量有所不同,造成SEM影像上之對比有所不同,在標定圖中1,2之位置後,立即進行EDS之成份分析,驗證是否與推斷相符合。圖四為EDS分析之成份,果然與預期相符合。在SEM影像顏色較淺之位置1,其Ni之含量較多,而在SEM顏色較深處之位置2,其Si之含量較多;因此,今後此類之樣品便可建立資料庫及由截面分析,便能了解不同元素含量的分布,更進而提供製程調整與改善之依據。
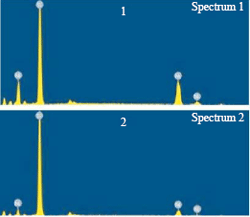
圖四、EDS之分析顯示在不同1,2位置,Si-Ni兩者含量之不同,可對照SEM影像上顏色之深淺不同
資料來源:工研院材化所/工業材料雜誌第252期
SPM 針尖、應力試片之製備,提供TEM之檢測分析
一般而言,SPM之針尖約在50 nm以下,以高解析度之SPM探針來說,針尖可達10 nm左右,目前DB-FIB也發展修針之技術,以提高其解析度,尤其是磁性探針。如何能讓TEM可分析此針尖,其試片製備為一大課題。一般TEM試片製備,會將製作好的試片置於含碳膜之銅網上,但SPM之針尖不像一般製作TEM試片容易切割並置於銅網上,且TEM之試片座也沒有如SPM之試片座可放置試片,除非另外訂做規格;因此,必需藉由另外的方式來製備此類樣品。DB-FIB提供了另一種技術來製備此類樣品,首先必須先將SPM之探針固定於DB-FIB之試片座上,利用此機台所配置之金屬(Pt)鍍膜與奈米操控器加上I-beam之切割,便可將SPM之針尖取下,另外,再將銅網置於SEM下,輕輕地把此針尖放置於銅網上,便能做進一步TEM之分析。
圖五顯示一鍍有金(Au)之薄膜的SPM探針,此探針之目的在於作近場光學之量測,因其金膜約在10~20 nm左右,而欲知其金薄膜之厚度及其分布情形,此兩項因素將影響近場光學之量測,所以可藉助DB-FIB之技術,把此針尖取下分析。如圖所示,奈米操控器將此針尖取出,並於右圖中置於銅網網格上,以準備作TEM之檢測分析。因此,DB-FIB在TEM之試片製備上,可提供一種其他方式不易製備的技術。
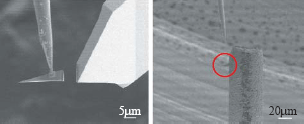
圖五、在SPM針尖之試片製備上,配合奈米操控器之運用,DB-FIB提供試片製備之技術
資料來源:工研院材化所/工業材料雜誌第252期
另外,在應力較大之TEM試片製備上,DB-FIB也提供可較適合製作試片之方法,以供TEM之檢測分析。一般而言,當兩種薄膜疊合在一起而有較大之應力時,傳統之研磨在磨成TEM試片前就已經崩裂,即使是利用DB-FIB一般之切片,也容易在未達到一定薄度時就已斷裂,因此,如何克服應力問題也是一項挑戰;所以在這方面我們也研發此能克服這類試片製備之技術;如圖六所示,一方面增加試片粗切時之厚度,另一方面利用平行切割的方式,如此就能克服這些問題,而提供適當薄度之TEM試片以供分析。
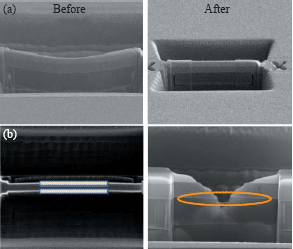
圖六、(a)增加試片粗切時之厚度,使之不易彎曲;(b)利用平行切割,可使試片不致於斷裂
資料來源:工研院材化所/工業材料雜誌第252期
奈米結構製作,以提供光學之檢測
DB-FIB具有I-beam蝕刻之能力及奈米級之製程能力,因此對光學要求之奈米週期性整齊之排列,當可達成其目標。所以,對於微且整齊週期性排列之奈米結構,DB-FIB為一重要考量機台,尤其是在近場光學之檢測分析上。首先,圖七樣品為玻璃基板,以金屬濺鍍方式鍍上200 nm厚的銀膜,利用DB-FIB蝕刻一圓洞,圓洞直徑為150 nm,深度為200 nm。圖七(a)、(b)為散射式近場光學顯微鏡(s-SNOM)的近場光學影像,分別利用632.8 nm 及532 nm 波長激發所得到近場光場強度分佈圖,右方的細干涉條紋及左方的大波辮為p 偏極態的入射光,於水平樣品的場與被孔洞激發的表面電漿干涉後的結果,圖七(c)為利用FDTD計算一個150 nm的孔洞受600入射光激發,垂直樣品並距離樣品表面20 nm處的近埸場強分佈圖,其中波長為632.8 nm。可發現與圖七(a)所量測的場分佈結果相當吻合,而圓洞激發的表面電漿行為如同點波源往外傳播,此特性對於往後解釋孔洞陣列的干涉模型將有幫助。因此,DB-FIB乃提供一對稱之圓洞以便s-SNOM作近場光學之檢測。
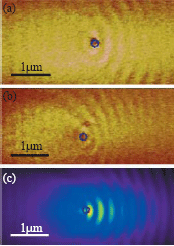
圖七、(a) (b)分別為632.8 nm及532 nm的入射光源,s-SNOM所得之近場場強影像分佈圖;(c)為632.8 nm的入射光源,FDTD模擬電場之分佈;藍色圓洞代表孔洞所在位置
資料來源:工研院材化所/工業材料雜誌第252期
另外,DB-FIB亦能製作橢圓之陣列,以供s-SNOM之量測;基本上,DB-FIB對各種材料皆可蝕刻以達到奈米結構之需求,當然仍須考量材料對粒子束之敏感度,但因近場光學常以金屬為主,尤其是電漿子光學,會以金、銀為主要之材料。所以如圖八也是以玻璃基板為基材,鍍上一層200 nm銀作為激發電漿子之材料。藉著適當調整I-beam之像差,配合調整像差時所產生深度變化之轉換率(此為一經驗值),則符合需求之奈米橢圓結構便可製作出來。
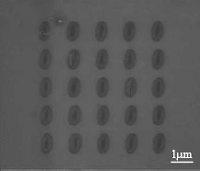
圖八、調整I-beam之像差,製作出橢圓之陣列
資料來源:工研院材化所/工業材料雜誌第252期
圖九顯示由s-SNOM所量測樣品之表面形貌及近場光學影像,可得知表面電漿子傳播之情形;若其橢圓形狀及其間之距離不對,或結構與入射波長不相調合,則無法得出近場訊號9。因此,DB-FIB可提供對微區且規則變化之結構一個很好的製作檢測樣品之工具,對初期概念之驗證具相當幫助。
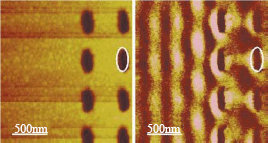
圖九、由s-SNOM所量測橢圓陣列之表面形貌及近場影像
資料來源:工研院材化所/工業材料雜誌第252期
DB-FIB的未來發展及應用
當然,對於DB-FIB之未來之發展,除了參考世界潮流趨勢外,也考慮國內及院內所內之需求並。由於材料發展有逐漸朝向有機材料開發之趨勢,因此,有關軟物質之相關產業勢必慢慢取而代之,包括太陽能電池之材料、可折疊式之顯示器、生醫材料等,其檢測分析將會是新才料研發上之一重要課題。所以,DB-FIB也從這個觀點出發,是否能發展軟物質鄉關之檢測分析技術。事實上,DB-FIB在製作TEM 試片,以提供檢測樣品之角色上,或許能有所助益,因此,將發展有關真空冷凍切片(cryo stage)之技術,期能保持樣品之完整度,不致於受到粒子束過多之破壞。另外,即時檢測(in-situ)也是目前對於了解原子分子隨時間變化之過程的重要技術,所以,DB-FIB在這方面也針對SPM之即時量測,提供適當之檢測分析樣品。
真空冷凍切片技術
由於軟物質之樣品易於在粒子束之轟擊下,被破壞殆盡而無法作檢測分析,因此,是否將其冷凍後再作試片之製備,可減少其損壞程度,而讓其他儀器能作檢測分析。DB-FIB之一優勢為微區定點切割,所以,可將此類樣品製作成可分析之試片,而有別於一般傳統製備技術,對軟物質樣品之製作有所困難。圖十為FEI公司所提供之冷凍切片零件,將可加裝於DB-FIB之機台上,以提供對有機或軟物質之試片製作技術發展。右圖為初步作酵素細胞之檢測分析,可看出其完整性將能予以保留。

圖十、FEI公司目前所提供之冷凍切片零件及其酵素細胞之分析
資料來源:FEI公司/工業材料雜誌第252期
即時檢測分析技術
不論是在電、光、磁、熱學上,深入了解原子分子隨時間之微觀變化,不但可掌握其機制,也能從中掌控製程參數,對科學之探討將有助益,也可將科技提升至新的里程碑;因此,從研發之角度而言,是值得投入的研究領域。圖十一顯示初步DB-FIB配合著奈米操控器,將鋰電池之負極單顆顆粒置於SPM之懸臂上,利用所建置SPM之液態環境,可在溶液中即時檢測此顆粒隨電壓變化之電容的大小,以了解鋰離子進出情形,作為製程改善之依據。

圖十一、DB-FIB配合奈米操控器,將鋰電池之負極單顆顆粒,置於SPM之懸臂上,提供即時檢測分析
資料來源:工研院材化所/工業材料雜誌第252期
★詳全文:https://www.materialsnet.com.tw/DocView.aspx?id=6528