半導體光電封裝材料技術不斷地提升來達到多功能化、高密度性及低成本等要求,材料廠商也竭盡全力提升自我研發能力,以期能有效掌控核心技術與專利,進而開拓高附加價值產品市場。台灣半導體產業供應鏈目前獨缺上游的關鍵材料及後端封裝材料,而相關的技術專利也大多掌控在美、日等大廠手中。
半導體構裝技術演進趨勢
傳統的半導體封裝技術如:BGA (Ball Grid Array)、QFN/DFN(Quad Flat Nolead/Dual Flat No-lead)以及CSP(Chip Scale Package)、FBGA(Fine Pitch Plastic BGA)等(圖一),已無法滿足目前晶片封裝產品的高密度、多功能異質整合、高傳輸效率與低成本等要求。發展最成熟的晶片尺寸封裝技術CSP,為了提升其生產效率及降低成本,也已朝向晶圓級晶片尺寸封裝WLCSP(Wafer Level Chip Scale Package)或稱晶圓級封裝WLP(Wafer Level Package)構裝技術發展。隨著WLP技術的引入與不斷的演進提升(圖三),從打線接合WB(Wire Bonding),再由覆晶技術FC(Flip Chip)結合打線接合,再往高密度化、大面積化晶圓級封裝技術等,皆順應了產品內部元件體積尺寸趨於更輕薄化的需求,並達最高構裝密度及有效降低成本等效益。
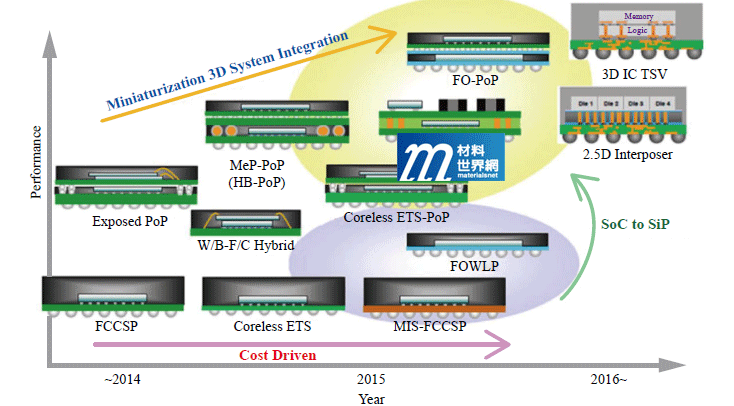
圖三、半導體3D-IC構裝技術趨勢
晶圓級封裝材料技術發展與市場趨勢
半導體構裝材料除了線材、導線架以及IC載板外,封裝材料主要又可區分為:固態封裝材料、液態封裝材料以及底部封裝材料等,此三者加總起來的成本比重大約占了12.7%;另外還有固定晶片用的黏晶材料以及錫球分別各占了3.4%與1.4%。根據Yole所公布的數據顯示,WLCSP市場規模預計將從2014年的30億美元增長到2020年的45億美元,每年以複合增長率8%成長,晶圓級封裝材料市場後勢展望樂觀。
封裝材料技術需求與特性
隨著封裝技術的迅速發展,對於材料的要求也越來越高,大多數的封裝材料廠商正面臨低營收成長狀況,需要尋求低成本封裝的解決方案。以全球半導體新型先進封裝材料技術與專利分析來看,主要廠商包括住友電木、日本京瓷、日東電工、日立化成、松下電工、信越化學等,而台灣封裝材料廠商正面臨相當多的問題,如:專利權問題、可搭配之先進封裝材料的開發課題、相關設備投入以及材料技術切入門檻過高等。而以材料技術的觀點來看,目前在晶圓級封裝過程中遇到最大的困難點是大面積薄型化封裝後的翹曲(Warpage)問題,在晶片模封過程中(圖四),樹脂材料在固化反應後本身會有收縮現象,再加上從高溫冷卻到室溫的過程中封裝材料的熱漲冷縮現象也會導致收縮,再加上與構裝基板介面間之殘留應力以及各材料間熱膨脹係數差異,皆會造成翹曲現象發生。
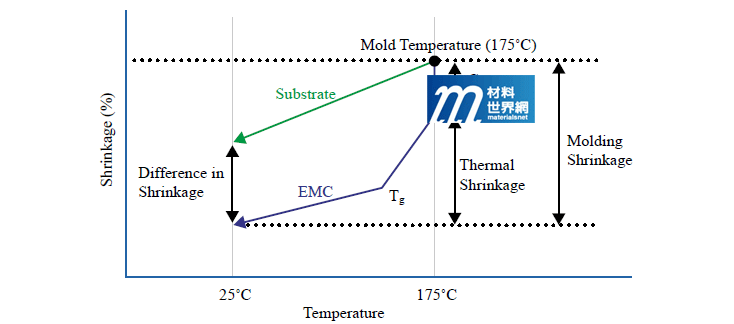
圖四、晶片在模封冷熱過程中之翹曲現象
封裝材料技術開發與研究
材化所多年來已建置完整的光電構裝用光電級高純樹脂材料改質合成及相關純化技術,如圖五所示。目前針對晶圓級封裝材料研究上,主要以固態封裝材料、液態封裝材料以及底部封裝材料為主;在樹脂材料端的開發上,最主要的考量是熱應力產生之成因與主要調控因素,包括:熱膨脹係數CTE、玻璃轉移溫度Tg以及彈性模數E’等議題。
半導體用的固態環氧樹脂模封材料其組成物的配方是以有機環氧樹脂系統混合高含量無機粉體為主,有機組成物可能包含:環氧樹脂(Epoxy)、硬化劑、催化劑、偶合劑、脫模劑、應力緩和劑、離子捕捉劑及其他添加劑等;無機組成主要是二氧化矽、碳黑等。所選用的環氧樹脂常見的是以結晶性固態環氧樹脂為主(圖六),須具有…以上為部分節錄資料,完整內容請見下方附檔。
作者:詹英楠、黃淑禎、陳凱琪/工研院材化所
★本文節錄自「工業材料雜誌」366期,更多資料請見下方附檔。