由於電子與光電元件體積縮小及功能提升的趨勢,造成元件發熱密度不斷增加,產生過熱問題而影響性能及可靠度,熱管理已成為電子及光電封裝設計非常重要的課題。近年來由於熱管理的需求增加,使得各種高效能散熱材料、元件製程及散熱設計技術發展非常迅速,也提升了傳統電子散熱能力的極限,而其中熱電元件就是目前非常受矚目的熱管理技術。熱電元件是一種固態電子元件,應用於致冷的主要原理是珀爾帖效應(Peltier Effect),將輸入電流轉換為熱能傳輸效應,實際應用時,主要是組成電性串聯而熱傳並聯的熱電模組(圖一),具有體積小、無動件、可靠度高等優點,近年來由於材料、製程及設計技術的提升,也使得熱電元件的性能增加,應用越來越受到重視。
IC封裝散熱應用
由於高功率IC如CPU的發熱密度非常高,影響元件性能及可靠度,造成嚴重的技術瓶頸。目前高性能晶片如CPU或Chipset等多採用覆晶(Flip Chip)製程,而在晶片上方貼附金屬片做為熱擴散及均溫之用。傳統熱電模組陶瓷基板須貼附於金屬片上方,因此增加材料層及接觸介面等熱阻,新的設計整合熱電結構採用金屬基板做為熱電材料基板,而直接貼附於晶片上,可降低封裝熱阻並提升元件效能,圖二為熱電元件整合FC-BGA封裝示意圖及封裝結構。圖三是利用JEDEC Standard進行晶片溫度及熱阻值量測,結果顯示,由於熱電模組具有高的散熱效能,甚至可將元件溫度降至室溫以下,因此元件熱阻值Rja會降為負值。隨著環境風速增加對流增強,熱電模組散熱性能提升。而加強熱電模組輸入電流及外加散熱片都可使散熱性能有效提升。
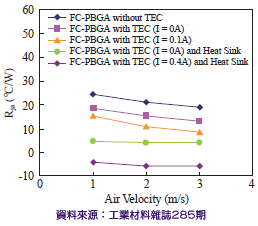
圖三、封裝熱阻量測結果
另一種以熱電模組進行熱點散熱的方式則是利用薄膜形式的熱電元件進行散熱,薄膜形式的微熱電元件體積小、吸熱密度高,因此可針對熱點散熱,整合在封裝散熱結構中可有效解決熱點問題。圖六是Nextreme Inc.利用超晶格(Superlattice)材料開發的微熱電元件,以內埋式設計做CPU熱點冷卻,可有效降低晶片熱點溫度。熱點發熱密度1,300 W/cm2時,可降溫15°C,如圖七所示。但元件製作複雜,在應用設計上如何降低各介面的接觸阻值以提升熱電元件散熱效能是主要技術困難點。
另一方面,目前IC封裝最新的技術發展是朝向3D IC技術,晶片透過微細凸塊(Bump)及通孔(TSV)等互連結構垂直堆疊,具有體積小、低功耗及高傳輸速率等優點。但由於晶片堆疊發熱量增加,使得發熱密度大幅提升,散熱是技術發展需迫切解決的問題。針對3D IC散熱問題,Georgia Tech.& IBM提出微流道技術,利用液體通過各層晶片表面及垂直連接的微流道產生很大的對流效果將熱帶走。
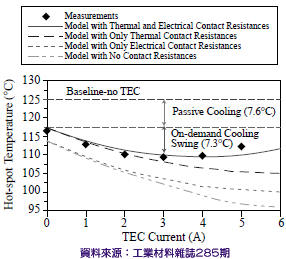
圖七、內埋式薄膜熱電元件熱點降溫效果
光電模組溫控
熱電技術應用於光電模組的溫度控制可分成兩部分,其中一個應用是光感應器的低溫控制,另一個重要應用則是光通訊模組的溫度控制。在光感測器方面,如高解析度的紅外線感測器及CCD影像感測器需要在低溫下有較佳的性能,以降低雜訊及暗反差(Dark Current)等問題,因此需使用多級熱電元件,一般利用二級熱電元件可降溫至-20°C,利用四級熱電元件可將溫度降至-50°C。元件一般以To-can形式封裝,如圖十四所示。
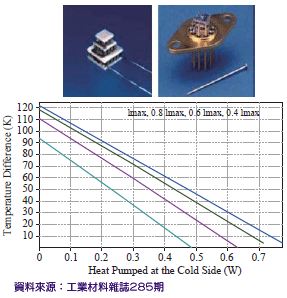
圖十四、多級式熱電元件及封裝散熱效能
熱電元件的應用主要除了避免元件溫度過高,也須控制穩定元件輸出功率及輸出波長,以得到良好的光品質。光收發模組(Transceiver)是一種主動元件,溫度會影響其發光波長偏移而造成資料傳輸漏失,如圖十五所示。利用熱電元件可精密溫控,精準度在±0.1°C之內…以上內容為重點摘錄,如欲詳細全文請見原文
作者:劉君愷/工研院電光所
★本文節錄自「工業材料雜誌285期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=8824