因應歐盟環保的浪潮,電路板材料與製程逐漸朝向無鹵素、無磷材料發展。根據實裝材料技術roadmap預測,在1998年至2010年間,印刷電路板基材的Tg由120~130℃提升至160~180℃,熱膨脹係數由現今60~80ppm/℃降至20~40 ppm/℃,絕緣層厚度由60~100μm降至40~60μm,小孔徑由150~250μm降至80~100μm。因應未來越高階的需求,在電路板最重要二個角色中樹脂材料與難燃材料,扮演著互相競爭的角色。
耐燃劑應用於PCB的技術發展如圖一所示,由於歐盟法規的限制,基板材料必須不含鹵素並且要提升耐熱性及尺寸穩定性以符合製程的需要,磷系難燃劑毒性較低、加工性佳、添加量少、發煙量低且與樹脂的相容性好,為近年來研發的主軸。然而添加磷化物的耐燃方式將會面臨玻璃轉移溫度較低與板材吸水性升高的問題,已經逐漸無法因應高階電子元件的需求,因此,無機類金屬化合物阻燃劑目前亦成為技術趨勢之ㄧ。此外,將奈米粉體納入基板的原料,可解決業界對基板性能的需求,利用奈米粉體所含之結晶水在燃燒時產生水氣以稀釋氧氣濃度以達到耐燃效用。奈米粉體亦可增加高分子之熱穩定性例如降低CTE與Tg等特性,其中最具代表性的是氫氧化鋁,佔無機阻燃劑的80%以上,它具有阻燃、消煙、填充三個功能,不産生二次污染,又能與多種物質産生協同效應,不揮發、無毒、腐蝕小、價格低。
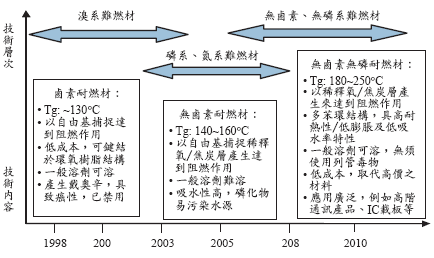
圖一 基板用耐燃材料技術發展趨勢
目前阻燃劑應用在PCB材料的結果,從圖二可知利用添加磷化物以因應環保的考量,對PCB材料的影響是也提升了基材部分物性如玻璃轉移溫度(Tg),但是板材之熱膨脹係數(CTE)與吸水性卻因為磷化物而變高,同時由無鉛製程的需求溫度提升,板材的耐熱性(solder resistance)亦從傳統的260℃ 提升至280℃以上,因應此部分的需求,磷化物必須藉助無機粉體的添加來達到,但對於高階產品的需求,將是一個很大的疑慮。對於無機粉體的使用,目前普便的種類其耐熱程度(Td1wt%)皆在260℃左右,雖然以有更高的耐熱型無機粉體產品出現,但其相對的在高溫時釋放的稀釋氣體量易減少甚多,此現象也降低了阻燃效果,同時過量的粉體添加,對於製程所造成的困擾是基板廠商所普遍面對的。對於此一問題,工研院材化所已於相應之對策,並可搭配新型可交聯之耐燃劑達到耐燃、低吸水、低熱膨脹與低成本之高階基板材料。
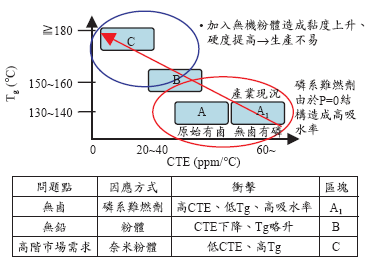
圖二 環保型有機/無機阻燃劑對PCB的物性影響
工研院著力於無鹵無磷高尺寸安定性基板材料目前已有顯著成果,技術的方向初步著重在耐高溫無機粉體的製備,同時進行具有高耐燃效果之交聯劑,應用將商品進行官能基的有機結構改質反應,所完成的交聯劑具有可與環氧樹脂交聯以提升交聯密度,有耐燃的結構可產生阻燃作用,同時高苯環的含量可增加基板耐熱性、低膨脹性及低吸水性…等效果。如圖三所示,將耐燃交聯劑應用於環氧樹脂系統的基板配方結果得知,具有高Tg可大於180℃、低熱膨脹(Z-axis=2.5%)、 低吸水性(<0.5% after PCT Ihr)、高耐熱性(288℃ solder text>300sec.),同時生膠水具良好儲存性(>72hr),以及具有UL-94 V0的耐燃等級,未來將可廣泛用於較低成本之高階電子用品以及複合材料的製造。

圖三 工研院材化所無鹵無磷基板材料測試結果
聯絡人:吳信和 (03-5914956)
★詳全文:https://www.materialsnet.com.tw/DocView.aspx?id=6262