本文分別介紹自旋轉移力矩式記憶體(STT-MRAM)、自旋軌道轉矩式記憶體(SOT-MRAM)及電壓控制式記憶體(VCMRAM)的發展史。此三種磁性記憶體,除媲美SRAM的高寫入/讀取速度,擁有與DRAM相抗衡的記憶容量外,更各有其優勢。
本文將從以下大綱,概略介紹各自之讀寫原理、優劣與發展歷程。
‧自旋轉移力矩式記憶體(STT-MRAM)
‧自旋軌道轉矩式記憶體(SOT-MRAM)
‧電壓控制式記憶體(VCMRAM)
【內文精選】
自旋轉移力矩式記憶體(STT-MRAM)
磁阻式隨機存取記憶體(Magnetoresistive Random Access Memory; MRAM)的技術在2006年進入一嶄新的紀元。Sony宣布推出首款實驗室生產的4 kb STT-MRAM (Spin Torque Transfer-MRAM)。該項技術是一種透過自旋極化電流(Spin-polarized Current)移轉效應所開發出的新記憶體技術,屬於非揮發性(Non-volatile)記憶體的一種,其應用優勢包括無限次數的讀寫週期、低耗電,以及運算速度更快等,更適合嵌入式設計應用。
早在1996年,美國IBM的學者Slonczewski和美國卡內基•梅隆大學的Berger教授已通過計算預測,當自旋極化電流流過奈米尺寸的鐵磁薄膜時,能使鐵磁薄膜中的原子磁矩發生變化。也就是說,電子的自旋能對鐵磁原子產生力矩,這個力矩可以被用來「翻轉」鐵磁體薄膜的磁化方向。圖一所示為場控式MRAM與STT-MRAM的讀寫架構比較圖。傳統的MRAM是採1T1MTJ設計,即一個電晶體搭配一磁穿隧接面(Magnetic Tunnel Junction; MTJ),如圖一(a),寫入時必須利用電流通過位元線(Bit Line; BL)與寫入字元線(Write Word Line; WWL)所產生的磁場來改變MTJ元件的狀態;而讀取時,則是控制讀取位元線(Read Word Line; RWL)使電晶體導通,並由位元線來檢測MTJ元件端電壓,進而判斷儲存於MTJ元件之資料。此方法因電晶體尺寸無法有效縮小,故技術上無法有效提升儲存密度與降低成本,造成進入商用市場的進度遲緩。
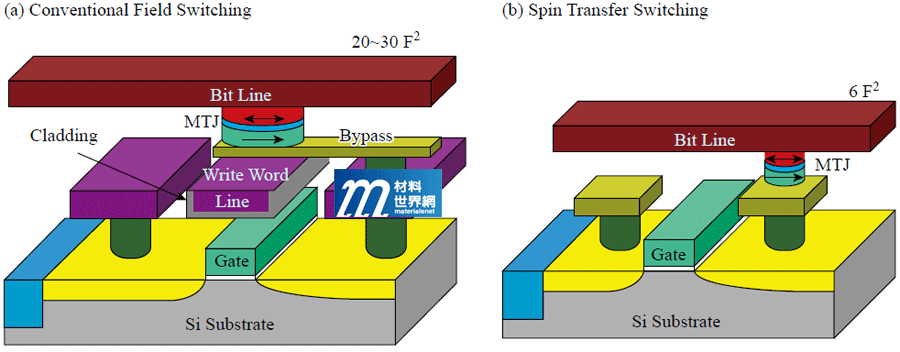
圖一、MRAM讀寫架構比較圖(a) 1T1MTJ;(b) STT-MRAM
自旋軌道轉矩式記憶體(SOT-MRAM)
SOT-MRAM是以電荷流誘導的自旋流來產生自旋轉移力矩,進而達到調控磁性記憶元的目的,如圖二(a)所示;其可分為基於Rashba效應(圖二(b))和自旋霍爾效應(Spin Hall Effect)兩類。其特別之處在於採用三端式MTJ結構,將讀取和寫入路徑分開,故比STT-MRAM具備更快的讀寫速度和更低的功耗。此舉不但保護了MTJ的隧穿絕緣層,而且增強了讀取數據的穩定性,並且由於將寫入路徑獨立出來,故可被進一步優化。
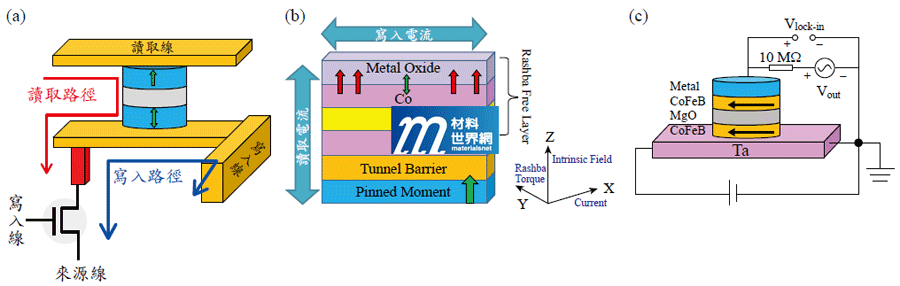
圖二、(a) SOT-MRAM架構圖;(b) Rashba效應;(c)自旋霍爾效應
其近年來之發展如下:
①2011年Jie Guo等人設計一基於Rashba效應的MRAM,該記憶元由在界面上具有強Rashba耦合的結構而構成。因Rashba效應的存在會誘導出巨大的內電場,當電流平行通過自由層時將可引發自旋轉移力矩,促使鐵磁層的磁矩發生翻轉,從而完成記憶元的寫入。
②2012年Liu等發現CoFeB/Ta的結構比CoFeB/Pt具有較大的自旋霍爾效應(GSHE),並成功使CoFeB磁矩翻轉,研究中之自旋霍爾角為0.12~0.15度,該自旋霍爾效應誘導翻轉架構如圖二(c)所示…...以上為部分節錄資料,完整內容請見下方附檔。
作者:葉林秀、吳德和/國立雲林科技大學
★本文節錄自「工業材料雜誌」377期,更多資料請見下方附檔。