近年來,隨著物聯網的興起、能源再生利用、綠能工業以及電動車等產業的持續發展,功率模組的發展已趨向高功率、高速化以及高密度。功率模組中與散熱直接相關的封裝材料共有三個,如圖一所示。分別是整顆模組的封裝外殼(Molding Material),以及直接傳遞晶片熱點的熱介面材料1(TIM1)和將基板熱傳遞至散熱鰭片的熱介面材料2(TIM2)。整個功率模組除了封裝材料之外,還會藉助金屬或陶瓷的散熱機構設計,達成整體散熱的目的。本文將針對現今功率模組之市場趨勢及發展進行分析,接著介紹功率模組的種類、封裝方法以及常用的封裝材料。最後將帶出高功率模組用封裝材料所面臨的散熱議題、解決方案以及未來展望。
功率模組之產業趨勢與市場現況
根據Yole機構的市場報告,2016年全球功率模組市場約35億美元,至2020年將成長至65億美元。一般以功率來區分,MW(106 W)是屬於大型應用,如軌道、電塔及船舶應用;kW(103 W)則是車載、工業以及家庭應用;其他更小的則是屬於使用一般電子應用,其分佈如圖二所示。隨著未來綠能電子的發展,功率模組將會有三大重要市場,分別為家用變頻系統、電動車以及工業控制應用。在所有的模組型態當中,IGBT模組擁有最廣泛的應用,包括電動車、無人機、馬達、風力、不斷電系統及鐵路等。
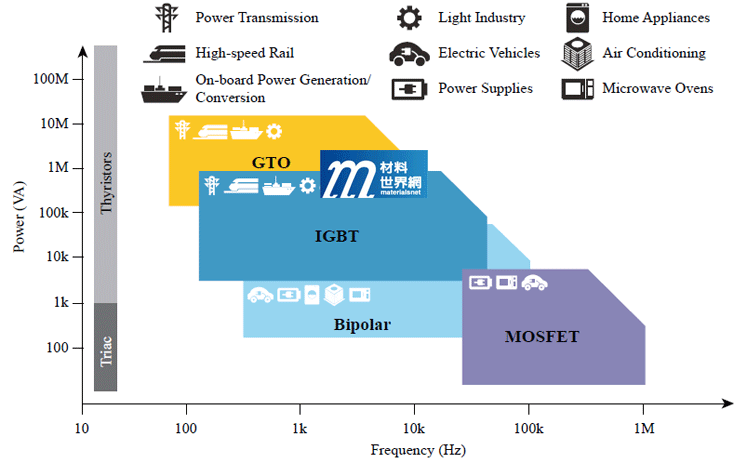
圖二、功率模組中的種類、應用與功率關係
圖五為IGBT以及MOSFET模組於車載市場中的發展趨勢。隨著能源議題受到重視,電動車發展不斷朝著輕量化邁進,功率元件必需的薄型化、高功率以及高密度已經是必然的發展趨勢。在車載模組的使用上,可以發現IGBT模組已占了約80%,因此在功率模組封裝材料開發上,也須及早針對IGBT的散熱以及可靠度需求,提出相應的材料設計方案。
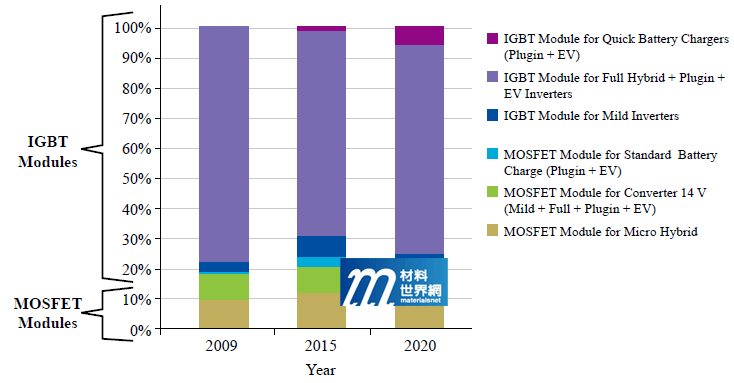
圖五、車用之高功率IGBT以及MOSFET模組的市場趨勢
功率模組用封裝材料介紹
功率模組所使用的封裝材料組成一般包含了樹脂、填充劑、硬化劑、硬化觸媒、改質劑以及其他特殊需求的添加劑。填充劑通常為無機物,一般大多數是使用結晶的氧化矽,如有耐壓或是高導熱的需求,則是會導入高熱傳導的填充料。樹脂通常是環氧樹脂(Epoxy Resin)和矽樹脂,其中以環氧樹脂為最大宗。
環氧樹脂常以轉注成形的方法封裝,矽樹脂則是以浸漬的方式封裝。環氧樹脂的選用是根據耐熱性、流動性以及模組的絕緣特性進行選擇。其中加成閉環法的環氧樹脂為酚醛型、雙苯酚型、多芳香環型、酚甲烷型、雙酚A型以及萘型,直接氧化法的環氧樹脂則為脂環型。硬化劑一般常見的為胺類、酸酐類以及酚醛類。不同官能基的選用以及官能基的數目,將會影響硬化溫度、硬化速度以及硬化後的封裝材料特性。
高功率模組用封裝材料所面臨的散熱議題與解決方案
功率模組的開發趨勢已確定朝向薄型化、高可靠度、功能整合及高功率密度發展。根據市場的統計分析,IGBT模組將會是高功率模組發展中最常使用的一型。未來將會以此基礎往多工的IPM模組進行開發,在此模組上將可同時實現驅動、控制及運算等多工運作。此外,為了往更高功率的模組系統發展,SiC晶片取代Si晶片已成為未來高功率發展的趨勢。晶片的可耐操作溫度從150˚C提高至200˚C,因此模組所產生的熱管理將會是最大的議題。其中封裝材料的封裝樹脂(Molding Material)以及熱介面材料(Thermal Interface Material)將會占整體熱管理議題的一半以上。因此,針對高導熱特性的封裝材料,國際各大材料廠…以上為部分節錄資料,完整內容請見下方附檔。
作者:劉彥群 / 工研院材化所
★本文節錄自「工業材料雜誌」364期,更多資料請見下方附檔。