隨著網路通訊技術進入 4G LTE世代,物聯網( Internet of Things; IoT )概念興起,許多全球性組織相繼制定車用專屬通訊協定( WAVE / DSRC ),使得政府、品牌車廠及 ICT業者將目光轉往汽車本身,也促成現今車載資通訊與車聯網( Internet of Vehicle;IoV )的快速發展。車載資通訊是以車為主軸,利用資訊、通訊及汽車電子技術來提供車內駕駛人多樣性的服務,更逐漸朝向多元資訊整合服務方式來滿足行車時的安全、交通、通訊、娛樂及商務需求。
汽車電子技術發展趨勢
為了符合乾淨能源環境,汽車將以氫氣為能源,結合雲端、互聯及巨量資料等技術,開發未來下世代行動社會藍圖;而福斯汽車也提出 90%汽車產業創新來自電氣與電子元件,其中包含資訊與導航、安全與服務、遙控、系統整合及App連結等功能。歐盟方面預計 2018年立法,未來汽車必備「交通事故自行通報系統」。2015年汽車型態將有 50~70%為 Connected Car,其產值約 310億歐元,到了 2020年,其產值更增加到 1,100億歐元;而 Mirrorlink、Apple 和 Google也積極開發無人駕駛車輛相關技術因應,主要透過車輛上的照相機、雷達感應器及雷射測距機來「看」其他的交通狀況,並且使用詳細地圖來為前方的道路導航。
車用功率元件技術發展趨勢
汽車各部元件乃是由各自獨立的電子控制單元所控制,各 ECU 又以微控制器為中心,分成電源、輸入及輸出部分。電源部分連接引擎室的 12V電池,供應穩定的電壓(5V、3V等)給 ECU 內的各區塊( Block );輸入界面則以混合類比( Mixed Analog )為中心,混合類比不僅把開關( Switch )操作傳達給微控制器,並將汽車的各種感測器資訊轉換成數位訊號傳達給微控制器;而輸出部分則是配備依微控制器的運算控制結果,驅動( Drive )馬達或致動器( Actuator )所需的功率半導體。
功率元件封裝材料發展趨勢
隨著通訊與攜帶型產品對元件體積要求日趨小型化,新世代構裝技術如 Flip Chip、CSP(Chip Scale Package)、Wafer Level CSP(WL CSP)、多晶片模組( Multi Chip Module; MCM )及三次元裸晶片等構裝技術亦逐漸被採用。因應這些新型構裝技術之封裝需求,除傳統固態移轉成型半導體封裝材料外,針對高腳數、大面積、無機基板及覆晶結構等新技術需求,使用新型液態封裝材料亦逐漸受到重視……以上為部分節錄資料,完整內容請見下方附檔。
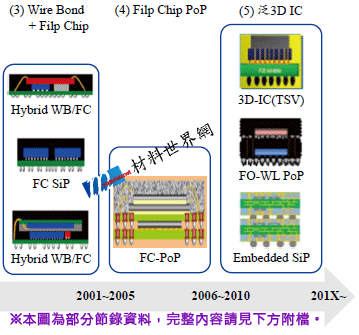
圖三、半導體構裝技術演化
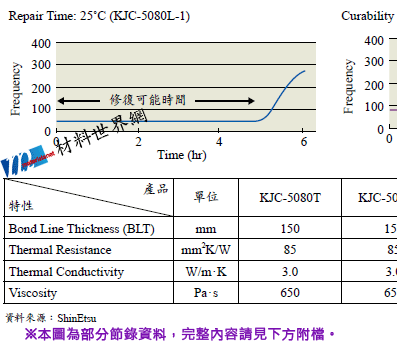
圖九、ShinEtsu KJC-5080系列之修復性、硬化性及導熱特性
工研院整合機械所的車輛影像安全、動力系統與車輛控制技術、電光所的功率模組技術、材化所的功率元件封裝材料技術、資通所的車間通訊和資訊服務技術,以及IEK的服務/營運生態系統建構。其中材化所主要開發功率元件封裝材料技術,透過特殊結構導熱樹脂設計合成,獲得具有高導熱係數樹脂(>0.4 W/m·K),以降低無機粉體添加量來製備高散熱、高耐熱(>200˚C)、可加工及高可靠度之封裝材料……以上為部分節錄資料,完整內容請見下方附檔。
作者:邱國展 / 工研院材化所
★本文節錄自「工業材料雜誌340期」,更多資料請見下方附檔。