高密度電弧蒸鍍技術為離子被覆(Cathodic Arc Ion Plating),屬於物理氣象沉積(PVD)技術的一種。一般是以靶材作為陰極,借助於引弧棒(Trigger),使靶材表面產生電離,利用引弧棒脫離靶材表面一瞬間,電阻急遽增大,使靶材溫度局部升高,從而在靶材表面形成等離子體,在磁場的作用下,飛速沉積在基材表面,其示意如圖一所示。
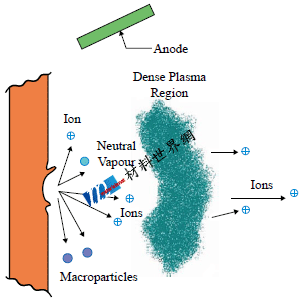
圖一、高密度電弧蒸鍍技術為離子被覆示意圖
表一為主要物理蒸鍍方法之功能比較,陰極電弧離子沉積屬於高能量物理沉積製程,在製程過程中不需要高基板溫度,沉積出來的膜層卻具有高溫製程的特性。與磁控濺射鍍膜相比,電弧離子鍍膜技術主要優勢包括:1.鍍膜與基材表面結合力強。這是因為離子不斷地轟擊基材,不斷地清洗基材,且離子轟擊所帶動能轉換為熱能,對基材有一個自加熱效應;2.鍍膜品質高。在薄膜沉積過程中,不斷受到解離陽離子的轟擊,致使冷凝物濺射,從而使製備的膜層更緻密;3.沉積速度快。高密度電弧蒸鍍技術由於具有沉積速度快、鍍膜均勻性佳、活化反應沉積優越、適合低溫沉積、各式化合物薄膜之成長(例如氧化物、氮化物、氮氧化物)等優點,越來越受到重視,已廣泛應用在汽車、模具、刀具與電子等領域。
具硬度梯度薄膜之活塞環鍍膜設計
本研究是有關於使用高密度電弧離子蒸鍍系統進行高硬度、高熱傳導速率與低摩擦係數之類鑽碳薄膜鍍膜開發。類鑽碳薄膜從1970年代被發現至今已經有40年的時間,近年來也被廣泛應用在刀工具等切削刀具與耐磨工件上,雖然類鑽碳薄膜擁有許多優越的特性,但仍有應用上的瓶頸待解決,像是薄膜與基材間內應力過大的問題。此外,類鑽碳薄膜與基材間因熱膨脹係數差異過大,會造成類鑽碳薄膜附著性不佳等問題。相較於刀工具與耐磨零組件,活塞環使用的環境與壽命要求更加嚴苛,因此若要將類鑽碳薄膜運用在活塞環表面,則類鑽碳薄膜必須具有相當好的薄膜品質,並與基材產生相當好的結合力。
為了解決類鑽碳薄膜附著不佳的問題,本研究使用多層結構(或稱為漸層結構)的設計理念,在類鑽碳薄膜與活塞環基材之間加入多層中間層(包含金屬緩衝層),中間層設計原則乃先利用金屬緩衝層降低界面應力,再分別利用金屬氮化層(硬度約 Hv 2,000)與金屬碳化層(硬度約 Hv 2,500)做為中間層,最後將類鑽碳薄膜被覆於最外層,製作成不同硬度層的硬度梯度結構,硬度從表面到基材界面逐步降低。
活塞環鍍膜薄膜(Cr/CrN/CrC/DLC)製作
本研究使用高密度電弧離子蒸鍍系統,具有電漿使用區域ψ≧400*H≧500(mm)六組電弧源,及可公自轉的工件載具,在電漿使用區域內可確保厚度均勻性,將Cr/CrN/CrC依序沉積於基材上形成多層膜。所得薄膜之 XPS分析顯示薄膜 SP3(ID)與SP2(IG)兩種組成結構的比例與所使用的基材偏壓有關(圖二),在基材偏壓為 -450V時所得到的薄膜擁有較低之 ID/IG 比例,代表此時的薄膜硬度最高,薄膜硬度分析結果也驗證此一趨勢(圖三)。當基材偏壓為 -450V時,DLC薄膜的硬度約為 25 GPa。DLC薄膜與基材間的附著力測試結果(圖四)也顯示,基材偏壓為 -450V時,得到的 DLC 薄膜與基材間的附著力最大(75.5N)。

圖四、不同偏壓下之DLC薄膜與基材之附著力測試
本研究也藉由 Ball-on-Disc 方式量測薄膜摩擦係數(圖九),結果顯示 ……以上內容為重點摘錄,如欲詳全文請見原文。
作者:陳溪山/工研院南分院
★完整內容請見下方檔案。