矽晶太陽模組的生命週期如圖一浴缸曲線所示,不同的時間歷程對應到嚴重程度不等的模組功率劣化原因,計有 p型矽晶電池的光衰、電壓誘發功率衰退(PID)、裂隙破片與電極腐蝕;模組封裝材料乙烯醋酸乙烯酯(Ethylene Vinyl Acetate; EVA)的脫層黃化、串焊用鍍錫銅帶腐蝕等可靠度問題,另模組架設遮蔭也可能引致熱斑(Hot Spot)。於電池製程前中段應用光致發光(Photoluminescence; PL)檢測可分析矽基材的裂隙、晶格差排、少數載子活存期與擴散長度;電池製程後段應用電致發光(Electroluminescence;EL)檢測能分析磷擴散不均、指狀電極網印缺損與燒結不佳,所造成的串聯電阻增高或並聯電阻降低等劣化填充因子(Fill Factor)的因素;模組串焊製程後的 EL影像能顯示串焊品質與檢測電池裂隙;此外,對戶外太陽光電系統進行 EL或熱影像檢測,能確認 PID或 Hot Spot現象劣化的模組,以利模組替換或架設工法調整,達成太陽光電模組發電效率優化及壽限延長。
矽晶模組關鍵缺陷與螢光檢測
1. 電壓誘發衰退
若太陽能發電系統輸出電壓的逆變器沒有做好接地措施,對太陽光電模組會產生偏壓,偏壓的大小與模組於系統中的串接位置有關,偏壓愈大會造成明顯的模組輸出功率衰退,嚴重時甚至會導致電池的抗反射層分解及電極腐蝕,如圖三所示。Sunpower公司曾於 2005年觀察到 N型太陽能模組在正偏壓增大時,填充因子劣化導致功率降低,迄今為止,許多模組廠在其 P型的太陽能模組產品也觀察到類似情形,嚴重時功率損失超過 50%,此現象通稱為電壓誘發衰退(Potential Induced Degradation;PID),近來已成為國外客戶投訴國內組件品質的主要問題之一。圖四為一般溫溼度環境下的模組,前板包覆鋁箔並承受負偏壓 -1,000V, 168小時後檢視其電致發光影像。

圖三、 模組受到偏壓導致(a)電極腐蝕;(b)抗反射層分解
2. 蝸牛紋與電池破片
太陽光電模組機械強度不足,在外界應力下容易造成電池破片(Cell Crack),經陽光曝曬後 EVA產生光氧化衰減形成類似蝸牛爬行過痕跡,稱為蝸牛紋(Snail Trail)或閃電紋,如圖六所示,初始影響外觀,後續則會造成模組輸出功率下降及壽限衰減。 J.Berghold等人觀察有蝸牛紋太陽光電模組的漏電流,如圖七發現有蝸牛紋的太陽光電模組漏電流有較高的趨勢,明顯大於 1 μA的電流。蝸牛紋的產生與電池破片有關, JulianeBerghold等人將蝸牛紋的產生與電池破片概分為電池低破片比例、高破片比例及微裂三種類型(圖八),其產生的蝸牛紋痕跡及功率損失,與破片的比例及程度成正比。
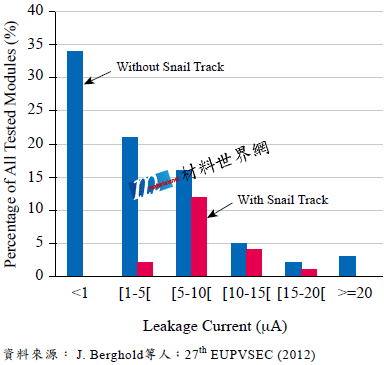
圖七、蝸牛紋太陽光電模組的漏電流測試
發展趨勢與結論
非破壞性螢光檢測技術從初期應用於矽晶電池與模組缺陷的定性分析,後續配合電池等效電路模型的提出與量測方式的建立,許多與電池輸出功率相關的電性參數已能數值化呈現,在光致發光(PL)影像部分,澳大利亞設備商 BT Imaging於 2011年時由 PL訊號強度轉換成少數載子活存期,由調變激發光源強度與電流密度的 PL影像可估計串聯電阻……以上內容為重點摘錄,如欲詳全文請見原文。
作者:劉漢章、黃兆平/工研院綠能所
本文節錄自「工業材料雜誌333期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=17087