下世代微影技術之進展
目前此五類奈米微影技術均各自有其優勢、缺點及尚待努力之處。以下將陳述各技術的進展現況及新近未來立即將面對的嚴苛挑戰,並就光阻材料/製程開發及機台硬體(含光罩)發展等兩方面加以說明。
適用於各種類NGL Tools 的光阻開發可能是一項最嚴峻的挑戰之一,2009 年SPIE Advanced Lithography研討會成長最多的即是來自光阻開發類論文。一個非常穩定光阻的開發要經過光阻商及設備製造/使用者許多複雜的可量產性測試後,始能釋出給生產線大量使用。這些可量產性測試包括:(1)Particle過濾/沉澱結粒;(2)線寬解析度;(3)線寬粗糙度;(4)光敏感度(Sensitivity);(5)聚焦深度(Depth of Focus; DOF);(6)曝光寬容度(Exposure Latitude; EL);(7)曝光後烘烤條件(Post Exposure Baking; PEB)及其穩定性;(8)曝光後顯影延遲(Post Exposure Delay; PED);(9)圖案製程缺陷檢測;(10)近接效應(Proximity Effect)強弱程度與修正;(11)短/長期穩定性;(12)其他等。以往光學微影設備商之間的競爭時光學縮影硬體部分相同,僅光阻商針對光源波長特調光阻成分來適應機台的特性即可。
DP製程發展的主要原因是單一曝光圖案化(Single Exposure Patterning; SP),目前幾乎已確定無法達到更低的38奈米線寬解析度極限。DP製程主要分成線寬/ 間距(Line/Space)及接觸孔洞(Contact Hole; C/H)兩類圖案發展。以單一方向圖案來說,要以相同技術節點的ArFi Tool曝顯更小的圖案,將會出現線寬與間距出現1:3 的差異,必須再利用另一次線寬/間距為1:3的曝光來填補過大的間距,使線寬/間距為1:1的圖案密度。目前ArFi-DP光阻的開發主要是希望降低單一圖案層的DP 製程成本。目前DP製程分成以下三類:(1)1st PR微影→ 2nd PR微影→蝕刻(Litho-Litho-Etch, LLE);(2)1st PR微影→蝕刻→ 2nd PR微影→蝕刻(LELE);(3)1st PR微影→間隙壁(Spacer)→回填凹槽→平坦化→蝕刻(Spacer DP; SDP)。圖六展示的是上述三種DP製程流程。
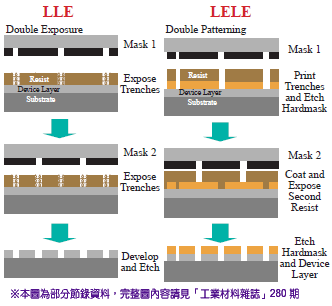
圖六、各種雙重曝光技術之製程流程簡介
22奈米世代微影設備的硬體發展較前一奈米世代淘汰賽更加困難,主要是因為微影設備的線寬解析度更小且更接近光學或電子光學的極限,機台軟硬體的控制也更加困難。尤有甚者,例如EUVL的占地面積超過一般十二吋廠規劃建廠單一機台面積太多,且機台消耗電力能源嚴重,使廠房設計可能必須擴大。相信這會直接導致EUVL 讓有意購置者產生更多顧慮。圖七將目前各種22奈米微影機台/技術的各項細部技術發展現況分成齊備(Ready)、接近齊備(Close to Ready)及距齊備尚遠(Far from Ready)等三種程度評估。細部技術主要分成光源、縮影光學、光阻材料/製程、光罩製作/耐用度(MEBDW則為資料傳輸率)、晶片移動平台、光罩/晶片缺陷控制、設計軟體及總和產率等。ArFi-DP的設備發展部分較無問題,主要還是來自前述的光阻DP材料與製程開發及光罩圖案分割等問題。各公司採用的DP製程應會各不相同,但都會影響產率(Throughput)。單一圖層以DP製程完成的成本提升及產率下降是目前其他種類設備尚未完全被排除的主因。但整體而言,ArFi-DP是目前發展齊備項目最多的機型。EUVL目前最主要的問題在於光源的功率尚嫌不足,2009 SPIE研討會上,Cymer Inc.公司報導目前的光源功率約50Watt@IF (Sn DPP)展示Proof-of-Principal,亦即產率約50(晶片/小時,WPH)。距離量產需求超過100 WHP仍有相當大的努力空間。
DP光罩基本上與SP的傳統ArFi光罩製作流程相同,僅DP圖案分割部分牽涉光源、光學近接修正(Optical Proximity Correction; OPC)及光阻特性而需模擬計算做最佳化設計。光罩製作的挑戰性並不會特別困難。EUVL反射式光罩因利用Mo/Si多層膜堆疊構成EUV光反射,多層膜厚度精準度對於光發散(Dispersion)極為重要……以上內容為重點摘錄,如欲詳細全文請見原文
作者:陳維恕/工研院電光所
★本文節錄自「工業材料雜誌280期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=8487