整合奈米/生物科技及電子/機械的第3代MEMS技術
微機電(MEMS)係指持有微小三次元機電結構體,可以處理各種輸出入信號的系統,可以結合半導體元件製程,如微影蝕刻(Photolithography)技術等,製作出微小的立體構造。目前已有許多利用半導體技術製作的之商品化MEMS元件,如感測器、噴墨印表頭、微鏡(Micro Mirror)的顯示器等。
第一代MEMS元件是從取代傳統既有零組件的單一功能出發,目前朝向高功能、小型、高可靠度等複合多功能的第2代MEMS趨勢發展(或稱為Fine MEMS,如下圖所示)。此代MEMS的研究朝向MEMS與奈米機能複合、MEMS與半導體的整合技術、MEMS與MEMS一致化高度整合技術等三方向進行開發。而未來第3代MEMS則將邁向與奈米/生物科技、電氣/機械上的融合。目前日本即將開始研究具有自律分散機能之元件或系統,通稱為BEANS(Bio Electronic-Mechanical Autonomous Nano Systems),預定從2008年度5月起開始進行BEANS用基盤技術開發計劃。圖一(a)、(b)為BEANS技術實現化與市場發展預測之Road Map。
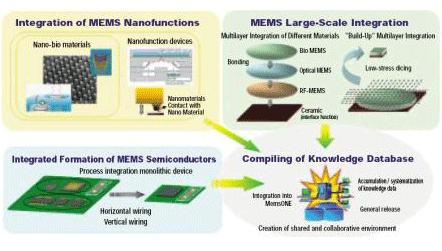
圖一(a) BEANS技術實現化之Road Map
資料來源:http://mmc.la.coocan.jp
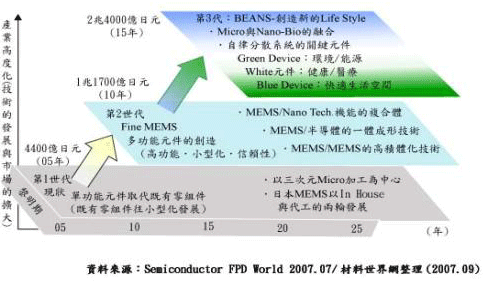
圖一(b) BEANS市場發展預測之Road Map
資料來源:Semiconductor FPD World 2007.07/材料世界網整理(2007.09)
半導體製程技術的發展趨勢不斷的往微細化推進,而目前MEMS元件製作尺寸仍以微米(micro-meter)為主流,因此可直接應用目前半導體技術,自由的製作出想要的立體結構。近年來奈米級的加工技術逐漸發展,如利用電子束曝光、薄活性層的SOI製程,目前已經可以做到數十nm大小的結構大小。但另一方面,由於半導體元件係在二次元平面上建構,而MEMS元件其為立體構造,為達成此目的,因此必須開發半導體不必用到的體加工技術,如Deep Etching,或異方性蝕刻等,以實現高深寬比的加工技術。
由於MEMS元件通常至少含有一可動元件或懸浮結構,在封裝過程中對於外界環境是十分敏感的,稍有不慎即會造成元件損壞。為確保可動元件能正常動作,因此封裝方式需能提供微機電元件適當動作空間;而且此空間通常為一密閉腔體,以避免外界的空氣、濕氣、污染物等進入元件腔體中,造成元件特性降低或是損壞。因此其封裝技術,如從晶圓將元件切出的Die Sawing技術、取Die、打線、molding技術等,都是與半導體元件不同。
MEMS必要的基礎技術開發
MEMS元件製造是一種類機械加工方式,其會因為採用之製程不同,而由有所改變。例如相同MEMS元件,若採用材料不同,其相對需要製程亦不同。因此即使有好的Idea,如果找不出有用的製程,也不可能成功製造,因此有必要對MEMS製造的基礎進行開發。目前日本在這方面,有所謂MEMS用設計/分析支援系統開發計劃--「Mems ONE」系統(MEMS Open Network Engineering System of Design Tools Project),開發期間從2004年到2007年3月結束。
何謂「Mems ONE」系統?以功能面來看,Mems ONE系統包括MEMS設計時必要的分析/設計用軟體,以及與最終構造設計相關的光罩或搭配製程的設計軟體,並可與後段接合、封裝評估軟體結合,再搭配奈米印刷與迴路進行整體分析等。此外,還包括了超過1700個資料庫(Data Base)與約170個材料特性資料庫。
晶圓級封裝所需技術開發現況
Tecnisco公司是一家提供高精度切、削、磨技術、電鍍、薄膜形成、蝕刻,以及組裝等高精密-「close etch微細加工」的公司,而此技術正可以應用至MEMS領域。
1. 開發玻璃貫通配線基板
MEMS元件因為內部有機械性的可動部位,一般均採取晶圓級封裝(Wafer Level Package),封裝完成後再進行後續晶圓切割製程。從可靠度觀點來看,氣密性的封裝不可或缺,另外使用無機材質的封裝亦為趨勢。因此,Tecnisco公司採用不必接著劑之陽極接合技術,搭配金屬貫通導線,開發出「金屬孔洞之玻璃貫通配線基板」。圖二為附金屬孔洞之玻璃貫通配線基板的封裝概要。
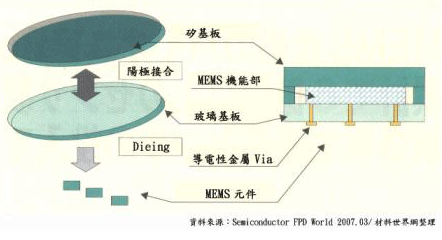
圖二 利用附金屬之玻璃貫通配線基板進行封裝概況
資料來源:Semiconductor FPD World 2007.03
2.採用矽酸硼玻璃基板
附金屬孔洞之玻璃貫通配線基板的玻璃,採用容易與矽基板的接合的矽酸硼玻璃基板,其好處是其與矽基板溫度係數類似,在封裝過程中較不易有熱應力殘留,並可配合陽極結合法進行晶圓級接合與封裝。
運用了附金屬孔洞之玻璃貫通配線基板與晶圓封裝,具有如下特性1.電極可以從封裝的側面取出,容易小型化2.實現低電感、低電阻化3.可應用至數十GHz高頻元件。Tecnisco公司正在研究推廣使用此基板之高頻用開關/繼電器、壓力感測器、加速度感測器、角速度感測器、Bio用感測器/Bio Reactor以及醫療機、各種機器人用感測器等應用。
3. 貫通電極加工技術
至於貫通電極用的加工技術,主要為其開發獨家的玻璃專孔開孔機,實現玻璃基板的高精度加工孔洞,且加工後之玻璃基板易採用陽極接合,與矽基板直接接合封裝,由於玻璃與矽基板之高溫度係數匹配,因此可實現高耐熱性。但玻璃與成為電極的金屬之間的密接性差,可能產生剝離、漏電。Tecnisco公司的解決方法,採用濺鍍法,先在玻璃孔的側壁形成密接的金屬膜,此膜對玻璃而言,一面具有鉸鏈似的功能,一面又兼具有緩和孔內部接合材與後續填充導電性金屬,因熱膨脹引起的熱應變(Stress)。在玻璃孔洞濺鍍好金屬膜之後,再充填導電材。
目前玻璃貫通配線基板的直線型孔洞的直徑,最小可以做到200μm,孔洞精度為±20μm,深寬比(Aspect Rate)約1~3,腳距(Pitch)精度±20μm。此外,已通過450℃/2小時的耐熱性、20mΩ以下電阻率、1x10-6atms.cc/sec的氦氣測漏、0.6kgf的導通金屬接合強度之可靠度試驗。未來發展方面,Tecnisco公司一面積極改良close etch微細加工技術,一面展開應用推廣,努力開拓如醫療、生物技術等新市場;對於玻璃貫通基板方面,也持續進行改良,如導通孔數,目前已大幅提昇已可超過1萬個以上,此外氣密性也更為提高,目前已達樣品試供階段。
★詳細內文請見下方附檔