PCB材料發展趨勢
近年來電子產品在輕薄短小及行動化的潮流趨勢下,薄型化、構裝密集化、高速化、高導熱、觸控及節能均是重要的需求,其中最重要的包含了軟板、硬板材料發展現況與未來趨勢,以及相對應的線路設計與周邊材料的開發。
綜觀來看,目前 PCB的產業技術不管硬板或軟板都是往高頻、高速以及高密度構裝的方向發展,對於材料以及製程的需求會越來越嚴苛,加上目前雲端科技以及行動傳輸的大量資料傳遞需求,因此相關製程與材料往高頻段 (~GHz )發展是一門顯學,其中最重要的材料特性需求就是更低的介電常數( Dk )/介電損失( Df )、高耐熱性以及 Low CTE,而設計端如何搭配材料與製程在有效的基板面積上設計出符合高頻應用的產品也是未來整個電子業重要的發展趨勢,本文將介紹目前 PCB 材料發展的趨勢以及應用方向。
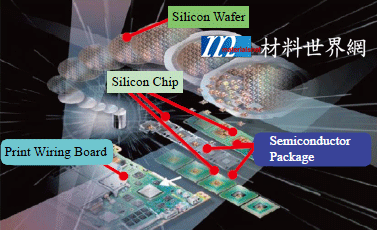
圖一、電子構裝層次結構
軟/硬板產品發展與技術介紹
由於銅箔基板是PCB的材料核心,它是由樹脂、補強材和金屬銅箔三者結合而成,所以樹脂含量及種類都會影響基板的電氣特性,此外補強材的種類也是重要的影響因素,因此不同電子產品應用可搭配不同的纖維及樹脂來達到訊號高速化與完整性的傳輸。當使用的玻纖是介電常數~4.7、介電損失<0.004 的NE-glass,其訊號的完整性大於一般使用E-glass的產品(表一)。
圖四是目前高頻樹脂材料研發的方向演變,已經從傳統的環氧樹脂逐漸轉移到碳氫樹脂(HCR),碳氫樹脂又稱為烴類樹脂,是由碳氫原子組成的烯烴聚合物,本身為低極性的高分子,加上結構具有高對稱性,以及含有的極性官能基種類與數量不如環氧樹脂來的複雜,因此具有較佳的介電特性(Dk ~2;Df <0.005),而有機會作為高頻樹脂材料的選項,且由於這類型樹脂本身具有的極性官能基少,所以可以利用此特性來建立基板的特性,但是也必須要克服本身耐熱性較差、與銅箔接著不佳的缺點以及現行製程相容性的問題。為了克服這些缺點,可利用官能基修飾或分子設計的方法來改質或變性,以提高熱安定性及降低其成本。
產業應用
近年來,隨著智慧型手機、平板電腦的普及化,消費者利用智慧型手機和平板電腦的無線連網功能,自雲端下載所需資料或圖檔,加上電信業者推出3G/4G上網吃到飽服務,資訊處理的需求容量與速度持續增加,對於硬碟容量、路由器以及伺服器的需求持續成長。其中雲端伺服器出貨量佔所有伺服器出貨量的比重將愈來愈大,從2010年的5%躍升至今年的15%以上。
另外,逐漸成形的物聯網風潮,傳統產品被加注了通訊和無線連結的功能進而轉變為智慧化電子產品,將帶動網路建構更趨完整以及無線網路的擴大佈建,所應用的路由器、交換機、防火牆、IPS、VPN等網路設備也會呈現正成長(如圖七)。由此可知,隨著高速傳輸需求的增加,電路板需要耐高溫和低雜訊,且穩定度要求高,也直接提升高速高頻PCB材料的需求增加……以上為部分節錄資料,完整內容請見下方附檔。

圖十一、可延伸軟性電路板
作者:洪銘聰、鄭志龍/工研院材化所
★本文節錄自「工業材料雜誌」346期,更多資料請見下方附檔。