麥克風在日常生活中應用廣泛,只要是接收聲音轉換為電訊號的場合都看得到,例如手機、電話、對講機、耳機、多媒體電腦、錄音筆、助聽器,以及目前流行的互動式電子狗、電子恐龍等;還有識別身分的聲紋辨識與衛星導航或是家電人工智慧的聲控裝置等新興潛力應用。利用半導體加工製作且耐高溫的麥克風與傳統麥克風(Electret Condenser Microphone;ECM)相較,具有微型化、省電與多功能的特性,特別適用於助聽器或超薄手機等高階市場,因此吸引以發展助聽器為本業的樓氏(Knowles)首先投入開發並量產。目前市面上已有多家公司提供將微型麥克風與類比放大電路封裝成為單一麥克風之產品。由於MEMS 麥克風具有體積小、低干擾及自動化生產等優勢,未來將取代傳統式麥克風市場。根據Yole Developpement 統計資料顯示,預估2006~2011 年MEMS 麥克風的年複合成長率可達43% , 2008 年麥克風整體市場出貨量為33 億顆,其中MEMS 麥克風占6.4 億顆,滲透率達19% ,預估2015年其滲透率將達35% 。雖然整體市場需求不斷看漲,但要切入此一市場,其技術門檻卻不低,其中MEMS 麥克風元件之封裝技術為一重要需突破之技術。為滿足國內技術開發之需要,工研院南分院微系統中心針對MEMS 麥克風元件之封裝技術進行研究,並希望藉此建立國內相關技術能量,協助國內封測產業技術升級。
MEMS 麥克風元件
在探討MEMS 麥克風元件封裝技術之前,需對MEMS 麥克風元件之結構與特性有所瞭解。MEMS 麥克風的功能係將聲音轉化為電壓,利用薄膜結構感測音壓產生相對應的變形,再將薄膜變形以電容感測方法讀出為電壓。電容式麥克風由一個導電的薄板與多孔的背板(Back Plate)形成電容結構,薄板受聲壓作用而變形,造成電容值改變,前級的讀取電路負責將電容變化轉換為電壓輸出,再經由後級的放大器將輸出訊號提高到所需的強度,實際的麥克風結構如圖一所示,薄板兩側的靜態壓力由一通道相連,因此薄板僅反應動態的壓力變化,背腔(Back Chamber)為封閉空間,提供部分的彈性回復力,可用於調整聲阻(Acoustic Impedance)與整體頻率響應特性。
由於MEMS 麥克風元件受音壓產生之電容值變化小,故需匹配一個放大電路,此放大電路架構包含轉阻緩衝級電路、放大器電路與偏壓級電路架構。轉阻緩衝級電路架構是將微電容之阻抗值轉換至較低之阻抗值,以利信號輸入與處理,進而將信號傳遞至後級放大器。偏壓級電路則進行提供元件需要之偏壓,使麥克風獲得穩定之偏壓電壓,以維持一定之感應性能,圖二為Knowles 電路架構之示意圖。因此,一個MEMS 麥克風模組基本上需包含感測元件與放大電路兩部份,缺一不可。
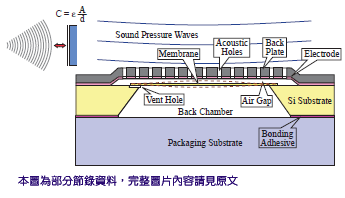
圖一、電容式MEMS 麥克風結構與Knowles 示意圖
MEMS 麥克風封裝
由於微電子封裝之製程已發展數十年,基本上MEMS 麥克風模組封裝大多依循微電子封裝之製程進行,但因應MEMS麥克風元件之性能需求,會增加特殊製程與設計,以滿足麥克風模組性能之考量。圖四為典型MEMS 麥克風模組之封裝流程,整個流程與現行之IC 元件封裝流程並無太大差異。圖五為Knowles 麥克風之封裝外觀,雖說流程與現今IC 封裝流程類似,但因MEMS 麥克風元件之感應結構為一厚度小於2μm之薄膜,故在某些晶粒上需考量對微薄膜結構之影響,以下因素將對麥克風模組性能與良率產生影響,簡述如下。
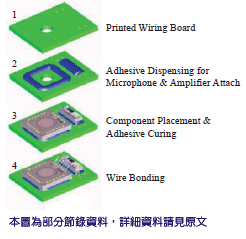
圖四、MEMS 麥克風典型之封裝流程
1. 晶粒切割(Dicing)
此為微機電封裝的挑戰,晶粒切割是將晶圓切割成單一小塊。通常切割是使用數密耳(Mils)厚度的鑽石刀,其需要良好的冷卻液順著切割方向流過晶圓表面,將切屑與鑽石粒子沖掉,以避免刮傷晶圓表面,而冷卻液另一功用乃是洗淨晶圓。其主要的參數包括切割速度、進刀深度、鑽石粒徑,以及冷卻液沖刷的速度、角度與方向等(圖六)。但麥克風薄膜感測結構厚度僅有數μm,很容易受切割製程中之冷卻液衝擊而造成結構斷裂毀損,或因水之毛細作用而使麥克風薄膜結構與背板產生附著,這些都是封裝廠必須面臨的問題。若以Laser 乾式切割將可避免此一問題,進而提升切割良率。
3. 裸晶上膠固定(Die Coating)
傳統微電子封裝對裸晶上膠固定之膠材選用非常謹慎,因為不同材料介面間之熱膨脹係數(CTE)差異會產生熱應力,這些熱應力作用會造成IC 元件之斷裂或功能失效。對於MEMS 麥克風而言,這些熱應力作用同樣會造成麥克風感應薄膜結構之變形或功能失真,且承受熱應力影響之能力不如傳統IC 元件。其原因……詳細全文請見原文
麥克風晶圓級測試
在元件切割與封裝前,傳統IC 產業會以電子測試方式進行WAT測試,以瞭解元件之良率,微機電元件需有外在感應才會有訊號輸出,而在晶圓上之元件又如何驅動?因此,對微機電元件如何做到元件製程之WAT 測試實屬困難。為使國內產業解決此問題,工研院南分院藉由對元件特性的瞭解,進而利用晶圓級的電壓− 電容(C-V)對麥克風進行作動特性確認,以確定POST CMOS 後製程可將麥克風結構釋放……詳細全文請見原文
作者:王欽宏、李新立/工研院南分院
★本文節錄自「工業材料雜誌273期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=8031