消費者對可攜式產品小型多功能化的持續追求,導致產品的空間尺寸愈來愈小,但零件卻愈來愈多,可供散熱的表面積愈來愈小,散熱問題日益嚴重。針對散熱問題的處理方式,近1~2年的發展策略已由原來行之有年的「熱對策」,轉變成幾乎所有設計者都不能忽視的「熱設計」。解決方案也由單一元件或外加的熱對策考量,轉換為所有元件皆需有熱設計的考量,產品內每個元件都肩負著散熱任務的時代已經來臨了。例如筆記型電腦近年CPU的耗電維持在30~35W左右,但持續追求產品的薄型/小型化與輕量化,為了實現光碟機承載等新功能的追加,只有縮小主機板的面積,結果主機板只有往高密度構裝提昇,因而造成散熱困難度增高的狀況。而手機等屬於自然冷卻的產品,有所謂外殼溫度的限制,這一類產品的散熱更為困難,也開始看到散熱的極限。一般公司規定,使用溫度加14℃為外殼溫度的上限。日本沖電氣工業公司對這一類產品的大致指標,是機身體積的耗電力如果超過10W,則欲利用空氣的自然冷卻是有困難的。
散熱問題解決方式的演變
由熱對策到熱設計
在最近1~2年,散熱問題的處理方式,已經由行之有年的「熱對策」轉變成幾乎所有設計者都不能缺席的「熱設計」。所謂「熱對策」指的是實際量測試產品內部溫度,發現有散熱問題時,再謀求解決對策(其流程如圖一(a)),此種場合幾乎都由結構設計師負責。「熱設計」指的是從設計階段就先找出可能出現散熱問題的部分,預先思考對策再設計產品。具體來說,一般大多採用先預估主要零件的發熱量,再以設計Data為基礎,利用熱流體分析進行模擬,模擬結果若還有問題,再修正設計Data,作第二次模擬驗證,反覆作業直到問題消除,才進入試作(其流程如圖一(b))階段。

圖一、近年散熱問題的處理方式由「熱對策」,轉變為「熱設計」
資料來源:NIKKEI ELECTRONICS 2007,08/材料世界網整理
採行熱設計方式時,參與人員除結構設計師外,元件、電路、外型(意匠)設計師等全部設計人員都必須參與,把散熱問題銘記在心,進行對散熱有利的設計。
在設計的早期階段,必須對元件發熱量、機器表面、fin等的散熱量進行檢討同時對組裝狀態下的熱途徑,以及對各部分溫度模擬、實測等方式加以掌握。
熱設計流程一開始大多由擅長模擬的結構設計師進行熱流體分析模擬,但結構設計者卻一致要求電氣設計者也必須進行熱流體分析模擬之後,再進行發熱元件的配置或基板配線的方式最為理想,而且從一開始設計電路時就考慮熱的問題,將成為熱源的元件分散配置的話,效果良好。也許訓練電氣設計師學會模擬分析,曠日費時,Sony公司的做法可供參考—派遣熟悉熱流體分析模擬之技術人員與電氣設計師合作。解決散熱問題的學問大,主導熱設計的電氣設計師也好,熱流體分析模擬人員也好,彼此的合作非常重要,因為在熱設計過程中,散熱與其他效應時常演變成Trade-off的關係,放任不管會演變成不可收拾的地步。
熱流體分析模擬的精度提昇
熱流體分析模擬精度的提昇是支持由熱對策轉換成熱設計的散熱發展的最重要因素。而熱流體分析模擬精度的提昇源於PC等性能的提昇,數百萬mesh的大量計算只需幾小時,加上模擬相關Know-how的累積,使精度得以提高,使模擬與實測的誤差可以抑制在1~2℃之內。
熱設計內涵
熱設計的做法含括兩種分析,即熱的平衡分析與決定熱途徑(如圖二),熱的平衡分析主要在概略設計時進行,需考慮熱的產生量與散出量的平衡;決定熱途徑則在詳細設計中執行。
(1) 概略設計:考慮熱的平衡,使用比較簡單的計算或模擬,目的在確認產品的規劃沒有破綻。如從外框尺寸、大量LSI等主要元件的耗電等項目,檢討發熱量與散熱量是否取得平衡,散熱零件的能力必須多高等。Sony公司為了不知顏色與材質的熱輻射率,而準備了簡易輻射率測定設備,以便在考慮熱平衡的前提下選擇顏色。
(2) 詳細設計:目的在將元件等產生的熱,經由哪裡可以散熱的所謂熱途徑的分析與修正。如決定從元件來的熱在框體內如何傳遞,從什麼地方散熱,具體而言,經由詳細模擬完成的設計,是否能如預期的散熱?有無囤積熱的地方?框體的空氣如何流動等進行反覆檢討。由於本步驟相當於過去以「試作品」所進行實測或檢測,因此各公司皆努力提昇模擬的精度。
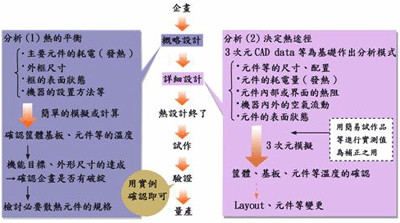
圖二、熱設計中重要的兩種分析
資料來源:NIKKEI ELECTRONICS 2007,08/材料世界網整理
詳細設計階段,可以利用3次元CAD的設計Data或專用model,利用熱流體分析進行模擬,此做法的好處是可給多個參數(parameter),以找出最適當的解答。模擬所費的時間,依公司或產品而異,一般在數天到數週之間;以次數來看,富士通的狀況多者10次,少者4~5次。表一為從機器內部發熱到散熱部分,如何才能有效控制熱的逃逸。為了有效散熱,基本上一般採行「將熱均勻分散自然冷卻」,或相反的「將熱集中在某部分的強制冷卻」。總之,溫度分布與空氣流動的模擬非常重要。
表一、熱的傳遞方式與對應處理方法例
|
熱傳導方式
|
對應處理
|
注重項目
|
具體的對應處理例
|
|
傳導
|
降低熱阻
|
材質
|
在熱通過部分採用金屬或高熱導性樹脂等熱阻低的材質
|
|
界面(半導體封裝與Heat Sink之間、元件間)
|
減少元件數,以減少界面數
|
|
在界面使用平坦度高的元件、或潤滑油、矽樹脂/橡膠等柔軟度高的元件、半硬化性樹脂或相變化sheet等,在製造階段為液體的元件使用在界面,可提高各元件間的密接性
|
|
剖面積
|
有厚度的配線等,加大熱通過部分的剖面積
|
|
對流
|
增大表面積
|
元件表面積
|
使用Heat Sink或Heat Spreader(熱擴散板)
|
|
輻射
|
提高輻射率
|
表面
|
使用輻射率高的材料,塗成黑色
|
資料來源:Nikkei Electronics 2007.08/材料世界網整理
以熱設計開發新產品的案例
Tenso公司為了提高豐田汽車公司混乘車「Lexus LS 600h」的性能,成功開發驅動馬達控制用PCU,齊心冷卻機構開發設計流程如圖三所示。首先決定開發方針---每個晶片流過的電流增加,導致IGBT等的發熱量也增加;解決散熱之道—首先檢討減少PCU熱阻的方法,以及冷卻Heat Sink由一處增為兩處以及其他配合方式,並進行模擬與實測。總之,以熱設計開發新產品的熱設計流程包括三大部分,1.利用簡單計算或模擬,首先將開發方針決定下來,並用原有設計進行對照分析;2.在概略設計階段考慮發熱與散熱部分,擬定對策;3.在詳細設計階段,完成新的設計並進行實測與驗證。
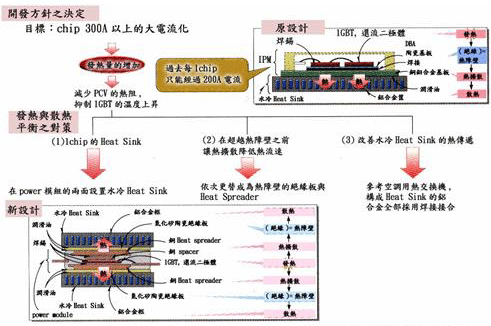
圖三、Tenso公司提高混乘車性能的冷卻機構開發設計流程
資料來源:NIKKEI ELECTRONICS 2007,08/材料世界網整理
所有元件肩負散熱的時代來臨
針對散熱問題的處理方法已經不同於往昔,過去在「試作品」時發現有散熱
的問題,只要張貼石磨片即可解決的代表性「熱對策品」,已經無法使用,主要理由為在高密度構裝之下,完全沒有可以安裝的空間,所以必須轉換成在早期的設計階段,將熱對策品設計進去,其實由所有元件肩負散熱使命的時代已經來臨,其作法如下:
(1) 基板也是散熱板
基板也是散熱板成為熱設計潮流之一,因為以小型產品的場合(1.0x0.5mm或0.6x0.3mm),散熱的90%是由印刷電路板傳遞的。印刷電路板由於銅導線分佈不同,不同地方的導熱率也不同。已經開始採取藉由模擬基板的溫度分佈狀況,來修正導線圖案。英國Flomerics公司的「FLOTHERM」、美國Fluent公司的「Icepak」等的模擬系統中追加了將基板的熱導率考慮在內的模擬軟體。
(2) 使用高散熱的接著劑
除了基板被要求也是散熱板之外,固定基板的接著劑、兩面膠帶也同樣被要求高散熱性。例如已於2007年1月正式為衛星導航液晶顯示器採用的雙面膠帶「Erethermal」,具1.4W/mk的高導熱率,用來固定背光源用LED基板,同時肩負讓基板的熱逃逸到框體的任務。
(3) 微細Heat Sink/Heat Sink與金屬基板一體型
中村製作所應用其精密加壓加工技術,開發將微小fin組合在金屬基板成微細Heat Sink,作為冷卻機構。微細fin的 pitch為0.5mm的銅製小型Heat Sink,其冷卻效果經模擬分析如圖四所示。以1.5W的熱源在無風的狀態下,可讓一般的銅板上升至246.4℃;安裝了0.5mm pitch 的fin後,Heat Sink的溫度被抑制在71℃。fin的 pitch越細,風越不易通過,冷卻能力無法提昇的場合很多,但中村製作所新開發的fin為0.05mm pitch,為過去的1/10,由於表面積加大,其散熱性更高。
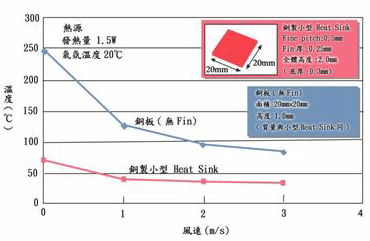
圖四、利用微細fin提昇散熱性
資料來源:NIKKEI ELECTRONICS 2007,08/材料世界網整理
Heat Sink與金屬基板一體型新產品為LED所需的強力散熱機構,為Sinwafron Tech.、中村製作所所提案。由於Heat Sink與基板之間沒有界面(不像過去存在空氣層或潤滑油),可抑制熱阻使散熱效果更高。Sinwafron Tech.的相關新產品,為與Heat Sink成一體的鋁合金製金屬基板,fin的高度最大30mm,pitch最小1mm的機械加工品。
★詳全文請見下方附檔