近幾年來電子散熱問題在3C 產業引起相當大的重視與關注,主要是隨著電子晶片不斷往高性能化、高速度化以及輕薄短小化的方向發展,使電子元件的發熱量(Power Dissipation)及相對熱流量(Heat Flux)愈來愈高,電子散熱問題變成電子產品首要克服的關鍵問題,這也造就熱管理產業的蓬勃發展。根據ITRS 2005 年對未來半導體發展歷程(Roadmap)之預估,在2008年高階電腦所用的微處理器(CPU)的發熱量將達200W ,之後將維持此值;而繪圖顯示卡(GPU)的發熱量近幾年亦持續飆升,未來將增加至180W 之後才趨於緩和,如圖一所示。這主要是因發熱量再增加上去將面臨強大的熱牆(Thermal Wall)挑戰,達到空氣強制冷卻的極限。雖然IC 晶片之發熱量有趨緩跡象,但其真正的挑戰則是晶片的不均勻發熱所造成的熱點問題,如圖二所示;另一方面由於晶片廠對於晶片發熱所帶來的環境衝擊及能源消耗已有所警覺,因此極力降低晶片的工作溫度(Tj)上限,同時因PC 逐步薄型化所造成的空間限制與環境溫度增加(Ta),促使散熱模組的熱阻需求仍不斷降低,如圖四所示,可預見未來的電子散熱問題仍沒有緩和的趨勢,因此電子散熱技術的增進與突破便顯得更加迫切與重要。
不僅電腦產業面臨嚴重的「熱」問題,近來以LED 作為照明光源或背光模組已被視為未來的發展趨勢, 而隨著LED 朝高功率及多晶片封裝的發展來看,LED 的散熱問題是繼CPU/GPU 之後另一個亟待解決的課題,必須從構裝材料、基板材料選用到照明系統散熱來強化LED 產品的散熱能力。要解決電子與光電元件所面臨的散熱問題,散熱材料本身的熱傳特性是一重要指標,材料的擴散熱阻與熱傳導率係成反比關係,亦即熱傳導率愈高其擴散熱阻愈低,散熱能力愈強。一般常用的散熱材料不外乎鋁、銅等熱傳導率不錯的材料(180 W/m•K, 380 W/m•K),但這種材料系統之熱膨脹係數偏高(17~23 ppm/K)且銅的比重過高(8.9 g/cc),而單晶鑽石雖熱傳導率極佳(2000 W/m•K),但價格昂貴又難以加工,因此鮮少作為散熱材料。為突破單一金屬材料所無法達到的熱物性質(熱傳導、熱膨脹及密度),近年來世界各國無不投入高導熱材料開發,包括高導熱石墨、碳化矽顆粒強化複合材料、碳纖維強化複合材料、石墨強化複合材料、鑽石顆粒強化複合材料等。
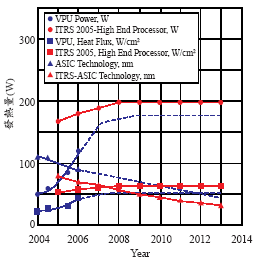
圖一、ITRS 2005 對半導體技術發展與晶片發熱量之預測
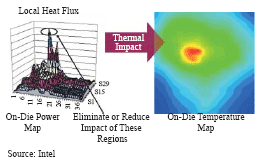
圖二、IC 晶片之熱點問題
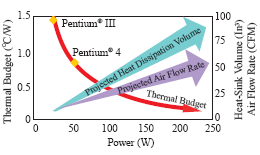
圖四、晶片發熱量與散熱模組熱阻抗需求
國外高導熱材之發展現況
國外發展高導熱複合材料由來已久,早期主要是配合航太工業的發展,需要高熱傳、低熱膨脹及輕量的材料,近幾年則擴及到電子及光電等民生領域的應用。一般用於高導熱複材的強化材大都以石墨、碳纖維及人工鑽石粉末為主,主要是碳原子為組成的材料,具有比金屬更高熱傳的特性。以石墨而言,包括人工石墨、天然石墨、電極石墨、球狀石墨等,熱傳導率在200~600 W/m•K 之間;碳纖維則有長纖維、短纖維、粉末碳纖維及氣相生成碳纖維等,其熱傳導率在500~1100 W/m•K 之間,氣相生成碳纖維甚至可達1600 W/m•K以上;而人工合成鑽石粉末的熱傳導率一般也有700 W/m•K 以上之水平。運用這些高導熱的強化材與金屬(Al, Cu, Ag, Mg)結合而做成的複合材料,即具有可調控的高熱傳導、低熱膨脹及輕量等特性,可以超越目前的鋁、銅、銀等金屬散熱材料。
1. 石墨強化複合材料
石墨具有規則排列的HCP 結構,純度好的石墨在平面方向(a Axis)的熱傳導率極佳,在200~600 W/m•K 之間;但在垂直方向(c Axis)因只靠凡得瓦力作原子鍵結,層與層之間的鍵結力差,影響晶格的振動及聲子傳遞,因此熱傳導率則在10 W/m•K 以下,兩方向的熱傳導相差40~50 倍,為一具異方性特性的材料。石墨的種類和型態繁多,有天然的及人工合成的,有片狀、鱗狀、球狀及粉末狀,包括天然石墨、片狀石墨、膨脹石墨、碳黑、電極石墨、介相微碳球(MCMB)等,圖六為石墨粉的外觀及其層狀結構,運用這些石墨作為強化材可以做出具有高熱傳導及低熱膨脹的複合材料。

圖六、石墨型態及其層狀結構
2. 纖維強化複合材料
一般應用於複合材料上的碳纖維強化相有許多種類,例如:連續長纖維、短纖維、鬚晶、粉末粒子。已商業化的碳纖一般是由丙烯脛系(PAN)和瀝青基系(Pitched)所製,丙烯脛系碳纖維因石墨化程度不如瀝青系碳纖維,其導熱率通常較低,因此目前應用於高熱導強化材最重要的是瀝青系碳纖維(亦稱之為石墨纖維),可以使用的方式有長纖、短纖、粉狀及纖維布(Mat)等。其中已真正商業化的瀝青系連續碳纖維,是以美國Cytec 所生產的K1100 之熱傳導率最高,達到1100 W/m•K ,其次為P120 , 熱傳導率達640 W/m•K; 而日本Mitsubishi Chemical 及Nippon Graphite Fiber所生產的短纖維經2800°C 石墨化處理之熱傳導率亦介於600~800 W/m•K 之間。另一種氣相生成碳纖維(VGCF),其熱傳導率據Applied Science Inc.宣稱可達1600 W/m•K 以上。不過值得注意的是上述的熱傳導率係沿著纖維方向的數值,但垂直纖維方向的熱傳導值通常只有20~30 W/m•K 左右,因此碳纖維具有高度的異向性,以碳纖維為強化材的複合材料同樣具有高度異向性,解決方法就是透過二維及三維編織方式,或者使用短纖維或粉末碳纖維來改善其異向性。
3. 鑽石強化複合材料
前面所提的碳纖維或石墨的晶體結構均為SP2 結構,其在纖維方向及Base Plane雖然都具有良好的熱傳導率,但具有強烈的異向性,而鑽石雖也是由碳原子組成,但因是SP3 結構,其材料特性屬等向性,不受方向影響。目前以高溫高壓合成技術製作出多晶體鑽石(Polycrystalline Diamond;PCD)的技術已相當成熟,人工合成的鑽石顆粒之熱傳導率甚至可達 1000 W/m•K 以上,約為一般純銅的2~3 倍,且售價約在US300~ 500/Kg 之間,比瀝青系連續碳纖維還便宜。因此國外有不少公司利用這種鑽石顆粒來製造成各種金屬基複材,而具有相當高的熱傳導率,且是等向的。表四所示為國外幾家公司所開發的鑽石強化金屬複材,金屬基材有鋁、銅、銀、矽等,從其熱傳導率可以發現其三個方向的熱傳導率均550~600 W/m•K 之間,甚至有的可以達到700 W/m•K 以上,遠比純銅高,且熱膨脹係數也只有4.5~7.5 ppm/K ,與GaAs 相當接近,重量又輕,只有3~5 g/cc 之間,是一相當好的散熱材料。
高導熱材之應用
高導熱複材具有高導熱、低熱膨脹係數及輕量之特色,可用於IC 構裝及散熱用途,有取代傳統金屬(Al,Cu)及金屬複材(Cu-W、Cu-Mo-Cu..)的空間,其應用包括微處理器的封蓋(Microprocessor Lids)、均熱片、CPU/GPU 散熱片、IGBT 散熱基板、微波構裝載板、雷射二極體散熱、LED 散熱基板、輕量化軌道車輛散熱器、航太及軍事用散熱板等,應用相當廣泛。
工研院材化所亦將其所開發的三維碳−碳鋁基複材應用於電腦散熱模組的底板上,其中圖十六(a)為鋁基複材+銅鰭片,重量320g ,熱阻為0.25°C/W,而圖十六(b)為鋁基複材+熱管+鋁鰭片,重量170g ,熱阻為0.19°C/W,較一般純銅散熱片的520g 輕2/3 。我們也將此高導熱複材用於LED 的散熱基板,作法是利用石墨鋁基複材表面覆上一層導熱絕緣層,再將電路網印上去而成LED 散熱基板,如圖十七所示。此種複合基板之製程簡單,且其熱傳導率高達320W/m•K ,熱膨脹係數在4 ppm/K 左右,熱擴散率更是銅的1.8 倍,可降低LED 熱點的形成,未來有機會應用在高功率及高密度矩陣封裝的LED 照明用途上。
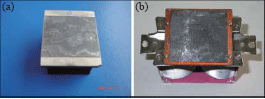
圖十六、高熱傳鋁基複材應用於電腦散熱模組的底板上
近幾年隨著電子構裝密度及電子元件發熱量的持續增加,同時逐漸朝輕量化、小型化和低成本化的趨勢發展,促使先進構裝與散熱材料更需具備高熱傳導率、低膨脹係數與低密度的要求。而石墨強化及碳纖維強化金屬基複合材料,是少數同時具備有這些特性的高性能材料,這也為高導熱複合材料開啟另一扇應用之窗,使其拓展至構裝與散熱的功能性用途上。然而電子構裝與散熱用高導熱複合材料的發展在國內尚屬研發階段,不像國外已具備相當程度的量產能力。工研院材化所經多年的開發,也逐步建立可量產的技術及智權佈局,期待能將此材料技術推廣至業界,實際應用於ICT 及LED 產業的構裝與散熱需求上。
對於上述工研院研發成果有興趣的讀者,歡迎 mail 至:materialsnet@itri.org.tw
作者:工研院材化所/ 黃振東
★本文節錄自「工業材料雜誌259期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=7023