徐振庭 / 工研院材化所
隨著電子資訊產業的飛速發展,電子元件的熱流密度不斷增加,以致對電子元件有更高的散熱要求,有效解決散熱問題乃成為電子設備必須解決的關鍵技術。電子散熱關係到電子設備的可靠性和壽命,是影響當今電子工業發展的一個瓶頸。伴隨著電子產業高性能、微型化、集成化的三大發展趨勢,電子散熱問題越來越突出,由中國電子學會電子材料學分會主辦的「AM China 2018中國導熱散熱展」即在此背景之下備受矚目。此展會展示出導熱散熱材料行業的最新產品與技術,為參展企業和與會客商提供了一個技術交流、產品展示和貿易洽談的最佳平台。
各項電子產品正朝向短、小、輕、薄趨勢發展,電子產品在高功能、高傳輸速率下工作,各種元件(如CPU、GPU等)的工作温度相對大幅升高,因此,電子零組件與系統的發熱功率也越來越大。通常傳統電子元件發熱功率較小時,解決散熱的方式主要依靠加裝散熱片或風扇來提高散熱效率。此時對於接觸熱阻、擴散熱阻等重要因素常被忽略。然而當系統功能及功率提高時,熱管理技術的要求相對也越來越嚴苛。在電子產品各部件由内向外的散熱路徑中,除了要求發熱元件本身需具備低熱阻特性,以及應用高效率的散熱元件之外,各個材料與散熱元件之間的組裝接合界面(Interface),也是熱管理技術的重要關鍵。
在散熱路徑中,各元件間的接觸情況與界面接合材料的熱傳導性能息息相關。由於兩元件互相接合時,即使表面平整度很好或施加很大的扣合壓力(Mounted Pressure),仍無法達成完美緊密接觸。如圖二所示,僅是部分接觸,接觸面中存在許多微細空隙或孔洞,由於縫隙中的空氣是熱傳導能力相當差的介質,因此成為熱傳導性能的阻礙。需要填充一種熱界面材料(Thermal Interface Materials;TIM )在接合面之間填補空隙,增進熱傳遞效率以降低界面熱阻。
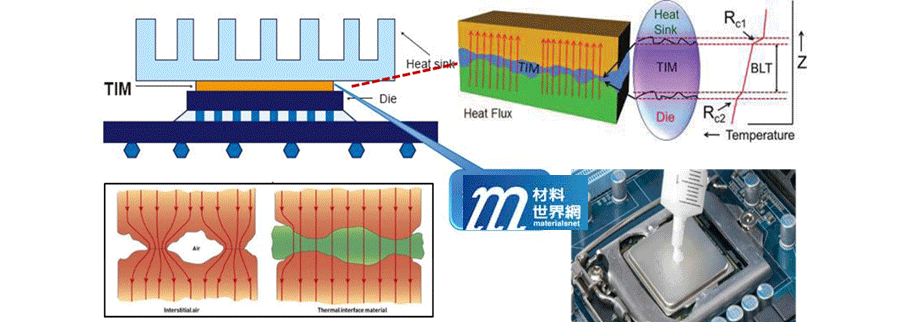
圖二、熱界面材料填補接合界面縫隙以降低界面熱阻
由於熱界面材料需具備填補兩接觸面縫隙的功能,除了本身要求一定程度的導熱性能之外,也需要具備足夠的流動性和延展能力,方能達到填入縫隙的目的。因此,除了熱傳係數之外,理想的熱界面材料也需要合適的黏度、流動性及塗佈延展性等其他性能。
導熱材料的種類很多,可以分為:灌封膠、矽膠膏、膠矽脂、導熱泥、矽膠片、導熱矽布、散熱油、導熱塗料、塑料、導熱膜、絕緣材料、界面材料、雙面膠、導熱散熱基板、相變材料、散熱膜、雲母片、墊片、膠帶、液態金屬導熱片等。
導熱界面材料的應用場域十分廣泛,如圖三所示,其中有些部分概念重合,有的概念基本上一致。本文將列舉五項常見的指標性產品進行簡介及說明。

圖三、導熱界面材料可應用之領域
灌封膠
灌封膠也叫做導熱灌封膠(Pouring sealant of thermal conductivity),在工業上若按材料分類,則有環氧導熱灌封膠和有機矽導熱灌封膠兩種。圖四為展覽會場中一家灌封膠攤位的展示看板。以現有的純環氧樹脂和有機矽樹脂而言,其熱傳導值介於0.1~0.2 w/mk之間,經由添加適當的導熱填充物之後,熱傳導值可直接提升約10倍,達到0.6~2.2 w/mk.......以上為部分節錄資料,完整內容請見下方附檔。