李守仁/ 健行科技大學;白立文/ 工研院材化所
由日本電子電路工業會(Japan Electronics Packaging and Circuits Association;JPCA)主辦的 2016年 JPCA Show,於 6月初在東京熱鬧登場。今年的展會計有760家廠商聯袂參展,三天展會期間共吸引超過四萬人次的參觀者入場。自 2005年起,日本電子電路工業會於 JPCA Show 的參展產品與技術中,以「獨創性」、「產業的發展性、未來性」、「信賴性」以及「時代的適應性」為審查標準,篩選參展「新產品發表(New Product Introduction)」的企業,並頒發 JPCA年度大賞,由這些得獎作品可一窺日本在印刷電路板及構裝技術的發展與方向,本文將介紹今年獲獎的八件產品與技術,提供國內相關業者參考。
Denso株式會社:可監視設備狀態之高靈敏度能源感測器的印刷電路板製程
電子設備小型化、高性能化的發展趨勢提升了對封裝基板微細化、多層化的需求;此外,三次元封裝零件內藏技術也朝向實用化發展。因應此趨勢,Denso公司開發應用於要求高信賴性之車用環境下的一體積層基板(Patterned Prepreg Lay-Up Process;PALAP,如圖一),目前已達到實用化階段。PALAP 技術的本質為「以熱可塑性樹脂作為壓力介質的粉末冶金技術」。應用此技術可開發出傳統技術無法達成的薄型、小型化的高靈敏度能源感測器用「RAFESPA 基板」。配備「RAFESPA 基板」的感測器對於熱能具有高靈敏度之檢測能力,可用以監測設備的狀態,也可以應用於 IoT 領域。
配備「RAFESPA基板」的熱流感測器可以檢測出熱的流量與方向。相較於目前廣泛使用於產業界的熱電偶,大幅提升了對溫度變化的靈敏度,且可測出放熱、吸熱的方向(熱的流向)。藉由半導體的高密度封裝,對熱流的靈敏度可以提升四倍以上。因薄型化,也可量測彎曲的部位。可廣泛應用於需進行高精密度熱解析的領域,例如汽車引擎室的熱損失量測、住宅隔熱性能評估等,也可應用於產品加速開發階段的熱設計,或是因零件劣化造成之工廠設備故障的診斷。
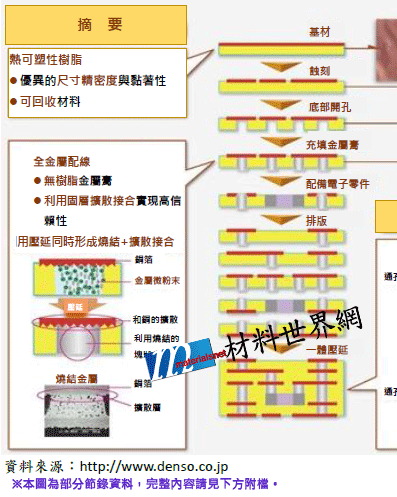
圖一、PALAP製程
Panasonic 株式會社:極薄FPC用可撓式多層銅箔基板材料
Panasonic 公司得獎的是多層可撓銅箔基板材料(Felios FRCC,圖二)。本產品具有銅箔、Polyimide 和接著劑等三層結構,在熱硬化性環氧樹脂成分中,透過採用熱可塑性樹脂經 Polymer Alloy 化的接著劑,作成兼具高耐熱性與富彎曲性的含可撓樹脂銅箔。具優異表面平滑性的熱硬化性樹脂,可撓化且多層成型後,以傳統製程難以做到的,厚度小於 0.2mm 的四層剛撓結合基板,可以減少組裝製程(圖三),相較於其他公司的產品,不但比較薄,且成本較低(圖四)。對智慧手機、智慧手錶等可攜式終端產品所使用之可撓式印刷電路板的小型化與高功能化卓有貢獻。今年在 14 家公司的 19 項競逐產品中脫穎而出,入選為 8件得獎產品之一。而這也是 Panasonic 公司連續第 3年在 JPCA 的得獎---以上為部分節錄資料,完整內容請見下方附檔。
圖四、四層剛撓結合基板的厚度與製造成本