近年來,IC產業不斷推陳出新,造就新一波工業革命,封裝產業紛紛推出新穎封裝技術手法,以滿足諸多新式元件於組裝及建構上的需求。現階段封裝產業最熱門的 3D IC 技術,不僅突破了過去僅靠覆晶組裝而完成構裝的思維,更以 TSV 設計搭配微接點技術運用於組裝當中,使得模組系統化有更進一步的發展,同時亦帶動了國內外各大廠競相引入鉅額投資,以俾使在此場技術競爭中拔得頭籌。另一方面,利用電路板技術即可完成的內埋式系統構裝架構,亦在此一風潮中扮演重要的角色;由於除了邏輯運算元件,或是繪圖功能元件外,一般功率元件或是通訊元件之 I/O 接點數目並不若該些高功能運算元件多,因此在成本考量底下,可藉由線寬線距規格較為寬鬆之電路板技術即可達成。
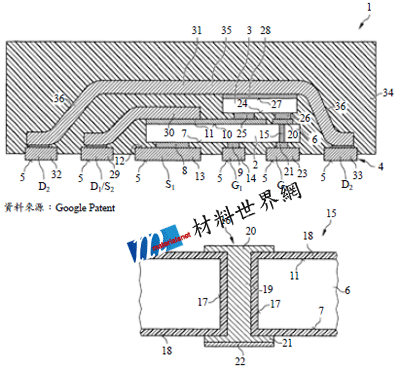
圖二、英飛凌新型功率模組結構
國際發展動態
主被動元件內埋技術自美國奇異( GE )公司的母專利出現至今已有數十年歷史,技術能力也由第一代的單一主動或被動元件內埋(表一),進階至目前第二代的異質主被動元件整合內埋技術(表二)。在第一代技術中,最成功的量產案例當屬 CMK 在 2006年配合Casio 的運動手錶所開發之內埋式晶圓級封裝( EWLP )模組。之後各種類似技術,例如 Infineon 的 eWLB 與 Freescale 的 RCP 技術在歷經長達數年的開發並成功度過經濟衰退後,亦已進入開花結果階段。第二代內埋技術開始整合異質主被動元件為單一系統模組,日本 OKI 在2005年發表相關技術,設定之應用領域包括 TV Tuner 與 Zigbee 無線模組等。由於裸晶圓取得不易,因此 OKI 之結構是內埋 Flip Chip 或 WLCSP 元件,而非薄化後的晶片。NEC 則是往高 I/O數的高階應用為發展方向,藉由結構設計強化模組的電氣性能表現與熱管理效益;而 IZM 的雙晶片內埋式封裝( EDCP )與TI協同喬治亞科技學院發表的主被動元件內埋式微機電模組( EMAP )技術,則不約而同朝異質元件的整合而努力。
工研院自 2007 年開始發展主被動元件整合式模組技術( iPAM )製程,與上述技術的最大差異點在於採用高介電係數材料達成被動元件的內藏,而非單純將各個離散的被動元件內埋至電路板中,對系統模組的微縮化更具效益,目前 iPAM 相關材料與製程技術已開始轉移予國內材料與電路板大廠,將陸續應用於 3.5G 與藍芽模組之生產,且較 eWLP 具有更高的技術門檻與發展性,有機會成為下世代 SiP 標準封裝製程。
電氣特性
圖三是傳統打線接合與內埋式封裝體在結構上的差異比較,兩者皆以一核芯層承載晶片,但在黏晶後,打線接合是以金線將晶片產生之訊號傳導至電路板上,而內埋式封裝則是在電路板與晶片上壓合一增層用介電材料,透過雷射鑽孔與電鍍填孔製程,將電路重佈於介電層上取代金線的角色。輔以眼圖進行兩種封裝結構之時域分析(圖五),在超高頻狀態下,金線可視為一電感,因此頻率響應變化劇烈,不論是傳輸端或接收端,其阻抗匹配都會受到一定程度的影響;相對地,晶片內埋式結構是以低阻值的銅金屬做為導通介質,且傳輸路徑短,頻率響應變化較為溫和,阻抗匹配容易控制,不論是張度或抖動的表現均優於……以上為部分節錄資料,完整內容請見下方附檔。
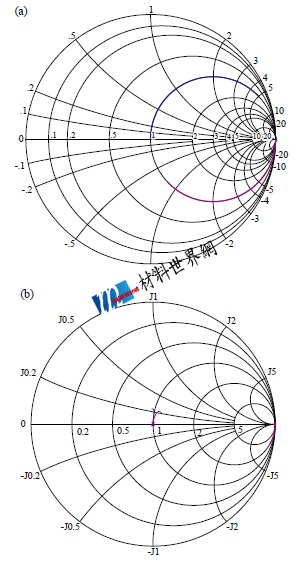
圖四、(a)打線封裝;(b)內埋式封裝在0~40 GHz之史密斯圖比較(模擬數據)
作者:鄭仁信、張景堯、張道智/工研院電光所;張孝民/文顥電子股份有限公司
★本文節錄自「工業材料雜誌」346期,更多資料請見下方附檔。
★相關閱讀:內埋式功率模組封裝技術(下)