電動車的電子系統中,在馬達控制單元的變頻器(Inverter)是由電能轉換成動能最重要電子零組件,如圖一所示,其中影響電能轉換效率最重要的部分是功率電子模組。具備寬能隙、高絕緣強度及高導熱率的碳化矽功率半導體元件已受到高度重視,被視為取代傳統矽基功率半導體的新一代高功率應用明日之星。SiC較傳統矽基IGBT與Diode等晶片具有較佳之系統Switching Frequency,並且能降低Power Loss及提升至較高的系統效率,是下一代製作功率元件極具看好的元件。然而,現有的SAC無鉛銲料系統已無法滿足未來SiC功率半導體元件的耐高溫要求, SiC雖然可運作在250˚C之操作溫度且轉換效率較高,但晶片端的Hot Spot散熱問題仍存在,且長期處在高溫運作,接點可靠度會急遽下降。
固液交互擴散接合技術
豐田汽車北美研究機構(Toyota Research Institute of North America)與阿肯色大學(University of Arkansas)發表Ni-Sn SLID接合功率元件,將Si IGBT功率元件組裝到功率基板(圖三),經過-40~200˚C的溫度循環測試,測試後的電性與微結構與測試前並無差異。證實Ni-Sn SLID接合具有非常優異的特性,適合高溫操作的功率模組之組裝。
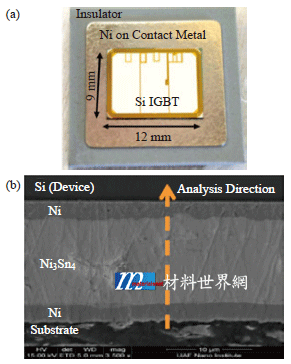
圖三、(a)Ni-Sn SLID接合應用於Si IGBT功率元件組裝到功率基板;(b)Ni-Sn SLID接點的微結構切片之掃描式電子影像
奈米金屬粉末燒結
本研究團隊已於本刊第308期介紹工研院自行開發的銀膏及其IGBT燒結固晶,現階段仍對此材料持續進行開發;同步採購業界開發量產的奈米銀膏進行評估,業界販售的奈米金屬粉末可分為膏狀(Paste Type)與薄膜狀(Film Type),最大的特色在於燒結環境不需在真空或特殊氣氛下,可直接在大氣環境下進行固晶燒結,燒結溫度為230~280˚C,與傳統無鉛銲錫的製程溫度區間相同,更勝於傳統無鉛銲料在迴銲後需要清潔殘留助銲劑,銀燒結完成後不會有任何污染沾附於基板與晶片,可省卻額外的清洗設備、製程與成本。
PCB廠商的壓合機也是另一種可進行銀燒結的設備,特別發展高可靠度內埋功率元件封裝技術,PCB廠商利用現有設備即可完成銀燒結製程,至於印刷與晶片P&P製程則可委託覆晶業者完成,然後再交由PCB廠商進行批量式銀燒結製程。此外,銀燒結薄膜同樣需要在燒結過程施加壓力,但據業者宣稱壓力值可小於10 MPa,此款材料的優勢在於可應用在功率半導體晶片堆疊架構,銀燒結薄膜只需先預貼到晶片或基板表面,接著進行晶片堆疊製程,最後再一次性完成堆疊晶片的燒結製程,此款材料目前仍在工研院進行實驗中。
真空迴銲技術
利用無鉛銲料或傳統迴銲製程最大的接合問題在於氣孔的形成,它不但會造成極大的熱阻,對於接點的長期可靠度也會帶來負面衝擊。對於車用功率半導體元件而言,接點氣孔所帶來的可靠度問題更是不容忽視。
圖十一為工研院Partial SiC功率模組封裝的流程圖,步驟A和B採用真空迴銲進行銲接,銲料為SAC 305 Solder Preform,搭配助銲劑清除金屬氧化膜,並降低銲錫的表面張力,增加其擴散能力,使真空迴銲後之接點孔洞率<1%。圖十二為最終完成的600V/450A Partial SiC功率模組,雖然僅將Si Diode更換為SiC SBD,但模組仍有優異的電性表現……以上內容為重點摘錄,如欲詳全文請見原文
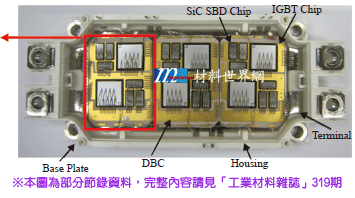
圖十二、工研院封裝之Partial SiC功率模組
作者:高國書、張道智/工研院電光所,張景堯、莊東漢/國立台灣大學
★本文節錄自「工業材料雜誌319期」,更多資料請見:https://www.materialsnet.com.tw/DocView.aspx?id=11171